引言
在未来几代器件中,光刻胶(PR)和残留物的去除变得非常关键。在前端制程(FEOL)离子注入后(源极/漏极、扩展、haIos、深阱),使用PR封闭部分电路导致PR实质上硬化且难以去除。在后段制程(BEOL)蚀刻中,在不去除低k材料的情况下去除抗蚀剂和残留物的选择性是非常具有挑战性的。概述了现状、问题和一些新的方法。
介绍
光致抗蚀剂用于保护晶片的某些区域免受干蚀刻化学物质、离子注入等的影响。工艺完成后,需要选择性地去除光致抗蚀剂并清洁表面,以确保表面没有残留物和颗粒。原则上,使用湿化学物质如热SPM、有机溶剂或通过使用干等离子体的“灰化”去除抗蚀剂是可能的。然而,在干法蚀刻或注入处理过程中,抗蚀剂会发生化学改性,这种改性会显著降低剥离速率。如果更具侵略性-例如,使用高度氧化的化学物质,这可能导致晶片上其他材料的不希望的侵蚀。虽然这些考虑几十年来,对于单元工艺开发非常重要,对于45纳米技术节点和更高技术节点的某些iTRS路线图要求变得越来越严格,以至于工业实验室正在考虑对cMOS集成流程的几个模块进行根本性的范式转变。同时,新的替代集成方案,包括使用应变硅、金属硬掩模和金属栅电极,导致不同的要求。这使得对这一主题的研究更加复杂。
在下文中,我们华林科纳总结了现状、问题和新方法,重点关注FEOL中的源漏注入模块和BEOL的低k干法刻蚀模块。
FEOL:植入后抗蚀剂剥离
源极-漏极注入模块场效应晶体管的源极/漏极(S/D)结是通过将掺杂剂离子注入硅衬底而形成的。这种注入通常涉及离子as、P、B或BF2的面密度约为。1012到几个1015cm。离子能量的范围从非常浅的S/D扩展的几100eV到深注入的几十keV。为了确保在同一芯片/晶片上制造的各种器件,特别是nFETs和pFETs,每个器件只接受适当的注入,需要进行选择性注入。这是通过用图案化的光致抗蚀剂进行掩蔽来实现的,如图1示意性所示。因此,S/D区域中复杂的掺杂剂几何形状是通过光致抗蚀剂应用和图案化、离子注入、抗蚀剂剥离和表面清洁的循环产生的。
注入抗蚀剂的离子导致近表面区域的化学改性。抗蚀剂聚合物的化学键被来自撞击离子的能量破坏,这会导致聚合物主链断裂。
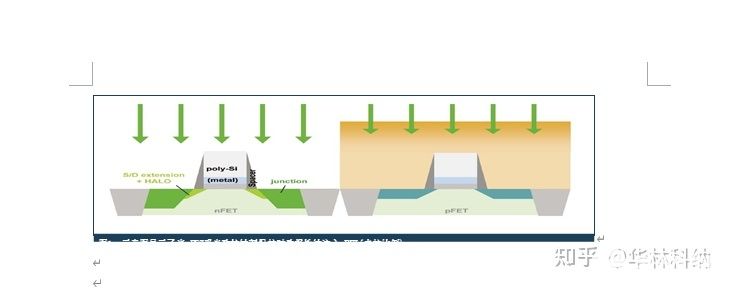
结论
开发下一代光刻胶剥离剂和残留物去除剂并不容易。它来自于大量的辛勤工作和致力于创造一种满足90纳米节点或以下技术需求的化学。
我们最新的化学技术可有效去除low-电介质上的大块光刻胶、灰渣和抗反射涂层。它还是100%水溶性的,是一种更加环保的解决方案。
审核编辑:汤梓红
相关推荐
IC设计工艺光刻胶
Mr_haohao
发布于 :2022年10月21日 02:03:43
光刻光刻胶
电子知识科普
发布于 :2022年10月27日 17:14:48
AL-CU互连导线侧壁孔洞形成机理及改进方法侧壁孔洞缺陷是当前Al?Cu 金属互连导线工艺中的主要缺陷之一。此种缺陷会导致电迁移,从而降低器件的可靠性。缺陷的产生是由于在干法等离子光刻胶去除工艺
发表于 10-06 09:50
100μm并具有极高的分辨率。 NR5 系列 NR5-系列负性光刻胶,用于深度离子蚀刻(RIE)中的厚膜掩膜工艺。 PR1 系列 正性光刻胶,用于光刻,蚀刻和高温制程。 IC1/DC5 系列 作为
发表于 04-21 10:57
光刻技术中,涂有光刻胶的硅片与掩膜版直接接触.由于光刻胶和掩膜版之间紧密接触,因此可以得到比较高的分辨率.接触式暴光的主要问题是容易损伤掩膜版和光刻胶.当掩膜版与硅片接触和对准时,硅片上很小的灰尘
发表于 01-12 10:56
本帖最后由 hughqfb 于 2013-3-22 12:34 编辑
第一次焊接144PIN的TQFP封装的芯片,第一次没成功,于是拆了再焊,终于成功,但是用洗板水洗过后芯片的引脚之间居然还留有很多白色的残留物,十分恼火!大家求赐教如何去除白色残留物!谢谢了!
发表于 03-20 16:48
。(即按客户要求进行显示的部分拉线蚀刻完成,如图)J. 清洗干燥:用高纯水冲洗余下的碱液和残留的光刻胶以及其它的杂质。 2. 特殊制程:(TOP 膜的涂布到固化后清洗) 一般的TN 与STN 产品不要求此
发表于 06-30 09:03
这是我的版图一部分,然后生成了图案是这样的: 感觉间距小的地方全都有残留,间距大的地方没有残留;工艺参数:s9920光刻胶, evg 620‘未进行蒸汽底漆层涂覆,前烘:100摄氏度,90s
发表于 11-29 14:59
旁边的漆膜变色或老化,会留下一些残留物,甚至一些种类的三防漆加热后会释放有毒气体,所以使用前一定要慎重。 二,微研磨法,此方法采用一种特殊的仪器,能把局部的漆膜打磨掉而不损伤产品,但是对操作
发表于 05-28 10:44
光刻胶在近紫外光(365nm- 400nm)范围内光吸收度很低,且整个光刻胶层所获得的曝光量均匀一致,可得到具有垂直侧壁和高深宽比的厚膜图形;它还具有良好的力学性能、抗化学腐蚀性和热稳定性。SU-
发表于 07-04 14:42
的厚膜图形;它还具有良好的力学性能、抗化学腐蚀性和热稳定性;在受到紫外辐射后发生交联,是一种化学扩大负性胶,可以形成台阶等结构复杂的图形;在电镀时可以直接作为绝缘体使用。 SU-8光刻胶的优点:1
发表于 07-12 11:57
。该膜的表面感光层材料受曝光光束后发生光化学反应,形成一较硬的抗RIE蚀刻层,然后以其作为掩蔽层,利用RIE等蚀刻方法对下层的光刻胶进行刻蚀,形成所希望的曝光加工图形。 对于光刻胶成分的选择必须同时
发表于 08-23 11:56
相同的设置下尝试了34401a和34410a。 34401a有大约2-3个计数(2-3uV)的残留物,34410a有没有办法去除U1252A上的AV mV残留物? 以上来自于谷歌翻译 以下为原文I
发表于 11-15 16:33
使用的黏合剂不耐高温,所以先用电吹风的暖风烘烤一下,待商标或封条的黏性减弱后就可以干干净净地撕下,丝毫不留痕迹。如果是已经撕掉了还有痕迹呢?可以看下下面去除不干胶的方法。 奥泰格分享不干胶标签怎么去除? 一
发表于 11-15 16:06
版完全一致的ITO图形。J. 清洗干燥:用高纯水冲洗余下的碱液和残留的光刻胶以及其它的杂质。2、特殊制程:(TOP膜的涂布到固化后清洗)一般的TN与STN产品不要求此步骤,TOP膜的涂布工艺是在光刻
发表于 07-16 17:46
(post bake) 为使残留在光刻胶中的有机物溶液完全挥发,提高光刻胶和基片的粘接性及光刻胶的耐腐蚀能力,通常将基片在120-- 200 oC温度下烘干20 – 30 分钟。 (6)腐蚀
发表于 08-16 11:11
光刻胶也称为光致抗蚀剂,是一种光敏材料,它受到光照后特性会发生改变。光刻胶主要用来将光刻掩膜版上的图形转移到晶圆片上。光刻胶有正胶和负胶之分。正胶经过曝光后,受到光照的部分变得容易溶解,经过显影后被
发表于 11-07 09:00
喷胶机是现代光电子产业中光刻胶涂布的重要设备。可对不同尺寸和形状的基片进行涂胶,最大涂胶尺寸达8寸,得到厚度均匀的光刻胶层,同时可对大深宽比结构的侧壁进行均匀涂胶;通过计算机系统控制器进行工艺参数的编辑和操作。
发表于 03-23 09:00
,光刻和刻蚀是其中最为核心的两个步骤。 而晶体管就是通过光刻和蚀刻雕刻出来的,光刻就是把芯片制作所需要的线路与功能区做出来。利用光刻机发出的光通过具有图形的光罩对涂有光刻胶的薄片曝光,光刻胶见光后会
发表于 07-07 11:36
一、光刻胶的选择光刻胶包括两种基本的类型:正性光刻和负性光刻,区别如下
发表于 01-12 10:17
快速去除氧化物。5、BOE 去除氧化物的速度较慢,但可以延长光刻胶掩模的使用寿命。蚀刻速率通常为 30 – 80 nm/min。6、稀释的 HF 蚀刻剂(例如 5% HF)用于在大约 30 秒内去除
发表于 06-30 10:40
的实验结果。确定了几个可能影响粘附的因素,并使用实验设计 (DOE) 方法来研究所选因素的影响和相互作用。确定的最显着的附着力改进是在光刻胶涂层之前立即加入天然氧化物蚀刻。除了提高附着力外,这种预涂层处理
发表于 07-06 09:39
工艺步骤:光刻:通过在晶片表面涂上均匀的薄薄一层粘性液体(光刻胶)来定义图案的过程。光刻胶通过烘烤硬化,然后通过光穿过包含掩模信息的掩模版进行投射而选择性地去除。蚀刻:从晶片表面选择性地去除不需要的材料
发表于 07-08 13:13
为满足电磁型平面微电机对定子绕组线圈的高深宽比及厚度要求,提出一种利用AZ4903光刻胶制作电磁平面微电机定子绕组的方法。通过反复摸索,得到了该光刻胶的较理想_的转速一
发表于 06-29 14:20
•53次下载
光刻胶与光刻工艺技术 微电路的制造需要把在数量上精确控制的杂质引入到硅衬底上的微小 区域内,然后把这些区域连起来以形成器件和VLSI电路.确定这些区域图形 的工艺是由光刻来完成的,也就是说,首先在硅片上旋转涂覆光刻胶,再将 其曝露于某种光源下,如紫外光,
发表于 03-09 16:43
•126次下载
的粘附改善是在光刻胶涂层之前加入天然氧化物蚀刻。除了改善粘附性,这种预涂层处理还改变了(100)砷化镓的湿蚀刻轮廓,使反应限制蚀刻与未经表面处理的晶片相比更具各向同性;轮廓在[011‘]和[011]方向
发表于 06-29 11:34
•0次下载
光刻胶产品说明英文版资料分享。
发表于 08-12 16:17
•0次下载
这是一种老式的旋转涂胶机,将芯片上涂上光刻胶然后将芯片放到上边,可以通过机器的旋转的力度将光刻胶均匀分布到芯片表面,光刻胶只有均匀涂抹在芯片表面,才能保证光刻的成功。
![的头像]() 发表于
发表于 05-17 14:39
•1.8w次阅读
干膜光刻胶是由预先配制好的液态光刻胶(Photoresist)在精密的涂布机上和高清洁度的条件下均匀涂布在载体聚酯薄膜(PET膜)上,经烘干、冷却后,再覆上聚乙烯薄膜(PE膜),收卷而成卷状的薄膜型光刻胶。
![的头像]() 发表于
发表于 01-30 16:49
•1w次阅读

光刻胶是指通过紫外光、准分子激光、电子束、离子束、X 射线等光源的照射或辐射,其溶解度发生变化的耐蚀刻薄膜材料。主要应用领域包括:半导体领域的集成电路和分立器件、平板显示、LED、以及倒扣封装、磁头及精密传感器等产品的制作过程。
![的头像]() 发表于
发表于 02-11 13:54
•2.3w次阅读
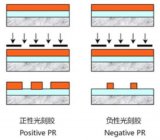
光刻机把电路图投影到覆盖有光刻胶的硅片上面,刻蚀机再把刚才画了电路图的硅片上的多余电路图腐蚀掉,这样看起来似乎没什么难的,但是有一个形象的比喻,每一块芯片上面的电路结构放大无数倍来看比整个北京都复杂,这就是这光刻和蚀刻的难度。
![的头像]() 发表于
发表于 03-14 14:15
•18.8w次阅读
在国家政策与市场的双重驱动下,近年来,国内企业逐步向面板、半导体光刻胶发力……
![的头像]() 发表于
发表于 04-23 16:15
•1.3w次阅读

2018年,南大光电和上海新阳先后宣布,投入ArF光刻胶产品的开发与产业化,立志打破集成电路制造最为关键的基础材料之一——高档光刻胶材料几乎完全依赖于进口的局面,填补国内高端光刻胶材料产品的空白。
![的头像]() 发表于
发表于 05-21 09:24
•6663次阅读

预计2019年底建成一条光刻胶生产线,项目产业化基地建设顺利。
![的头像]() 发表于
发表于 07-19 14:08
•5094次阅读
Mattson Technology Inc.表示,它正与欧洲IMEC合作位于比利时鲁汶的微电子研发中心共同开发新的光刻胶和残留物去除工艺。
![的头像]() 发表于
发表于 08-13 10:15
•6091次阅读
光刻胶概念股南大光电10月23日公告,拟投资新建光刻胶材料以及配套原材料项目。
![的头像]() 发表于
发表于 10-24 16:47
•2873次阅读
经开区企业北京欣奕华科技有限公司(以下简称“欣奕华”)了解到,经过多年的行业累积和技术迭代,欣奕华在平板显示用负性光刻胶领域实现了量产,预计今年将有1000吨的光刻胶交付用户,约占国内市场的8%。
![的头像]() 发表于
发表于 10-28 16:38
•3512次阅读
今年7月17日,南大光电在互动平台透露,公司设立光刻胶事业部,并成立了全资子公司“宁波南大光电材料有限公司”,全力推进“ArF光刻胶开发和产业化项目”落地实施。目前该项目完成的研发技术正在等待验收中,预计2019年底建成一条光刻胶生产线,项目产业化基地建设顺利。
![的头像]() 发表于
发表于 12-16 13:58
•6917次阅读
随着电子信息产业发展的突飞猛进,光刻胶市场总需求不断提升。2019年全球光刻胶市场规模预计接近90亿美元,自2010年至今CAGR约5.4%,预计未来3年仍以年均5%的速度增长,预计至2022年全球光刻胶市场规模将超过100亿美元。
![的头像]() 发表于
发表于 03-01 19:02
•3747次阅读
光刻胶按应用领域分类,大致分为LCD光刻胶、PCB光刻胶(感光油墨)与半导体光刻胶等。按照下游应用来看,目前LCD光刻胶占比26.6%,刻胶占比24.5%,半导体光刻胶占比24.1%,PCB光其他类光刻胶占比24.8%。
![的头像]() 发表于
发表于 06-12 17:13
•5009次阅读
来源:浙商证券研究院 光刻胶又称光致抗蚀剂,是一种对光敏感的混合液体。其组成部分包括:光引发剂(包括光增感剂、光致产酸剂)、光刻胶树脂、单体、溶剂和其他助剂。光刻胶可以通过光化学反应,经曝光、显影等
![的头像]() 发表于
发表于 09-15 14:00
•1.4w次阅读
全球光刻胶市场规模从2016 年的15 亿美元增长至2019年的18亿美元,年复合增长率达6.3%;应用方面,光刻胶主要应用在PCB、半导体及LCD显示等领域,各占约25%市场份额。
![的头像]() 发表于
发表于 09-21 11:28
•3050次阅读

大型PCB制造商使用电镀和蚀刻工艺在板上生产走线。对于电镀,生产过程始于覆盖外层板基板的电镀铜。 光刻胶蚀刻也用作生产印刷电路板的另一个关键步骤。在蚀刻过程中保护所需的铜需要在去除不希望有的铜和在
![的头像]() 发表于
发表于 12-31 11:38
•2775次阅读
全球光刻胶市场规模从2016 年的15 亿美元增长至2019年的18亿美元,年复合增长率达6.3%;应用方面,光刻胶主要应用在PCB、半导体及LCD显示等领域,各占约25%市场份额。 国内光刻胶整体
![的头像]() 发表于
发表于 10-10 17:40
•2686次阅读
光刻胶是由感光树脂、增感剂和溶剂三种主要成份组成的、对光敏感的混合液体。利用光化学反应,经曝光、显影、刻蚀等工艺将所需要的微细图形从掩模版转移到待加工基片上的图形转移介质,其中曝光是通过紫外光
![的头像]() 发表于
发表于 12-06 14:53
•713次阅读
此外,由于光刻加工分辨率直接关系到芯片特征尺寸大小,而光刻胶的性能关系到光刻分辨率的大小。限制光刻分辨率的是光的干涉和衍射效应。光刻分辨率与曝光波长、数值孔径和工艺系数相关。
![的头像]() 发表于
发表于 10-15 15:09
•5699次阅读
光刻胶是微纳加工过程中非常关键的材料。有专家表示,中国要制造芯片,光有光刻机还不够,还得打破国外对“光刻胶”的垄断。
![的头像]() 发表于
发表于 12-08 10:53
•3790次阅读
昨夜晚间,宁波南大光电发表公告称,公司自主研发的 ArF 光刻胶产品 近日成功通过客户的使用认证。
![的头像]() 发表于
发表于 12-18 09:52
•2801次阅读
,“ArF 光刻胶产品开发和产业化”是宁波南大光电承接国家“02 专项”的一个重点攻关项目。本次产品的认证通过,标志着“ArF 光刻胶产品开发和产业化”项目取得了关键性的突破,成为国内通过产品验证的第一只国产 ArF 光刻胶。 此举意味着国产193nm ArF 光刻胶产
![的头像]() 发表于
发表于 12-25 18:24
•5453次阅读
近期,专注于电子材料市场研究的TECHCET发布最新统计和预测数据:2021年,半导体制造所需的光刻胶市场规模将同比增长11%,达到19亿美元。
![的头像]() 发表于
发表于 03-22 10:51
•4606次阅读
按照应用领域分类,光刻胶主要包括印制电路板(PCB)光刻胶专用化学品(光引发剂和树脂)、液晶显示器(LCD)光刻胶光引发剂、半导体光刻胶光引发剂和其他用途光刻胶四大类。本文主要讨论半导体光刻胶。
![的头像]() 发表于
发表于 05-17 14:15
•3531次阅读
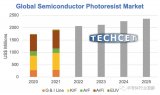
由于KrF光刻胶产能受限以及全球晶圆厂积极扩产等,占据全球光刻胶市场份额超两成的日本供应商信越化学已经向中国大陆多家一线晶圆厂限制供货KrF光刻胶,且已通知更小规模晶圆厂停止供货KrF光刻胶。 信越
发表于 06-25 16:12
•667次阅读
5月27日,半导体光刻胶概念股开盘即走强,截至收盘,A股光刻胶板块涨幅达6.48%。其中晶瑞股份、广信材料直线拉升大涨20%封涨停,容大感光大涨13.28%,扬帆新材大涨11.37%,南大光电
![的头像]() 发表于
发表于 05-28 10:34
•2246次阅读
人工进行检测,需要借助农药残留物检测仪等专业的检测仪器进行检测。目前农药残留物检测仪【恒美 HM-NC12】常被用于农贸市场、生产基地、批发市场、超市等场所。 传统的检测方法需将采集的样品带到实验室里进行测定和分析,这种检测方式耗
发表于 06-10 14:40
•255次阅读
波长不同,可分为g线(436nm)、i线(365nm)、KrF(248nm),ArF(193nm)以及EUV光刻胶,其中KrF、ArF和EUV光刻胶被认为是高端光刻胶,目前国内几乎空白。 日本垄断全球光刻胶大部分市场份额,全球排名前四的光刻胶厂商都来自日本,包括合成橡胶
![的头像]() 发表于
发表于 07-03 07:47
•2.1w次阅读
。 光刻胶去除是半导体芯片制造图形化环节中的关键技术,而光刻胶去除剂则是决定图形化最终良率及可靠性的关键材料之一。默克此次推出的“AZ® 910 去除剂”基于不含有NMP(N-甲基吡咯烷酮)的新型特制化学配方,不仅可以快速溶解残留光刻胶,同时具备超高的经济性、
![的头像]() 发表于
发表于 07-28 14:23
•2189次阅读

,增幅11.11%。 截图自企查查 光刻胶是芯片制造中光刻环节的重要材料,目前主要被日美把控,国内在光刻胶方面投入研制的厂商主要晶瑞股份、南大光电、上海新阳、徐州博康、北京科华等,那么华为投资的徐州博康在光刻胶方面有何优势,国内厂商在光
![的头像]() 发表于
发表于 08-12 07:49
•4712次阅读
光刻胶是光刻机研发的重要材料,换句话说光刻机就是利用特殊光线将集成电路映射到硅片的表面,如果想要硅片的表面不留下痕迹,就需要网硅片上涂一层光刻胶。
![的头像]() 发表于
发表于 02-05 16:11
•5943次阅读
关键词:氧气、微气泡、光刻胶、高剂量离子注入、气水界面 介绍 微气泡是一种很有前途的环保光刻胶去除方法的候选方法。已经证明,臭氧微气泡可以去除硅片上的光刻剂,即使被高剂量的离子注入破坏
发表于 01-10 11:37
•1078次阅读

,必须:1)保证光刻胶粘附,防止图案被蚀刻;2)防止蚀刻剂渗透到光致抗蚀剂/材料界面。为了避免后一种现象,了解蚀刻剂是否穿透光刻胶以及其扩散速率是至关重要的。 蚀刻垂直渗透的界面修饰已经在之前的工作中得到了证明。我
发表于 01-18 15:20
•272次阅读
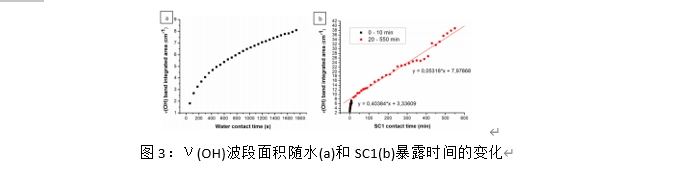
来源: 果壳硬科技 1、光刻胶究竟是怎样一个行业? 光刻胶,又称“光致抗蚀剂”,是光刻成像的承载介质,可利用光化学反应将光刻系统中经过衍射、滤波后的光信息转化为化学能量,从而把微细图形从掩模版转移到
发表于 01-20 21:02
•816次阅读

摘要 我们华林科纳提出了一种新型的双层光阻剂方法来减少负光阻剂浮渣。选择正光刻胶作为底层抗蚀剂,选择负光刻胶作为顶层抗蚀胶。研究了底层抗蚀剂的粘度和厚度对浮渣平均数量的影响。实验表明,低粘度正光刻胶
发表于 01-26 11:43
•491次阅读
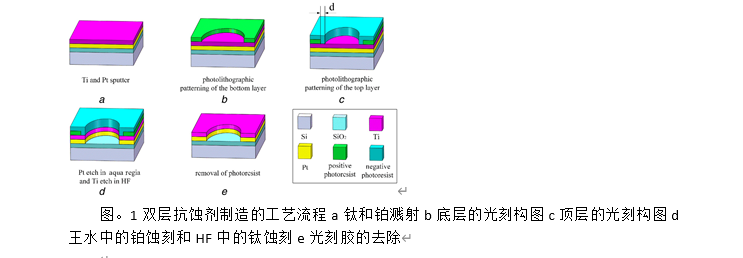
残留物。高剂量离子注入后,使用纯scco2不容易去除光刻胶。因此,加入极性溶剂作为高溶于scco2的共溶剂,以去除重有机物(光刻胶和光刻胶残留物)。单一共溶剂修饰的scco2体系不能有效去除,而是膨胀重有机
发表于 01-27 14:07
•1765次阅读
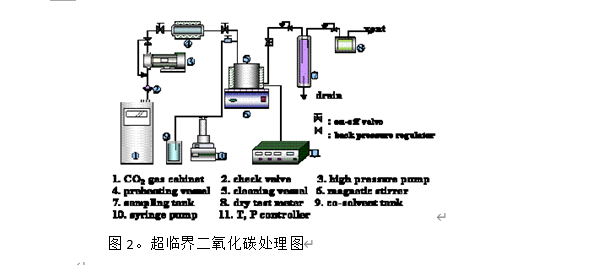
臭氧水中微气泡的存在显著提高了光刻胶的去除率,这是由于溶解臭氧浓度的升高和微气泡对自由基产生的直接影响。此外,臭氧微气泡溶液能够有效地去除高剂量离子植入的光刻胶,由于其非定形碳状层或“地壳”,它非常
发表于 01-27 15:55
•287次阅读
臭氧水中微气泡的存在显著提高了光刻胶的去除率,这是由于溶解臭氧浓度的升高和微气泡对自由基产生的直接影响。此外,臭氧微气泡溶液能够有效地去除高剂量离子植入的光刻胶,由于其非定形碳状层或“地壳”,它非常
发表于 02-11 15:24
•300次阅读
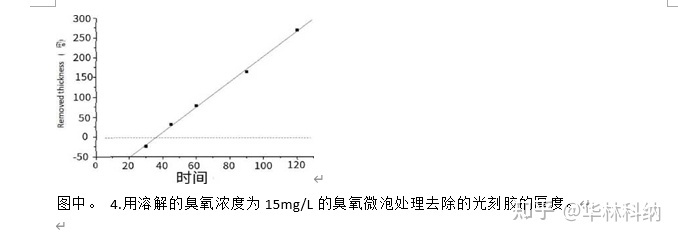
。气溶胶处理旨在破坏和部分去除植入抗蚀剂的结痂顶层,在该表面产生圆形开口,直径为数十至数百微米。在经过气溶胶预处理的晶片碎片浸入热的 H2SO4/H2O2 混合物 (SPM) 后,光学显微镜或局部 SEM 检测均未检测到抗蚀剂。 下一代器件面临的最关键挑战之一是有效去除离子注入后
发表于 02-28 15:00
•522次阅读

了晶圆厂占地面积,并降低了资本投资和运营成本。 在 CMOS 制造中,离子注入用于修改硅衬底以满足各种带隙工程需求。通常,图案化光刻胶 (PR) 用于定义离子注入位置。离子注入后,图案化的光刻胶必须完全去除,表面必须为下一轮的图
发表于 03-01 14:39
•942次阅读
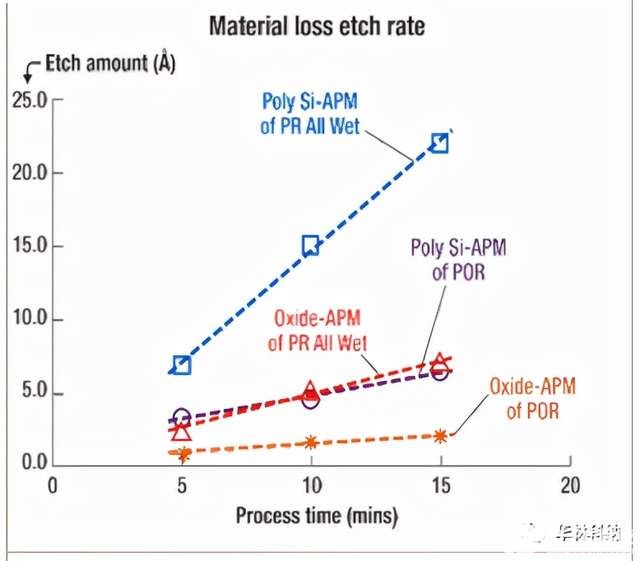
类型和智能流体®配方发生反应,将最有希望的组合进行到第二阶段进行深入研究。后续实验结果证明了通过改变工艺温度设置和添加兆声能来优化工艺参数。通过目视检查和接触角测量来量化光刻胶剥离结果。 介绍 光刻胶材料的去
发表于 03-03 14:20
•331次阅读

什么是光刻?光刻是将掩模上的几何形状转移到硅片表面的过程。光刻工艺中涉及的步骤是晶圆清洗;阻挡层的形成;光刻胶应用;软烤;掩模对准;曝光和显影;和硬烤。
发表于 03-15 11:38
•626次阅读

提供了一种在单个晶片清洁系统中去除后处理残留物的方法。该方法开始于向设置在衬底上方的邻近头提供第一加热流体。然后,在基板的表面和邻近头的相对表面之间产生第一流体的弯液面。基板在接近头下方线性移动。还提供了单晶片清洁系统。
发表于 03-22 14:11
•1156次阅读
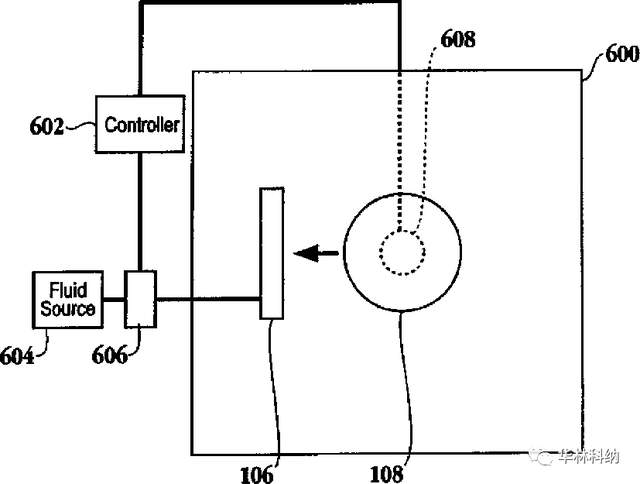
半导体的清洗在制造工序中也是非常重要的。特别是光刻胶的去除是最困难的,一般使用硫酸和过氧化氢混合的溶液(SPM)等。但是,这些废液的处理是极其困难的,与环境污染有很大的关系,因此希望引进环保的清洗技术。因此,作为环保的清洗技术之一,以蒸馏水、臭氧为基础,利用微气泡的清洗法受到关注。
发表于 03-24 16:02
•486次阅读
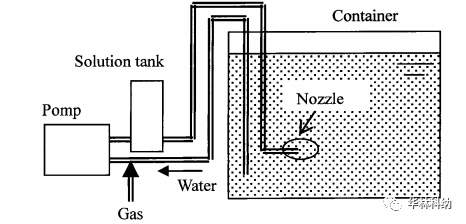
在未来几代器件中,去除光刻胶和残留物变得非常关键。在前端线后离子注入(源极/漏极、扩展),使用PR来阻断部分电路导致PR基本上硬化并且难以去除。在后端线(BEOL)蚀刻中,除低k材料的情况下去除抗蚀剂和残留物的选择性非常
发表于 03-24 16:03
•466次阅读
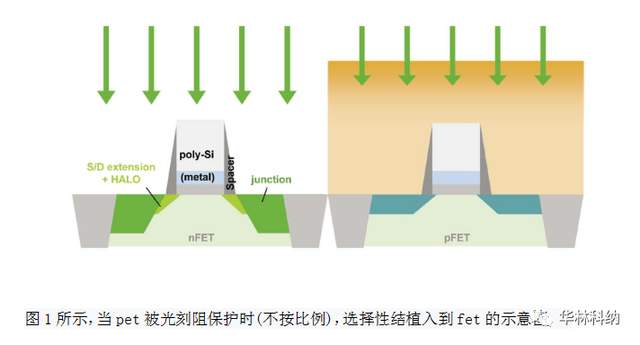
本文提出了一种新型的双层光阻剂方法来减少负光阻剂浮渣。选择正光刻胶作为底层抗蚀剂,选择负光刻胶作为顶层抗蚀胶。研究了底层抗蚀剂的粘度和厚度对浮渣平均数量的影响。实验表明,低粘度正光刻胶AZ703
发表于 03-24 16:04
•498次阅读
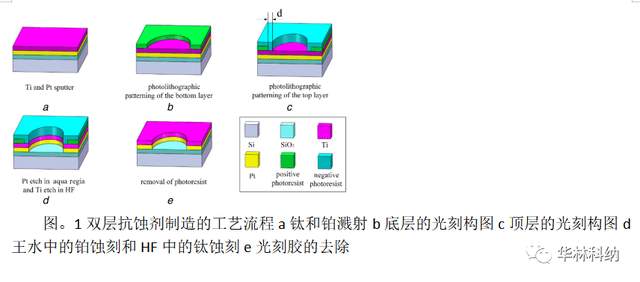
本发明涉及一种感光膜去除方法,通过使半导体制造工艺中浇口蚀刻后生成的聚合物去除顺畅,可以简化后处理序列,从而缩短前工艺处理时间,上述感光膜去除方法是:在工艺室内晶片被抬起的情况下,用CF4+O2等离子体去除聚合物的步骤; 将晶片安放在
发表于 04-12 16:30
•252次阅读
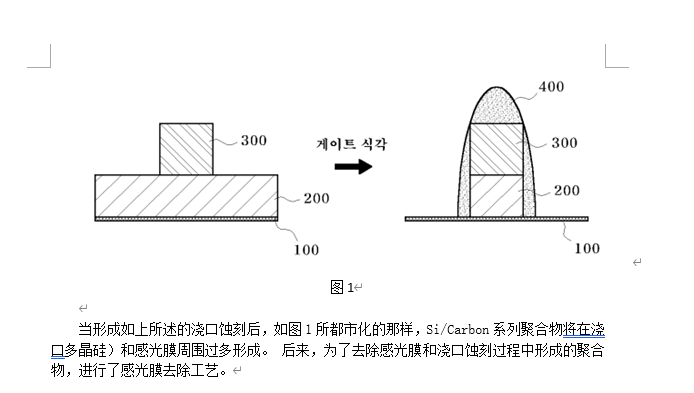
本发明涉及一种去除光刻胶的方法,更详细地说,是一种半导体制造用光刻胶去除方法,该方法适合于在半导体装置的制造过程中进行吹扫以去除光刻胶。在半导体装置的制造工艺中,将残留在晶片上的光刻胶,在H2O
发表于 04-13 13:56
•592次阅读
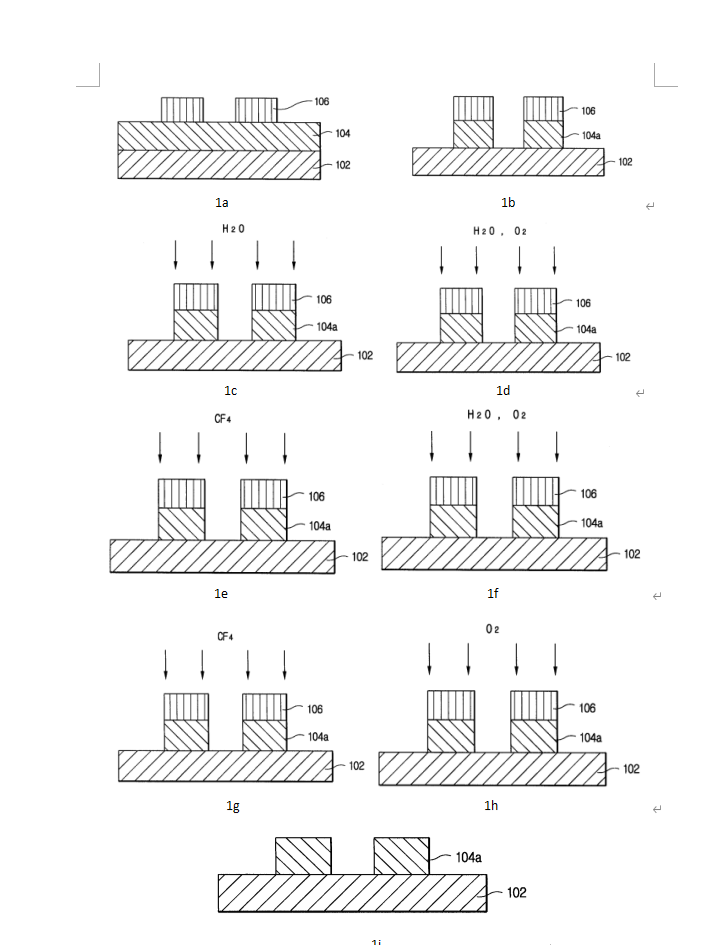
引言 光刻胶又称“光致抗蚀剂”或“光阻剂”,被广泛应用于光电信息产业的微细图形线路的加工制作,是微纳制造技术的关键性材料。 光刻胶是光刻工艺最重要的耗材,其性能决定了加工成品的精密程度和良品率
![的头像]() 发表于
发表于 04-25 17:35
•7485次阅读

本文研究了金属蚀刻残留物,尤其是钛和钽残留物对等离子体成分和均匀性的影响。通过所谓的漂浮样品的x射线光电子能谱分析来分析室壁,并且通过光发射光谱来监测Cl2、HBr、O2和SF6等离子体中的Cl
发表于 05-05 14:26
•534次阅读
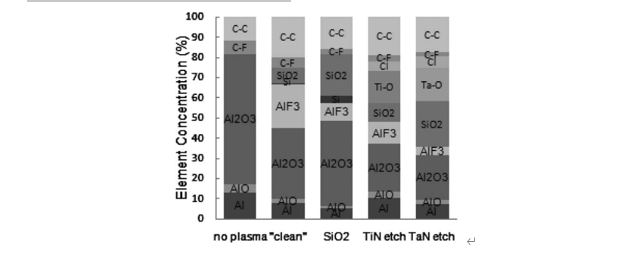
引起的,湿法清洗和干法蚀刻清洗工艺被用于去除多晶硅蚀刻残留物,这可能影响电特性和进一步的器件工艺。XPS结果表明,湿法清洗适用于蚀刻残留物的去除。
发表于 05-06 15:49
•789次阅读
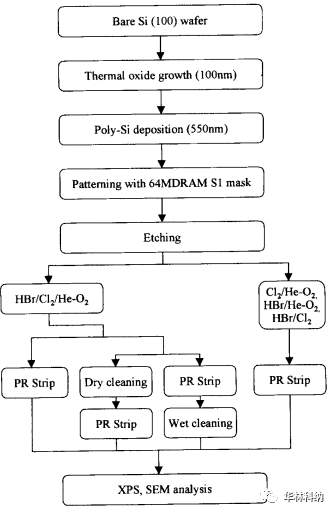
本文的目标是讨论一种新技术,它可以在保持竞争力的首席运营官的同时改善权衡。 将开发湿化学抗蚀剂去除溶液的能力与对工艺和工具要求的理解相结合,导致了用于光刻胶去除的单晶片清洗技术的发展。 该技术针对晶
发表于 05-07 15:11
•320次阅读

蚀刻后光刻胶和BARC层的去除,扫描电子显微镜(SEM)和X射线光电子能谱(XPS)用于评估清洗效率,使用平面电容器结构确定暴露于等离子体和湿化学对低k膜的介电常数的影响。 对图案化结构的横截面SEM检查表明,在几种实验条件和化学条件下可以实现
![的头像]() 发表于
发表于 05-30 17:25
•754次阅读
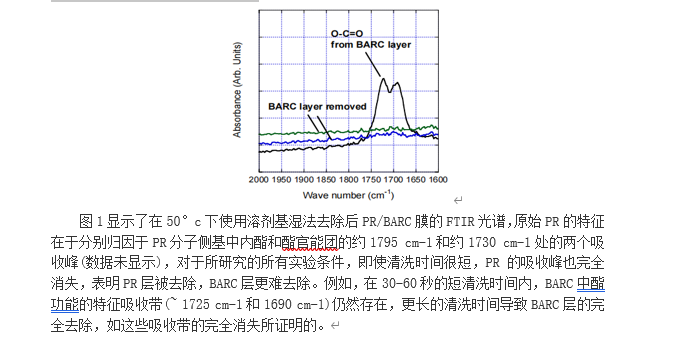
本文描述了我们华林科纳研究去除金属硬掩模蚀刻后光致抗蚀剂去除和低k蚀刻后残留物去除的关键挑战并概述了一些新的非等离子体为基础的方法。 随着图案尺寸的不断减小,金属硬掩模(MHM)蚀刻后留下的
![的头像]() 发表于
发表于 05-31 16:51
•2936次阅读
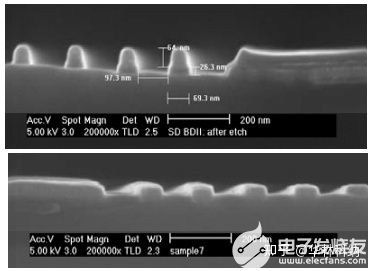
(BCB)。蚀刻工艺的固有副产物是形成蚀刻后残留物,该残留物包含来自等离子体离子、抗蚀剂图案、蚀刻区域的物质混合物,以及最后来自浸渍和涂覆残留物的蚀刻停止层(Au)的材料。普通剥离剂对浸金的蚀刻后
![的头像]() 发表于
发表于 06-09 17:24
•1450次阅读
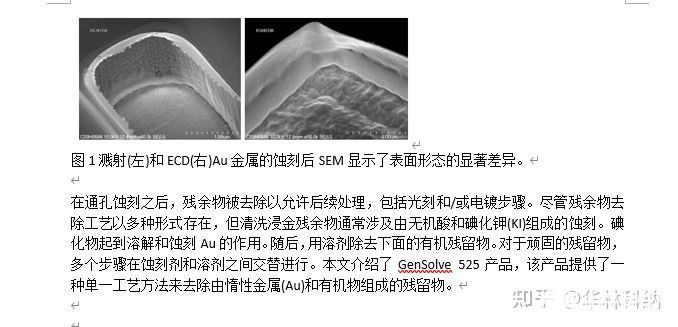
我们华林科纳半导体开发了一种新的湿法清洗配方方法,其锡蚀刻速率在室温下超过30/min,在50°c下超过100/min。该化学品与铜和低k材料兼容,适用于铜双镶嵌互连28 nm和更小的技术节点
![的头像]() 发表于
发表于 06-14 10:06
•1341次阅读
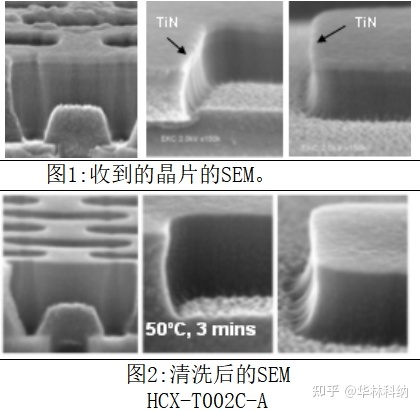
)开口的低k图案化中,观察到两个主要问题。首先,MHM开口后的干剥离等离子体对暴露的低k材料以及MHM下面的低k材料造成一些损伤。受损低k是非常易碎的材料,不应该被去除,否则将获得一些不良的轮廓结构。其次,连续的含氟低k蚀刻等离子体导致聚合物
![的头像]() 发表于
发表于 06-14 16:56
•888次阅读
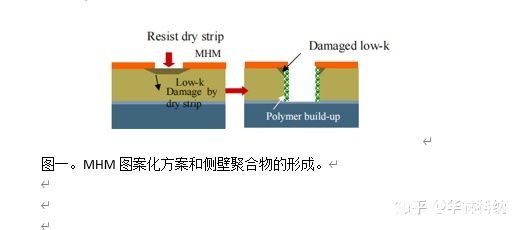
和扫描电子显微镜(SEM)来确定缺陷密度和通孔尺寸。使用光学显微镜、SEM和俄歇电子能谱(AES)完成对蚀刻后去除的分析。通过一系列评估,来自通用化学公司的化学物质被确定为能有效地同时去除光刻胶掩模和
发表于 06-23 14:26
•319次阅读

引言 介绍了一种蚀刻后残留物清洗配方,该配方基于平衡氢氟酸的腐蚀性及其众所周知的残留物去除特性。在最初由基于高k电介质的残留物提供的清洁挑战所激发的一系列研究中,开发了一种配方平台,其成功地清洁了由
![的头像]() 发表于
发表于 06-23 15:56
•661次阅读

本文章介绍了我们华林科纳一种光刻胶剥离用组合物,该组合物不仅对离子注入工艺后或离子注入工艺和高温加热工艺后硬化或变质为聚合物的光刻胶具有良好的去除力,而且使膜质腐蚀性最小化。半导体工艺中离子注入工艺
![的头像]() 发表于
发表于 07-01 15:16
•918次阅读

灰化,简单的理解就是用氧气把光刻胶燃烧掉,光刻胶的基本成分是碳氢有机物,在射频或微波作用下,氧气电离成氧原子并与光刻胶发生化学反应,生成一氧化碳,二氧化碳和水等,再通过泵被真空抽走,完成光刻胶的去除。
![的头像]() 发表于
发表于 07-21 11:20
•1783次阅读
光刻胶为何要谋求国产替代?中国国产光刻胶企业的市场发展机会和挑战如何?光刻胶企业发展要具备哪些核心竞争力?在南京半导体大会期间,徐州博康公司董事长傅志伟和研发总监潘新刚给我们带来前沿观点和独家分析。
![的头像]() 发表于
发表于 08-29 15:02
•4372次阅读

领域进行激烈竞争的时候,中国国产光刻胶企业在国内晶圆厂布局的成熟制程领域,展开了新产品上市和量产的争夺战。 南大光电最新消息显示,国产193nm(ArF)光刻胶研发成功,这家公司成为通过国家“02专项”验收的ArF光刻胶项目实施主体;徐州博康宣布,该
![的头像]() 发表于
发表于 08-31 07:45
•1949次阅读
南大光电最新消息显示,国产193nm(ArF)光刻胶研发成功,这家公司成为通过国家“02专项”验收的ArF光刻胶项目实施主体;徐州博康宣布,该公司已开发出数十种高端光刻胶产品系列,包括
![的头像]() 发表于
发表于 08-31 09:47
•868次阅读
光刻胶的组成:树脂(resin/polymer),光刻胶中不同材料的粘合剂,给与光刻胶的机械与化学性质(如粘附性、胶膜厚度、热稳定性等);感光剂,感光剂对光能发生光化学反应;溶剂(Solvent
![的头像]() 发表于
发表于 10-21 16:40
•5771次阅读
半导体光刻胶用光敏材料仍属于“卡脖子”产品,海外进口依赖较重,不同品质之间价 格差异大。以国内 PAG 对应的化学放大型光刻胶(主要是 KrF、ArF 光刻胶)来看,树脂在 光刻胶中的固含量占比约
![的头像]() 发表于
发表于 11-18 10:07
•1225次阅读
光刻胶是IC制造的核心耗材,技术壁垒极高。根据TECHCET数据,预计2022年全球半导体光刻胶市场规模达到23亿美元,同比增长7.5%,2025年超过25亿美元。
![的头像]() 发表于
发表于 03-21 14:00
•1477次阅读
此前该公司指出,公司已建成年产5吨ArF干式光刻胶生产线、年产20吨ArF浸没式光刻胶生产线及年产45吨的光刻胶配套高纯试剂生产线,具备ArF光刻胶及配套关键组分材料的生产能力,目前公司送样验证的产品均由该自建产线产出。
![的头像]() 发表于
发表于 04-11 09:25
•366次阅读
新的High NA EUV 光刻胶不能在封闭的研究环境中开发,必须通过精心设计的底层、新型硬掩模和高选择性蚀刻工艺进行优化以获得最佳性能。为了迎接这一挑战,imec 最近开发了一个新的工具箱来匹配光刻胶和底层的属性。
发表于 04-13 11:52
•64次阅读
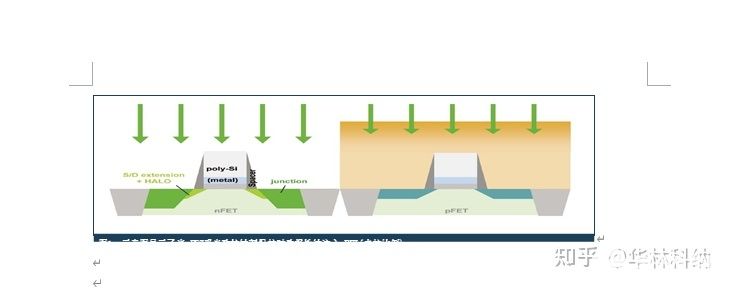

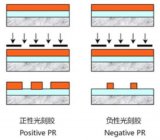


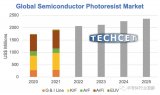


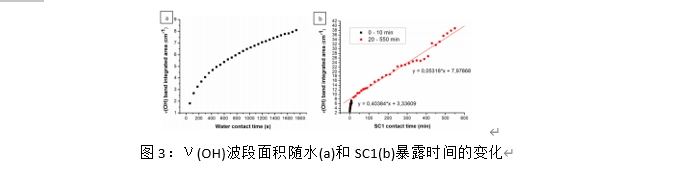

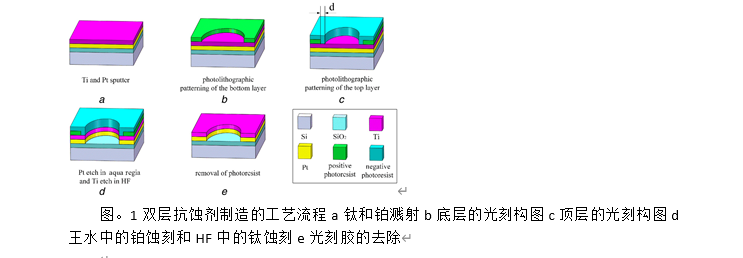
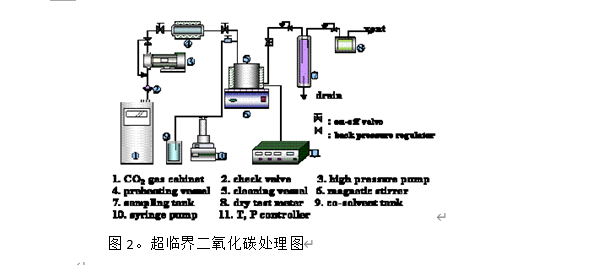
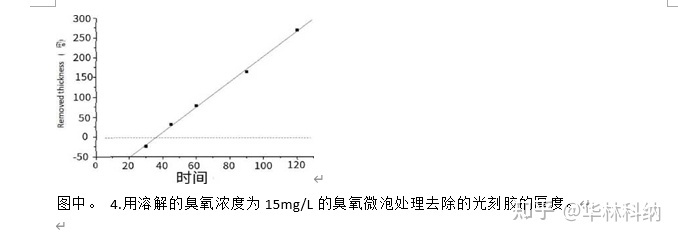

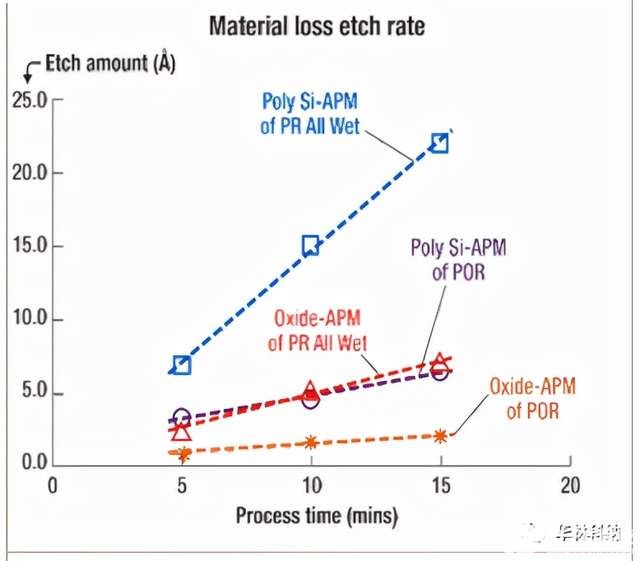


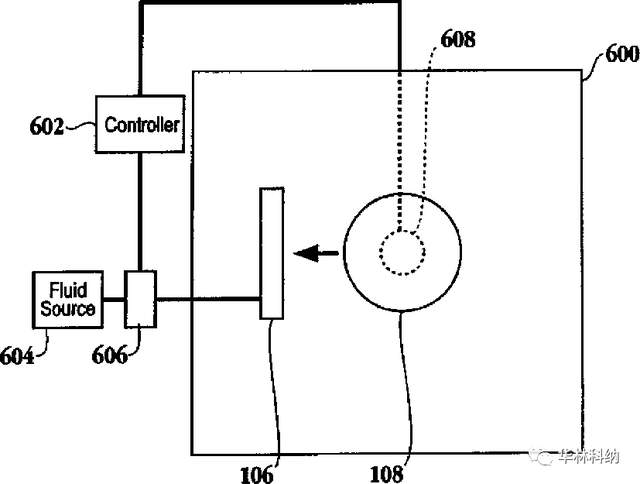
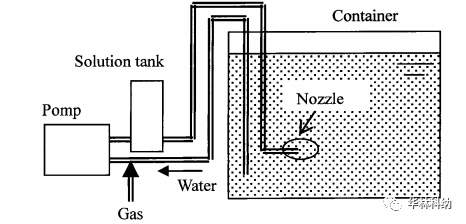
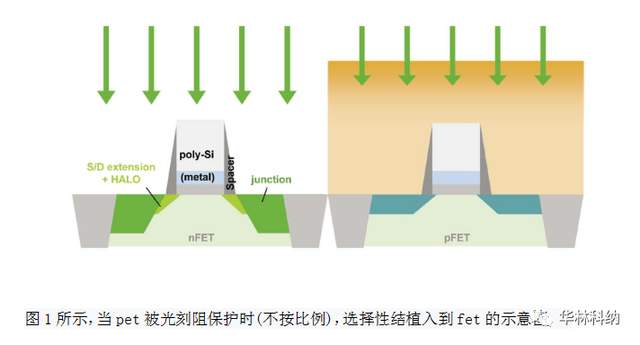
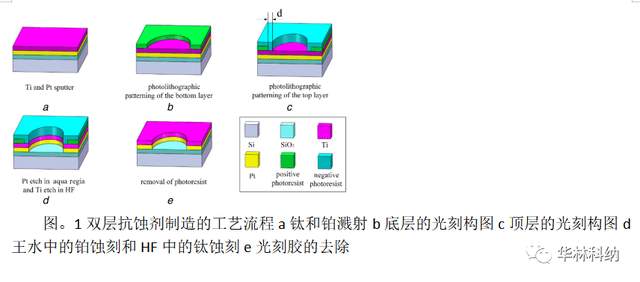
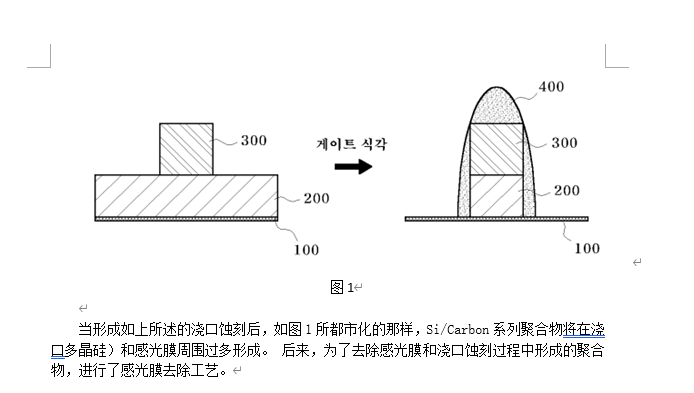
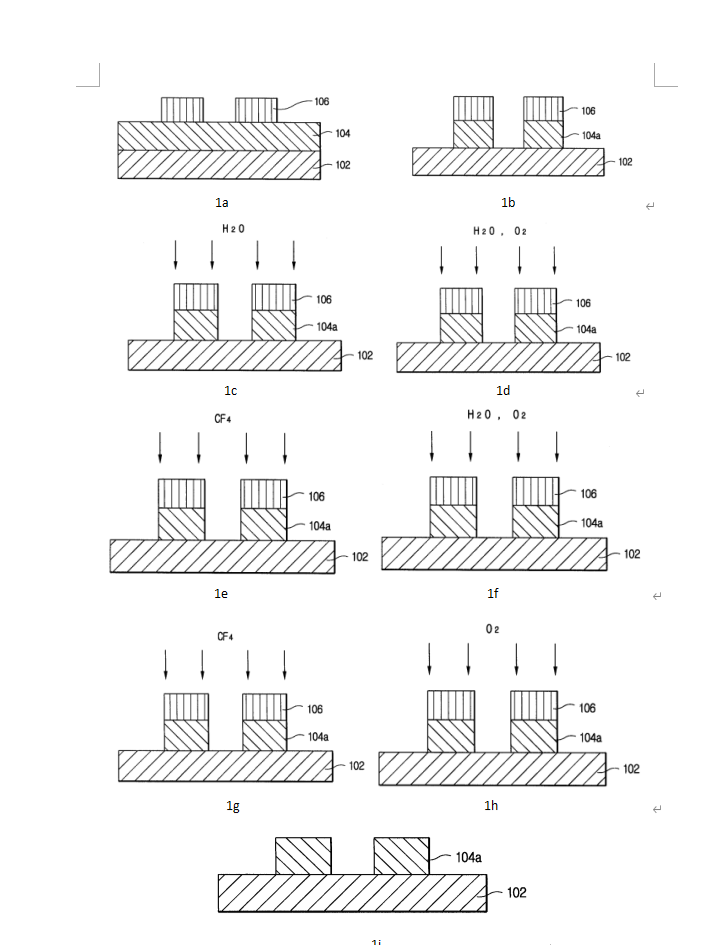

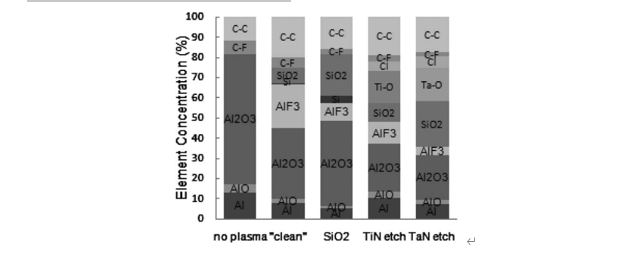
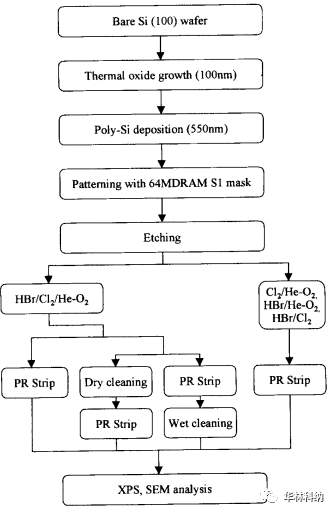

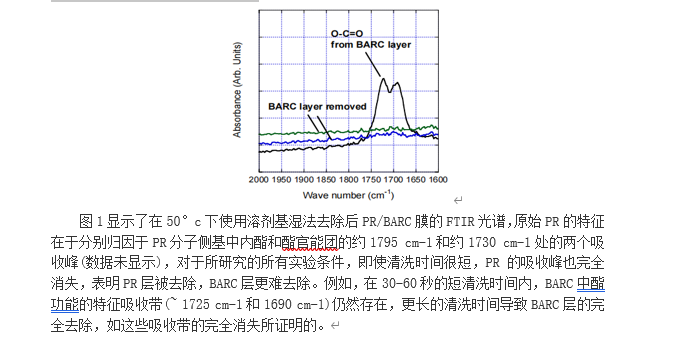
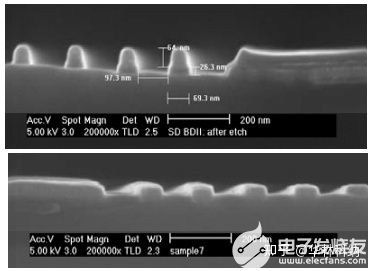
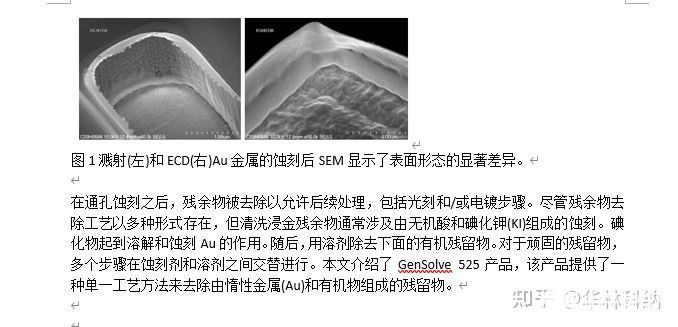
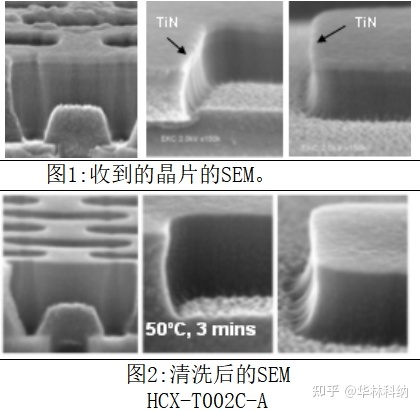
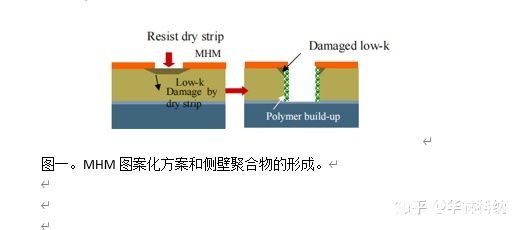








 蚀刻后残留物和光刻胶的去除方法
蚀刻后残留物和光刻胶的去除方法 0
0

















评论