本文章介绍了我们华林科纳一种光刻胶剥离用组合物,该组合物不仅对离子注入工艺后或离子注入工艺和高温加热工艺后硬化或变质为聚合物的光刻胶具有良好的去除力,而且使膜质腐蚀性最小化。半导体工艺中离子注入工艺是将3族或5族的离子加速到电场,使其具有足以穿透硅表面的大能量,注入到硅中的工艺,通过在硅中兴奋剂掺杂不纯离子,部分导电。
为了形成源/垂域,要经过高度量的离子注入工艺,从而加速了光刻胶上部的轻化,因而消除该光刻胶非常困难,为了去除这些光刻胶,用高温加热处理虽然会减小光刻胶的体积,但是光刻胶膜的硬化会加剧,而且由于光刻胶内部压力的上升而形成聚合物,因此也很难去除。为有效去除上述所述离子注入工艺后或离子注入工艺和高温加热后硬化或变质为聚合物的光刻胶,提出了多种干法、湿法方法。然而,这些干法蚀刻工艺不仅工艺复杂化,而且装备大规模化,带来的结果是产出率下降,反而成本增加,其他通常的方法是利用氧等离子体处理后的SPM溶液,存在不能去除硬化的光刻胶或聚合物的问题;另一方面,以往在湿法剥离及洗净工序中使用的光刻胶剥离液中,由有机胺、水溶性有机溶剂、文返修剂等组成的组合物被提出,使用量较大,然而,用上述胺类剥离溶液不能完全去除离子注入工艺后硬化的光刻胶,为了消除这些胺类剥离溶液的缺点,提出了由羟胺类化合物组成的剥离溶液或含有氟类化合物的组合物。
因此,我们华林科纳旨在提供一种光刻胶剥离用组合物及利用该组合物的剥离方法,该组合物不仅对离子注入工艺后或离子注入工艺和高温加热工艺后硬化或变质成聚合物的抗蚀剂具有良好的去除力,而且使膜质腐蚀性降至最低。
在本文的组合物中,防腐剂包括:含羟基或硝基的芳香族化合物;和从由直链多醇化合物组成的群中选择的一种或多种可以使用,含羟基或硝基的芳香族化合物有氢醌、儿茶酚、左旋醇、疲劳醇、甲氧基、褐酸、邻苯二甲酸等,直链多价醇化合物有松香醇、木糖醇、马尼醇、三唑等。防腐剂的含量以0.01~10重量使用为宜,如果使用重量小于0.01重量,则会硬化或聚合物变质的光刻胶的去除力下降,而且是导致膜质腐蚀的原因,超过10重量使用时,与硬化或聚合物变质的光刻胶的去除性能提高效果相比组合物的制造成本负担较大,因此从产业上的可利用性来看不利。
氟类化合物优选为氢氟酸、氟铵、氢铵、伏罗氟铵、氟硼酸、氟化氢或它们的混合物。
氟类化合物的含量以0.001~10重量为宜,此时,如果使用小于0.001重量,则该温浇注工艺后聚合物变质的光刻胶不能去除,而使用超过10重量,则严重影响膜质的腐蚀。
本文还提供了一种剥离方法,该方法不仅能完美去除高量离子注入工艺后或离子注入工艺和高温回火工艺后硬化,而且能将膜质腐蚀降至最低,剥离方法可采用业内通常已知的方法进行,如果剥离溶液与硬化或有聚合物变质的光刻胶的基板接触,则可获得良好的结果。 剥离方法包括:沉积、喷雾或利用沉积和喷雾的方法,淤积,喷雾,或经沉积和喷雾剥离;作为剥离条件,温度通常为10~100℃,优选为20~80℃,浸渍、喷雾或浸渍和喷雾时间通常为30~40分钟,优选为1~20分钟,但不严格适用于本发明,可在方便和适宜的条件下使用。

(1)剥离能力试验:高度离子注入工艺后或离子注入工艺和高温加热后硬化或变质为聚合物,将凝结在多晶硅表面的试片在温度65°C的剥离溶液中沉积20分钟,然后从剥离溶液中取出试片,用超纯水护发素1分钟,利用氮气干燥,并利用扫描电子显微镜评价了硬化或聚合物改性光刻胶对各组合物的去除性;
(2)腐蚀性试验:将涂有多晶硅的试片在温度65°C的剥离溶液中沉积20分钟,然后从剥离用液中取出试片,用超纯水护发素1分钟,利用氮气干燥,然后用膜厚测定仪,对腐蚀程度进行了评价。
本文章提供一种光刻胶剥离用组合物和利用这些组合物的剥离方法,能够同时剥离高剂量的离子注入工艺后或离子注入工艺和高温加热后硬化或变质为聚合物的光刻胶,并使膜的腐蚀性降至最低,在半导体元件制造工艺中,为了形成源/衬区,在离子注入掺杂的工艺后剥离工艺中发挥卓越的效果。
审核编辑 黄昊宇
-
半导体
+关注
关注
319文章
21154浏览量
199144 -
光刻胶
+关注
关注
9文章
224浏览量
29452
发布评论请先 登录
相关推荐
图形反转工艺用于金属层剥离的研究
Futurrex高端光刻胶
Microchem SU-8光刻胶 2000系列
光刻胶
光刻胶在集成电路制造中的应用
泛林集团旗下GAMMA®系列干式光刻胶剥离系统推出最新一代产品
使用超临界二氧化碳剥离碳化光刻胶的实验
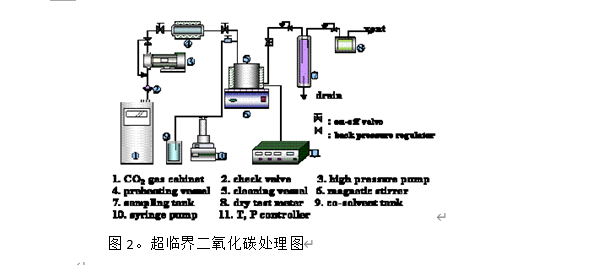
光刻胶剥离工艺—《华林科纳-半导体工艺》
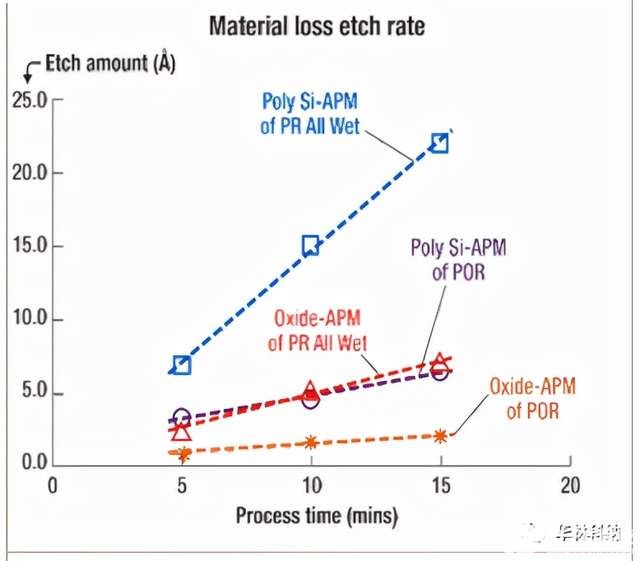
晶片光刻胶处理系统的详细介绍

光刻胶剥离工艺的基本原理
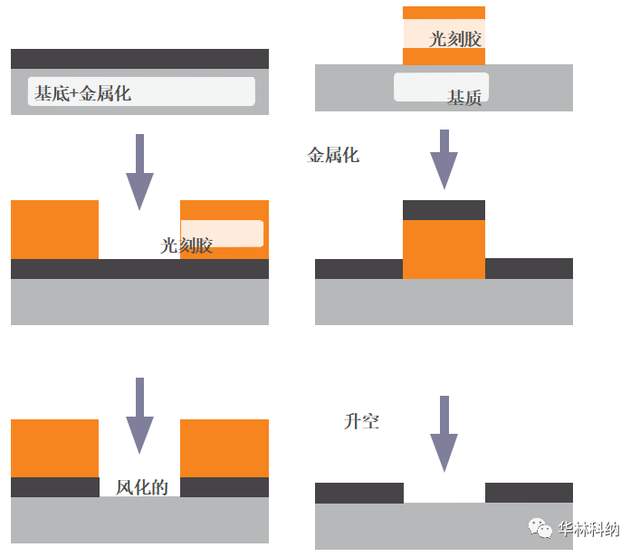




 光刻胶剥离用组合物及用其进行剥离的方法介绍
光刻胶剥离用组合物及用其进行剥离的方法介绍
















评论