引言
宽带隙氮化镓(GaN)优越的电子、化学、热和机械性能吸引了人们对开发功率开关器件和下一代半导体传感器的极大兴趣。通过对薄(20~30 nm) AlGaN的凹槽刻蚀,可以实现AlGaN/GaN高电子迁移率晶体管的势垒增强模式操作。AlGaN/GaN凹陷通常通过使用Cl2/BCl3等离子体的低功率反应离子蚀刻(RIE)来完成,这通常表现出深度控制困难、不均匀性、蚀刻残留物和由于离子轰击造成的晶格损伤。在电感耦合等离子体(ICP) RIE蚀刻过程中,将衬底温度从20℃提高到180℃,可以减少Cl基残留物的数量,并降低蚀刻表面的粗糙度。或者,在650℃下,在不氧化氮化镓的情况下,通过热氧化AlGaN阻挡层,并结合70℃下的氢氧化钾氧化蚀刻,成功地证明了这一点。
这本文中,我们提出了一种精确的,低损伤的循环刻蚀AlGaN/GaN的新方法,用于精确的势垒凹陷应用,使用ICP-RIE氧化和湿法刻蚀。设备功率设置的优化允许获得宽范围的蚀刻速率~0.6至~11纳米/周期,而相对于未蚀刻的表面,表面粗糙度没有任何可观察到的增加。
实验
本方法在2英寸蓝宝石晶片上,异质结构从衬底开始,由2个微米未掺杂氮化镓缓冲层、1纳米氮化铝夹层、21纳米未掺杂氮化铝镓74N阻挡层和1.5纳米氮化镓盖层组成。在蚀刻实验中,晶片表面被清洗并涂上300纳米的PECVD二氧化硅作为硬掩模。氧化物用光致抗蚀剂构图,并用缓冲氧化物蚀刻剂(BOE)蚀刻,因为它不蚀刻下面的氮化镓盖层。去除光刻胶后,将晶片切割成7×7 mm²的芯片,用于凹槽蚀刻实验。在第一次氧化之前,通过盐酸浸渍除去天然氧化物。在室温下,用等离子体刻蚀器进行氮化物氧化3分钟,然后用1∶4盐酸∶H2O溶液进行1分钟的氧化物刻蚀。使用两个ICP-RIE系统,它们具有不同的ICP源和射频偏置发生器功率范围。两个系统的氧化配方参数总结在表1中。在氧化过程中,只有O2气体被注入腔室。将3个芯片以随机取向同时装载到蚀刻室中,用于测试每个氧化配方。在3或4次蚀刻循环后,用BOE去除二氧化硅掩模。使用原子力显微镜测量蚀刻深度和表面粗糙度。通过测量测试样品上的多个点来确定每个周期的平均蚀刻速率。

表1 ICP-RIE氧化的工艺配方信息
结果和讨论
在这项工作中,我们研究了电感耦合等离子体和射频功率对氧等离子体氧化AlGaN/GaN的影响,而其他设置在所有实验中保持不变。使用AST系统测试的射频和电感耦合等离子体功率范围的平均蚀刻速率如图1所示。获得的结果显示蚀刻速率随着射频功率的增加而线性增加。获得了从约0.6至约6纳米/周期的宽范围的平均蚀刻速率。对电感耦合等离子体功率的依赖性不太明显,蚀刻速率变化很小,特别是对于300瓦和450瓦电感耦合等离子体功率。射频发生器用于控制等离子体离子的能量,而电感耦合等离子体发生器用于优化等离子体密度。
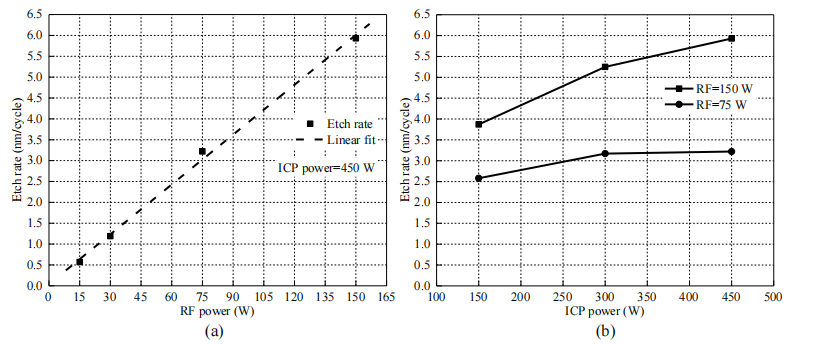
图1 蚀刻速率依赖于(a)恒定电感耦合等离子体功率下的射频功率和(b)使用AST蚀刻机的恒定射频功率下的电感耦合等离子体功率
我们得出结论,较高能量的O2离子可以更深地渗透到氮化物层中以形成更厚的氧化物,而在测试范围内等离子体密度没有显著耗尽,从而显著影响氧化过程。与使用相同功率参数450瓦/75瓦(电感耦合等离子体/射频)时的AST (3.22纳米/周期)相比,使用牛津仪器系统时获得了3.4倍高的蚀刻速率(11纳米/周期)。这些差异可归因于许多设备设计变化,例如:可用的发电机功率范围、腔室尺寸和设计、离子能量等。因此,为了获得所需的氧化深度,应进行设备特定的优化。用牛津仪器工具蚀刻3个周期后,测得的台阶高度为33纳米,表明氮化镓缓冲层也被蚀刻。
通过粗糙度测量评估基于等离子体反应离子刻蚀氧化的刻蚀后的表面损伤。未蚀刻(用BOE去除二氧化硅掩模后)和蚀刻层的原子力显微镜表面形貌图像如图2a-b所示。使用AST系统以450瓦/150瓦(电感耦合等离子体/射频)配方蚀刻3次后,均方根粗糙度保持不变。类似地,使用牛津仪器系统蚀刻后,粗糙度没有改变。
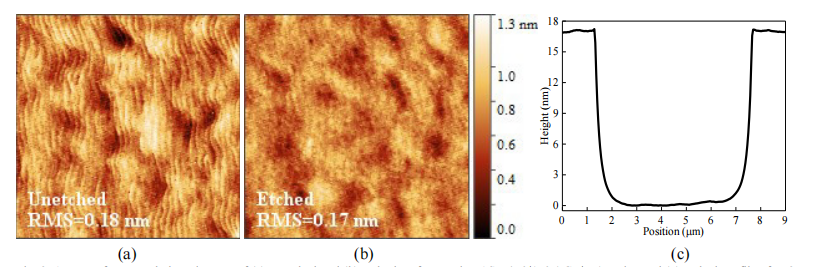
图2 (a)未蚀刻表面和(b)使用AST450/150(ICP/RF)配方和(c)3次氧化/蚀刻循环后的蚀刻表面形态图像
蚀刻的均方根粗糙度值分别为0.22纳米和0.21纳米。与直接等离子体蚀刻不同,用盐酸湿法蚀刻氧化层对氮化物层具有高度选择性,因此不会对下面的AlGaN/GaN造成表面损伤。横跨6微米沟槽的台阶轮廓,如图3c,显示光滑和均匀的底面。
总结
总之,我们已经证明了一种精确的、低损伤的循环刻蚀AlGaN/GaN的方法。获得了0.6 ~ 11nm/周期范围内的可控刻蚀速率。这种方法非常有希望在HEMT制造过程中在薄的AlGaN/GaN层中形成几纳米到几十纳米的精确凹槽,以及提高GaN HEMT基化学传感器的灵敏度,并且由于减少了所需的循环次数而适用于大体积微制造。未来的工作将包括研究优化氧化时间,以确定饱和氧化深度以及氧化过程中氧气流量的影响。该方法将进一步应用于制作高灵敏度的HEMT传感器。
审核编辑:符乾江

 电子发烧友App
电子发烧友App












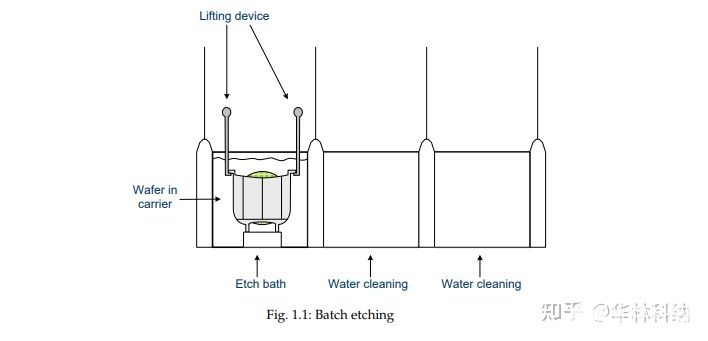


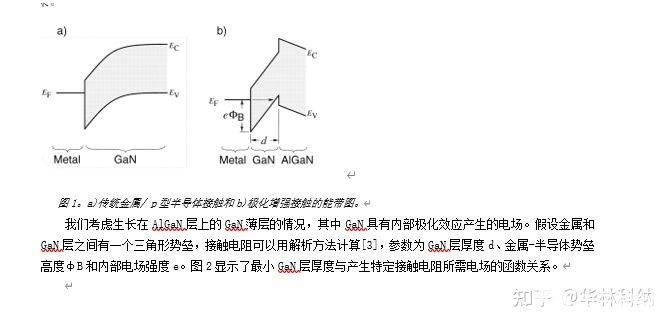



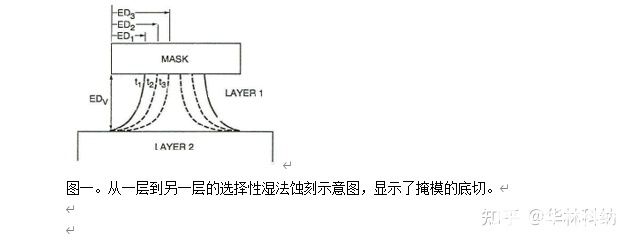




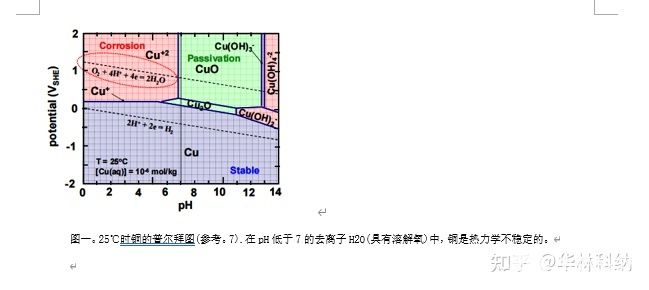
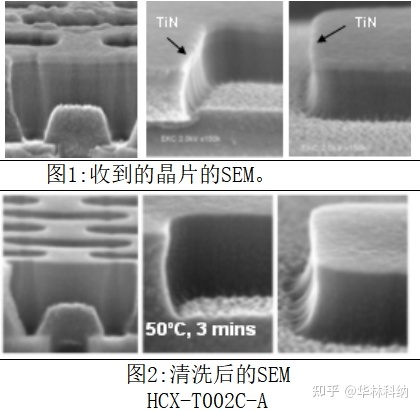



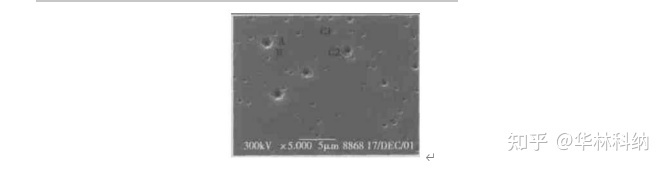


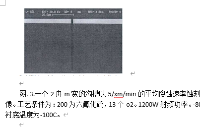

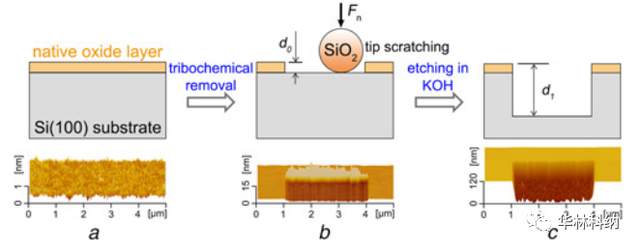

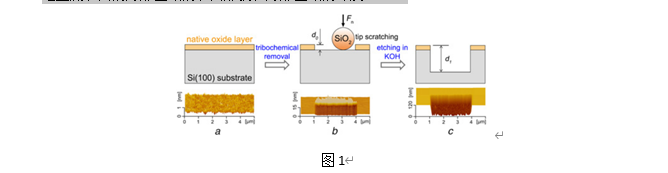

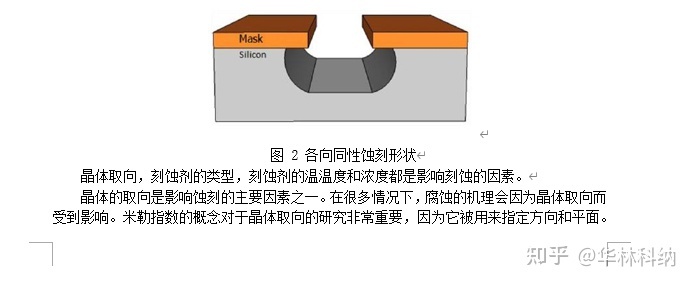
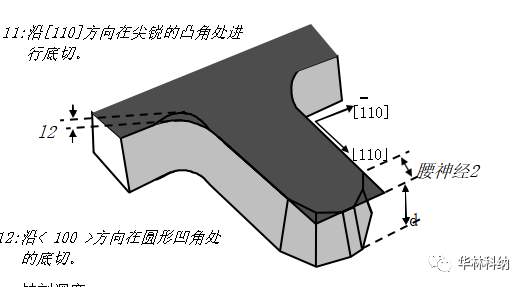

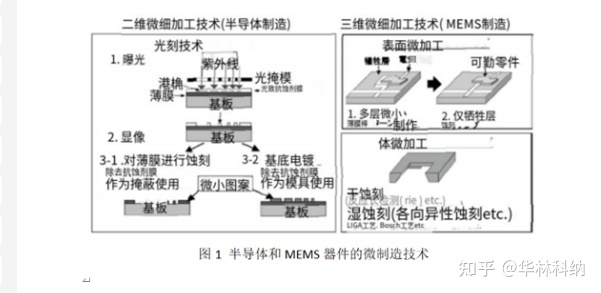


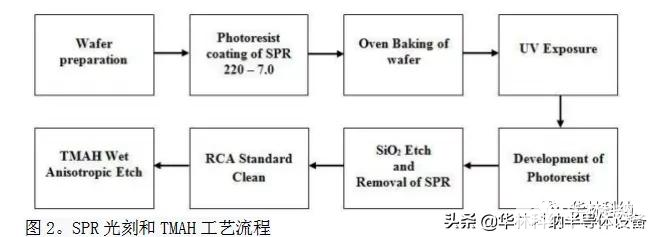

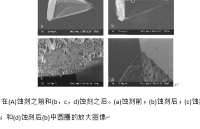
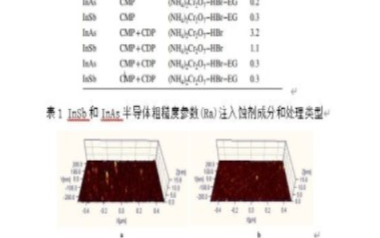




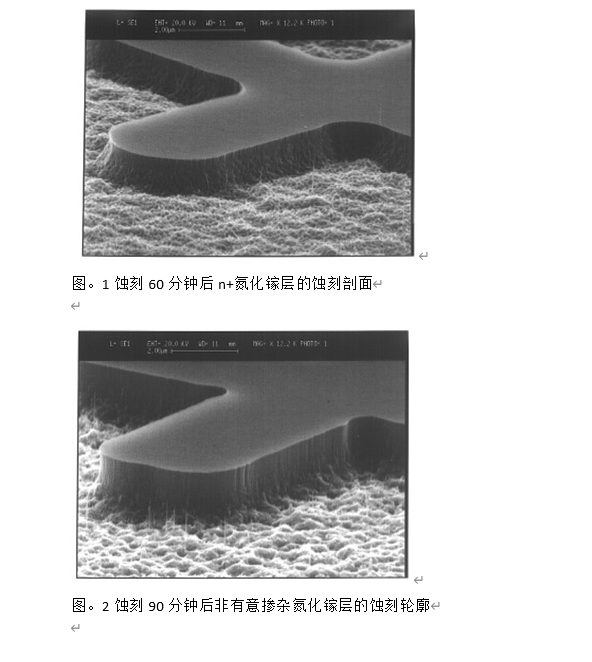
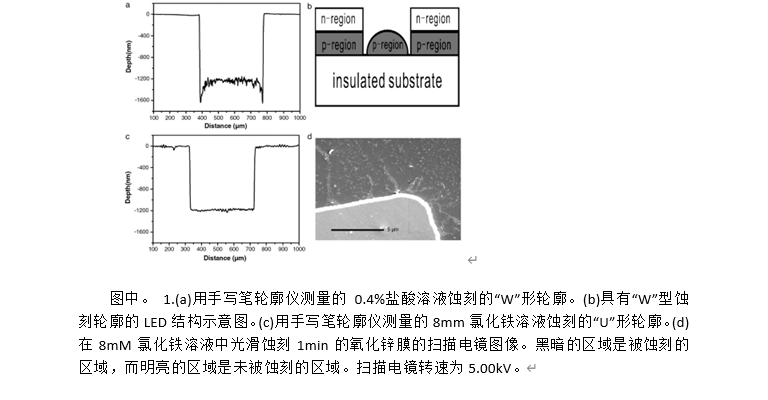

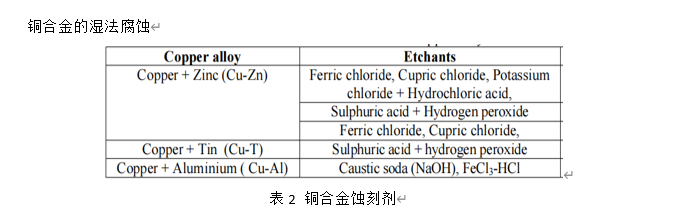

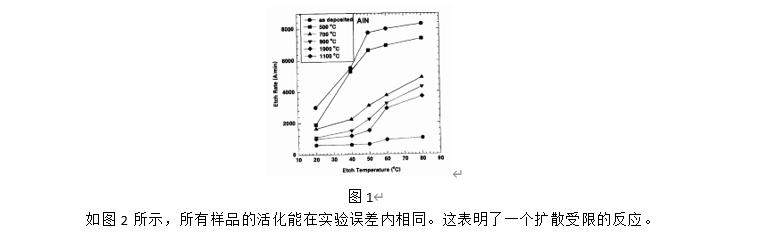


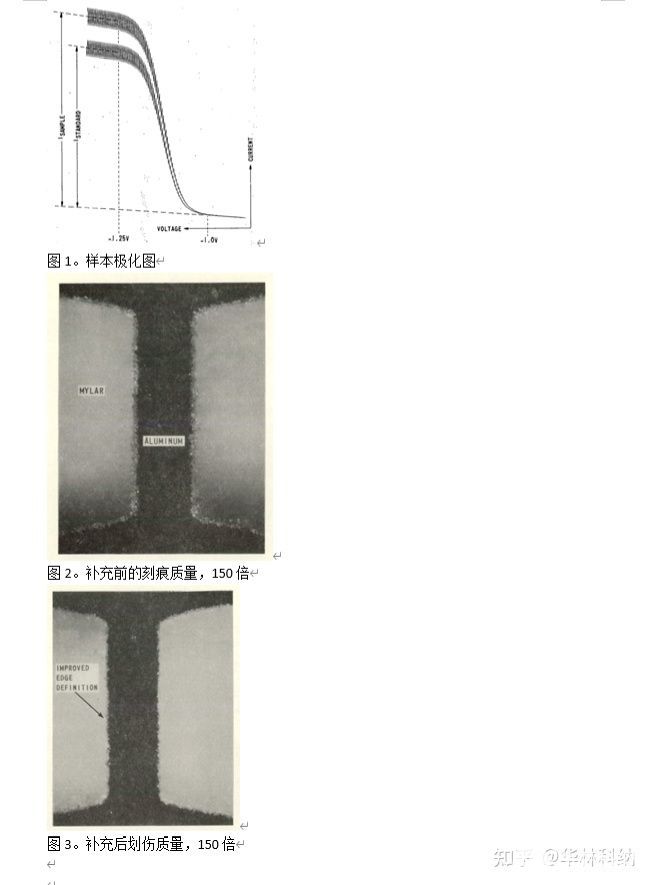

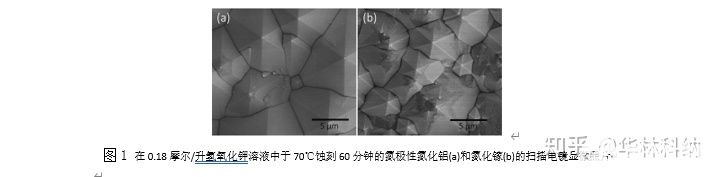

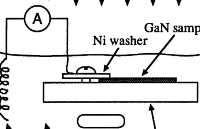
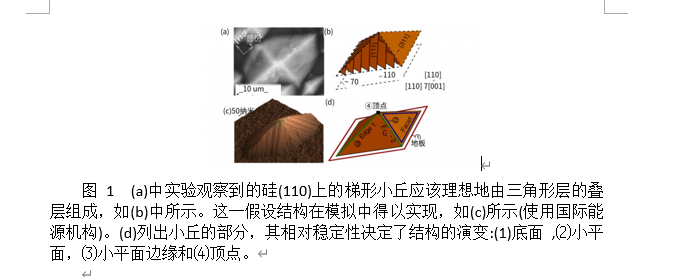
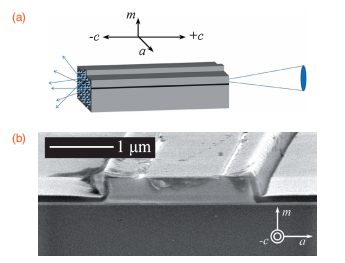
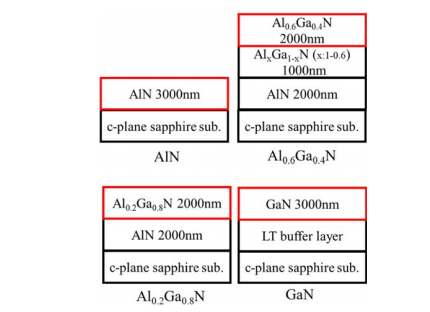


















评论