摘要
薄晶片已成为各种新型微电子产品的基本需求。更薄的模具需要装进更薄的包装中。与标准的机械背磨相比,在背面使用最终的湿法蚀刻工艺而变薄的晶片的应力更小。硅的各向同性湿式蚀刻通常是用硝酸和氢氟酸的混合物进行的,并添加化学物质,以调整单个晶圆旋转加工的粘度和表面润湿性。 随着硅被蚀刻并加入到蚀刻溶液中,蚀刻速率将随时间而减小。这种变化已经被建模了。本文的重点是比较过程控制技术,以保持一致的蚀刻率作为时间和晶片处理的函数。这些模型允许延长时间,补充化学品或这些物质的组合。
硅蚀刻:
硅的各向同性湿法蚀刻最常用的化学方法是硝酸和氢氟酸的结合物。它通常被称为HNA系统(HF:一基氮:醋酸与醋酸) ,作为湿式工作台应用程序的缓冲区添加。硝酸作为一种氧化剂,将其表面转化为二氧化硅,然后用高频蚀刻(溶解)该氧化物。
Si + 4HNO3 SiO2 + 4NO2 + 2H2O SiO2 + 6HF H2SiF6 + 2H2O
单个晶圆旋转处理器提供了蚀刻晶圆一侧的能力,同时保护另一侧。对于单一晶圆旋转处理器,需要添加具有更高粘度的化学物质,以在晶片表面提供更均匀的蚀刻。上述溶液中的醋酸被磷酸和硫酸的组合所取代。这些厚粘性酸不通过化学方式参与蚀刻反应,因此不会改变化学动力学,但会增加 由于粘度的增加而产生的传质阻力。有文献报道,在相同的去除率下,在高频和一硝酸的混合物中加入少量粘性酸会更有效地降低晶片的粗糙度。此外,HF和一氮的比值会影响蚀刻率和表面粗糙度。在高高频和低氮浓度下,该过程非常依赖于温度,反应速率控制,导致不稳定的硅表面。在低高频和高硝酸含量下,由于扩散限制反应,表面光滑抛光。化学反应的速率与sp有关。
实验:
实验结果在SSEC 3300系列单晶圆自旋处理器系统上进行。所采用的化学成分是氢氟酸、一硝酸、硫酸酸和磷酸酸的混合物,比例为1:6:1:2。使用SSEC的收集环技术进行了化学反应的再循环。在蚀刻过程中有许多工艺参数可以变化,从以往的工作中选择了一个优化工艺。
随着硅晶片被蚀刻的时间不变,我们可以看到蚀刻的深度逐渐减少(蚀刻率降低)。下面的图表显示了一个扩展的尺度,以便仔细查看数据和一个趋势线。这种经过加工的晶片的蚀刻深度(蚀刻率)的变化对于制造工艺是不可接受的。
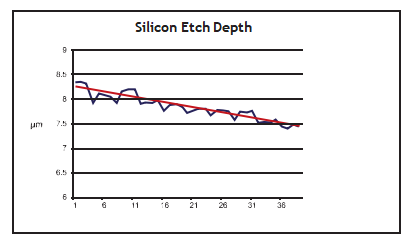
图1:恒定蚀刻时间下的硅蚀刻深度。

时间vs化学品
图3:每4小时增加蚀刻时间1秒。
在从蚀刻到冲洗的转换过程中,我们关闭收集杯并停止收集化学物质,以避免在化学物质中加入水。在此过程中损失的化学物质的量 短暂的时间(小于一秒)在我们所使用的流量下大约是30毫升。因此,在处理了400个晶片后,我们将消耗12升的化学供应,它将需要重新填充。此外,在某个时候,溶液中硅的含量将达到最大值,其化学性质将需要被取代。
另一种保持恒定蚀刻速率的方法是在化学混合物中加入活性成分(HF),或者不断地去除和补充化学溶液或这些溶液的某种组合。
下图显示了在每个晶圆片后加入30毫升化学物质的结果,其中加入的化学物质是5毫升HF和25毫升1:6:1:2混合物的混合物。
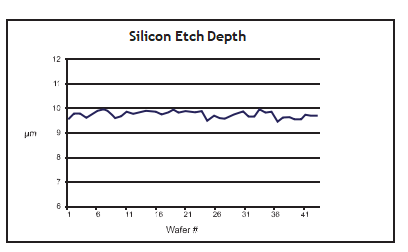
图4:添加化学品以保持恒定的蚀刻速率。
继续添加400片化学物质,我们看到了保持蚀刻率的能力。
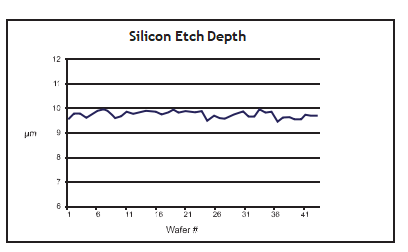
图5:增加时间或添加化学品的比较。
总结
随着硅晶片的蚀刻,可以观察到蚀刻速率的下降。HF峰值提供了一种补充活性成分的方法。与此同时,硅正以六氟硅酸的形式在溶液中积累起来。去除硅的唯一方法是在每个晶片上去掉一些溶液。晶圆尺寸将确定尖峰、去除和新鲜补充量,以达到稳定的平衡。就化学成本和系统停机时间而言,这是最低的拥有成本,并将导致随时间不变的蚀刻率。
审核编辑:汤梓红
相关推荐
集成电路芯片不断向高密度、高性能和轻薄短小方向发展,为满足IC封装要求,越来越多的薄芯片将会出现在封装中。此外薄芯片可以提高器件在散热、机械等方面的性能,降低功率器件的电阻。因此,硅片减薄的地位
发表于 05-04 08:09
北京华林嘉业科技有限公司(简称CGB),公司致力于为以下行业提供蚀刻、清洗、显影、去膜、制绒、减薄等高品质设备:半导体LED:硅片清洗机;硅片腐蚀机;硅片清洗腐蚀设备;基片湿处理设备;硅片清洗刻蚀
发表于 04-13 13:23
操作,并具备对PECVD或LPCVD工艺优化的能力; 4、 熟悉光刻工艺、湿法刻蚀;离子蚀刻(RIE, ICP etc)者优先;5、熟悉计算机操作,具备相关专业英语阅读能力; 6、工作认真细致、有
发表于 12-19 22:42
其中国市场的开发、推广。公司自有产品包括半导体前段、后段、太阳能、平板显示FPD、LED、MEMS应用中的各种湿制程设备,例如硅片湿法清洗、蚀刻,硅芯硅棒湿法化学处理,液晶基板清洗,LED基片显影脱膜等
发表于 04-02 17:23
我司是做湿法蚀刻药水的,所以在湿法这块有很多年的研究。所以有遇到湿法蚀刻问题欢迎提问,很愿意为大家解答。谢谢!QQ:278116740
发表于 05-08 09:58
。蚀刻工艺对设备状态的依赖性极大,故必需时刻使设备保持在良好的状态。【解密专家+V信:icpojie】 目前﹐无论使用何种蚀刻液﹐都必须使用高压喷淋﹐而为了获得较整齐的侧边线条和高质量的蚀刻效果
发表于 06-23 16:01
大家好!我司主要为国内半导体芯片设计公司、研究所及各大院校提供MEMS器件和系统封装设计、封装、测试、减薄划片及相关业务,专业的高精度传感器封装、测试能力;封装设计、生产和测试三位一体;为MEMS
发表于 01-11 09:02
大家好!我司主要为国内半导体芯片设计公司、研究所及各大院校提供MEMS器件和系统封装设计、封装、测试、减薄划片及相关业务,专业的高精度传感器封装、测试能力;封装设计、生产和测试三位一体;为MEMS
发表于 01-11 09:30
MEMS封装 SIP系统级封装、多层芯片叠层封装测试(F/T)wafer减薄划片 有需要了解的可以联系!谢谢!(MPW减薄、划片、切单颗服务) 加QQ893144436TEL:0573--83955218
发表于 03-19 14:05
。一.蚀刻的种类要注意的是,蚀刻时的板子上面有两层铜。在外层蚀刻工艺中仅仅有一层铜是必须被全部蚀刻掉的,其余的将形成最终所需要的电路。这种类型的图形电镀,其特点是镀铜层仅存在于铅锡抗蚀层的下面。另外一种
发表于 04-05 19:27
目前,印刷电路板(pcb)加工的典型工艺采用“图形电镀法”.即先在板子外层需保留的铜箔部分上,也就是电路的图形部分上预镀一层铅锡抗蚀层,然后用化学方式将其余的铜箔腐蚀掉,称为蚀刻。PCB蚀刻工艺
发表于 09-13 15:46
先在板子外层需保留的铜箔部分上,也就是电路的图形部分上预镀一层铅锡抗蚀层,然后用化学方式将其余的铜箔腐蚀掉,称为蚀刻。 一.蚀刻的种类 要注意的是,蚀刻时的板子上面有两层铜。在外层蚀刻工艺中仅仅有
发表于 09-19 15:39
。 ②仅在孔和图形上覆盖干膜,以干膜作抗蚀层。 ③在酸性蚀刻液中蚀去多余的铜,从而得到所需要的导线图形。 (3) 特点 ①工序较图形电镀蚀刻法简单,但工艺控制会困难些。日本不少企业用此工艺
发表于 09-21 16:45
需要开发新技术,实现背面减薄工艺集成,以提高硅片减薄的效率,减少芯片的碎裂。 1.2 划片工艺 减薄后的硅片被送进划片机进行划片,划片槽的断面往往比较粗糙,通常存在少量微裂纹和凹坑;有些地方甚至存在
发表于 11-05 15:57
腐蚀掉,称为蚀刻。要注意的是,这时的板子上面有两层铜.在外层蚀刻工艺中仅仅有一层铜是必须被全部蚀刻掉的,其余的将形成最终所需要的电路。这种类型的图形电镀,其特点是镀铜层仅存在于铅锡抗蚀层的下面。另外一种
发表于 11-26 16:58
晶圆的表面,将会给光刻工艺的光刻版造成损坏,同时造成器件的表面有针孔和曝光不好,影响产品的成品率。同时,通过边缘倒角可以规范晶圆直径。通常晶圆的直径是由滚圆工序来控制的,由于滚圆设备的精度所限,表面
发表于 09-17 16:41
`请问PCB蚀刻工艺质量要求有哪些?`
发表于 03-03 15:31
湿法蚀刻工艺的原理是使用化学溶液将固体材料转化为液体化合物。选择性非常高,因为所用化学药品可以非常精确地适应各个薄膜。对于大多数解决方案,选择性大于100:1。
发表于 01-08 10:12
是半导体制造,微机械和微流控设备中的重要过程,需要微尺度的特征来优化性能或创建层流态,这在宏观上几乎是不可能获得的。由于能够通过改变蚀刻剂浓度和蚀刻时间来轻松控制z轴蚀刻,因此常用于分层应用。缺点包括许多化学废物,其中许多是高酸性和多步过程。
发表于 01-08 10:15
为了在基板上形成功能性的MEMS结构,必须蚀刻先前沉积的薄膜和/或基板本身。通常,蚀刻过程分为两类:浸入化学溶液后材料溶解的湿法蚀刻干蚀刻,其中使用反应性离子或气相蚀刻剂溅射或溶解材料在下文中,我们将简要讨论最流行的湿法和干法蚀刻技术。
发表于 01-09 10:17
使用化学溶液去除材料。在 CMOS 制造中,湿法工艺用于清洁晶片和去除薄膜。湿法清洁过程在整个工艺流程中重复多次。一些清洁过程旨在去除微粒,而另一些则是去除有机和/或无机表面污染物。湿蚀刻剂可以是各向同性
发表于 07-06 09:32
:MacEtch 是一种湿法蚀刻工艺,可提供对取向、长度、形态等结构参数的可控性,此外,它是一种制造极高纵横比半导体纳米结构的简单且低成本的方法。 3 该工艺利用了在氧化剂(例如过氧化氢 (H2O2))和酸(例如
发表于 07-06 09:33
的历史蚀刻工艺进行了两个主要的工艺更改,这使得这项工作成为必要。首先,我们从 Clariant AZ4330 光刻胶切换到 Shipley SPR220-3。我们发现后者的光刻胶具有更好的自旋均匀性和
发表于 07-06 09:39
、135°C 以上溶于乙二醇的 KOH、180°C 溶于乙二醇的 NaOH。文章全部详情,请加V获取:hlknch / xzl1019^晶体蚀刻工艺中两个蚀刻步骤中的第一个用于确定蚀刻深度,它可以通过几种
发表于 07-07 10:24
书籍:《炬丰科技-半导体工艺》文章:GaN晶体蚀刻的几何方面和光子应用编号:JFSJ-21-044作者:炬丰科技网址:http://www.wetsemi.com/index.html摘要:湿法
发表于 07-08 13:09
`书籍:《炬丰科技-半导体工艺》文章:GaN 纳米线制造和单光子发射器器件应用的蚀刻工艺编号:JFSJ-21-045作者:炬丰科技网址:http://www.wetsemi.com
发表于 07-08 13:11
黄金。以上只是基于实验的基础,实验设备也比较简陋,如果再结合湿法清洗设备进行蚀刻工艺,效果会有明显的提高,南通华林科纳半导体设备有限公司生产的湿法清洗设备能在各方面满足要求,使清洗达到事半功倍的效果。 如有侵权,请联系作者删除
发表于 07-09 10:23
书籍:《炬丰科技-半导体工艺》文章:InGaP 和 GaAs 湿蚀刻工艺编号:JFKJ-21-010作者:炬丰科技关键词:InGaP,湿法蚀刻,蚀刻速率我们展示了在 HC1:H3P04:H2O2 中
发表于 07-14 10:12
书籍:《炬丰科技-半导体工艺》文章:宽禁带半导体湿法化学蚀刻工艺编号:JFKJ-21-011作者:炬丰科技宽带隙半导体具有许多特性,使其对高功率、高温器件应用具有吸引力。在本文中,我们回顾了三种重要
发表于 07-14 10:13
书籍:《炬丰科技-半导体工艺》文章:化学蚀刻GaN纳米柱阵列编号:JFKJ-21-009作者:炬丰科技我们研究了使用电感耦合等离子体 (ICP) 蚀刻和蚀刻后湿化学处理制造的 GaN 纳米柱阵列
发表于 07-14 10:15
操作降低了工艺整合的难度。附加工艺步骤(如晶片干燥或旋转)可轻松纳入。CSE 湿法工作台特别适用于电镀工艺的预处理和后处理,并且与 CSE 系统兼容。无论是半导体工业、微系统技术还是太阳能技术,CSE
发表于 07-16 15:14
重要材料的湿法腐蚀,即氧化锌、氮化镓和碳化硅。虽然氧化锌很容易在许多酸溶液中蚀刻,包括硝酸/盐酸和氢氟酸/硝酸,在非酸性乙酰丙酮中,第三族氮化物和碳化硅很难湿法蚀刻,通常使用干法蚀刻。已经研究了用于氮化
发表于 10-14 11:48
高效交错背接触(IBC)太阳能电池有助于减少太阳能电池板的面积,以提供足够的家庭消费能源。我们认为,即使在20μm的厚度下,借助光捕获方案,适当钝化的IBC电池也能保持20%的效率。在这项工作中,光刻和蚀刻技术被用于对厚度小于20μm的晶硅(cSi)晶片的深度蚀刻。
发表于 06-28 11:20
•0次下载
超细线蚀刻工艺技术介绍
目前,集成度呈越来越高的趋势,许多公司纷纷开始SOC技术,但SOC并不能解决所有系统集成的问题,因
发表于 03-30 16:43
•1047次阅读
本文首先介绍了PCB蚀刻工艺原理和蚀刻工艺品质要求及控制要点,其次介绍了PCB蚀刻工艺制程管控参数及蚀刻工艺品质确认,最后阐述了PCB蚀刻工艺流程详解,具体的跟随小编一起来了解一下吧。
发表于 05-07 09:09
•3.6w次阅读
在印制板外层电路的加工工艺中,还有另外一种方法,就是用感光膜代替金属镀层做抗蚀层。这种方法非常近似于内层蚀刻工艺,可以参阅内层制作工艺中的蚀刻。目前,锡或铅锡是最常用的抗蚀层,用在氨性蚀刻剂的蚀刻工艺
发表于 07-10 15:11
•2234次阅读

要注意的是,这时的板子上面有两层铜。在外层蚀刻工艺中仅仅有一层铜是必须被全部蚀刻掉的,其余的将形成最终所需要的电路。这种类型的图形电镀,其特点是镀铜层仅存在于铅锡抗蚀层的下面。另外一种工艺方法是整个
发表于 07-08 14:51
•1894次阅读

PCB板蚀刻工艺用传统的化学蚀刻过程腐蚀未被保护的区域。有点像是挖沟,是一种可行但低效的方法。在蚀刻过程中也分正片工艺和负片工艺之分,正片工艺使用固定的锡保护线路,负片工艺则是使用干膜或者湿膜来保护线路。用传统的蚀刻方法到线或焊盘的边缘是畸形的。
发表于 07-12 10:26
•2431次阅读
与湿法蚀刻相比,等离子蚀刻的一个主要优点是能够获得高度定向(各向异性)的蚀刻工艺。
发表于 10-07 15:51
•2038次阅读
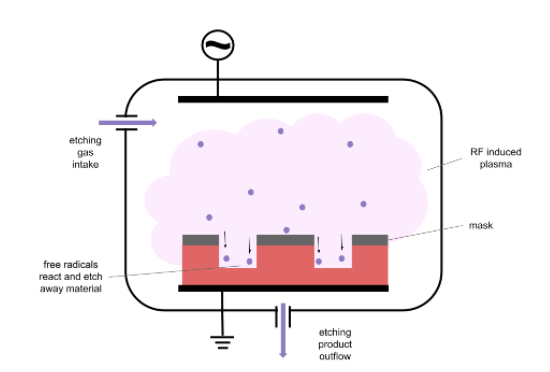
引言 了解形成MEMS制造所需的三维结构,需要SILICON的各向异性蚀刻,此时使用的湿式蚀刻工艺考虑的事项包括蚀刻率、长宽比、成本、环境污染等[1]。用于硅各向异性湿式蚀刻 溶液有KOH
发表于 12-23 09:55
•396次阅读
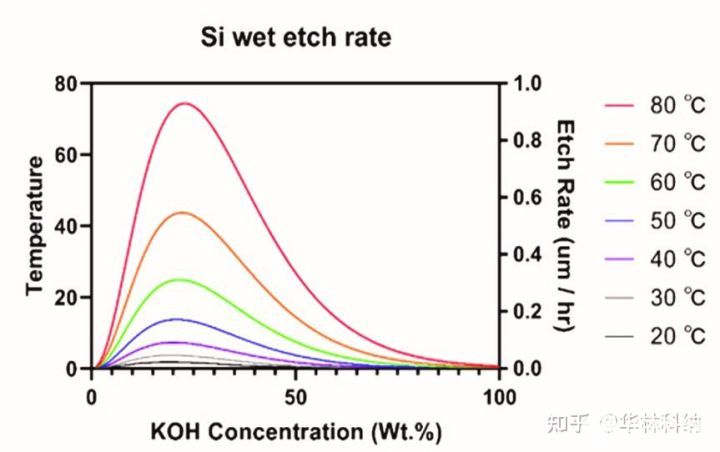
不可预测地改变了蚀刻剂的质量。 为了解决成分变化的问题,研究开始了确定一种可靠的分析蚀刻剂的方法。当分析程序最终确定时,将建立一个控制程序,其中蚀刻剂成分将保持尽可能接近一个固定的值。经过尝试的各种分析技术,
发表于 01-07 16:47
•576次阅读
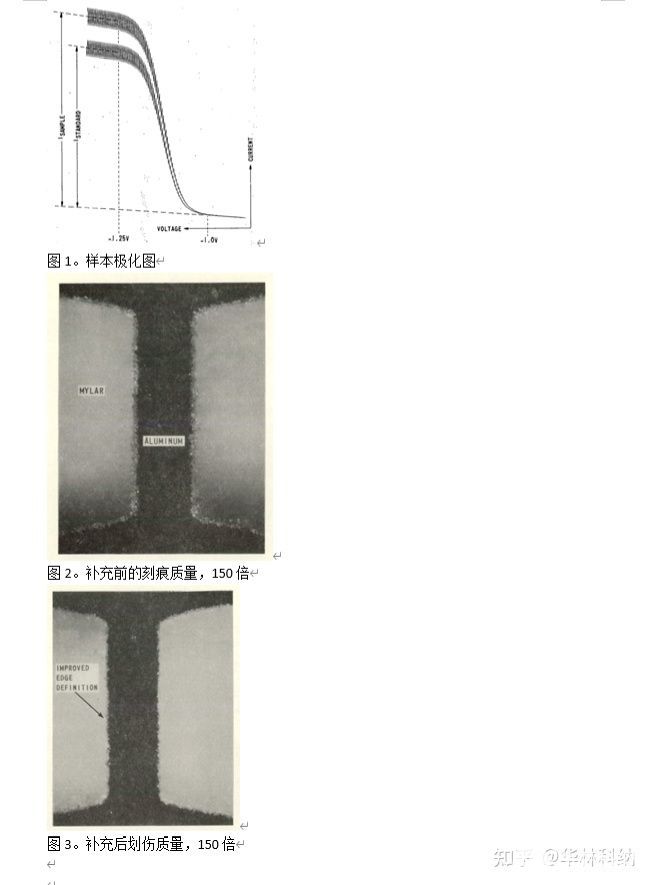
蚀刻的湿法蚀刻技术的方法。本文分析了玻璃湿法刻蚀工艺的基本要素,如:玻璃成分的影响、刻蚀速率、掩膜层残余应力的影响、主要掩膜材料的表征、湿法刻蚀工艺产生的表面质量。通过分析的结果,提出了一种改进的玻璃深度湿
发表于 01-19 16:13
•1419次阅读

本研究透过数值解析,将实验上寻找硅晶片最佳流动的方法,了解目前蚀刻阶段流动的形式,并寻求最佳晶片蚀刻条件,蚀刻工艺效率低利用气泡提高湿法蚀刻工艺效果,用实验的方法寻找最佳流动,通过数值分析模拟了利用
发表于 01-19 17:11
•196次阅读

湿法蚀刻工艺已经广泛用于生产各种应用的微元件。这些过程简单易操作。选择合适的化学溶液(即蚀刻剂)是湿法蚀刻工艺中最重要的因素。它影响蚀刻速率和表面光洁度。铜及其合金是各种工业,特别是电子工业的重要
发表于 01-20 16:02
•1190次阅读
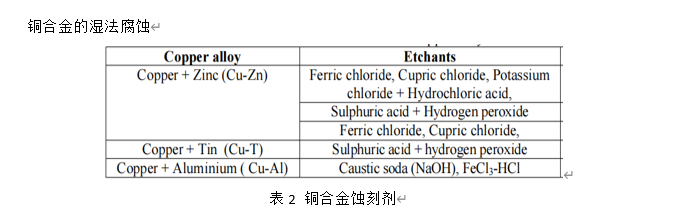
的组成,我们研究了两种类型的晶体表面形态,抛光和钝化的薄膜,形成后的化学动态(CDP)和/或化学机械抛光(化学机械抛光)在溶液中,饱和的溶剂和氧化剂,结果发现,在抛光蚀刻剂中,CDP和CMP工艺均能形成
发表于 02-14 16:47
•294次阅读
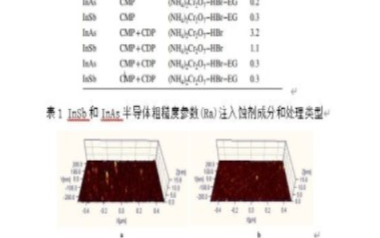
当硅片进行湿法化学蚀刻时,芯片的任何外角都可能面临严重的底切。这种咬边问题对于切屑的边界角来说是极其严重的;并且很多时候它会限制芯片设计的紧凑性。开发了一种特殊的蚀刻掩模图案,用于在湿化学蚀刻下保护
![的头像]() 发表于
发表于 02-21 13:34
•1270次阅读
半导体制造工业中的湿法清洗/蚀刻工艺用于通过使用高纯化学品清洗或蚀刻来去除晶片上的颗粒或缺陷。扩散、光和化学气相沉积(CVD)、剥离、蚀刻、聚合物处理、清洁和旋转擦洗之前有预清洁作为湿法清洁/蚀刻工艺
![的头像]() 发表于
发表于 02-22 13:47
•1227次阅读
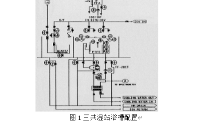
电感耦合等离子体反应离子蚀刻获得的高蚀刻速率和高度各向异性的轮廓。光增强湿法蚀刻提供了一种获得高蚀刻速率而没有离子诱导损伤的替代途径。该方法适用于器件制造以及n-氮化镓中位错密度的估算。这有可能发展成为一种快速评估材料的方法。
![的头像]() 发表于
发表于 02-23 16:20
•1755次阅读

:壹叁叁伍捌零陆肆叁叁叁本工作采用光刻和刻蚀技术对晶圆进行深度刻蚀,使晶圆厚度小于20μm。 关键词:IBC太阳能电池,掩模蚀刻,光刻,反应离子蚀刻,TMAH蚀刻 介绍 太阳能显示出供应潜力,这个因素取决于对高效率光伏器件和降低制造成本的需求
![的头像]() 发表于
发表于 02-23 17:43
•555次阅读
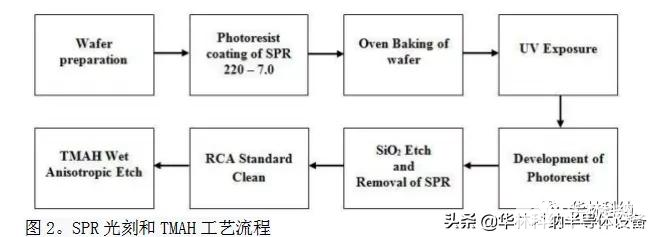
的氧化镍未完全去除造成的。这项研究对这些多余金属缺陷的成分进行了分类和确定,评估了推荐的去除氧化镍的湿蚀刻方法,最后提出了一种湿蚀刻工艺,该工艺将快速去除缺陷,同时继续保持所需的半各向异性蚀刻轮廓,这是大多数金属
发表于 02-28 14:59
•1105次阅读

摘要 低氧含量的湿法加工可能会提供一些优势,但是,完全控制在晶圆加工过程中避免吸氧仍然是单个晶圆工具上的短流程工业化的挑战。在线氧浓度监测用于工艺优化。然后,根据记录的氧浓度和处理室中气氛控制的硬件
发表于 03-02 13:59
•212次阅读

提高10倍的吞吐量。 虽然大多数公司使用干式蚀刻工艺来创建图案表面,但干式蚀刻的缺点并不小,包括加工设备的成本高,吞吐量低,扩展性差等等。 这种不利因素促使许多人重新燃起对湿法蚀刻的兴趣。历史上,标准
发表于 03-08 13:34
•277次阅读
硅的各向异性蚀刻是指定向依赖的蚀刻,通常通过碱性蚀刻剂如水溶液氢氧化钾,TMAH和其他羟化物如氢氧化钠。由于蚀刻速率对晶体取向、蚀刻剂浓度和温度的强烈依赖性,可以以高度可控和可重复的方式制备多种硅
发表于 03-08 14:07
•1565次阅读

通过使用各向同性和各向异性工艺,可以高精度地创建由硅湿法蚀刻产生的微观结构。各向同性蚀刻速度更快,但可能会在掩模下蚀刻以形成圆形。可以更精确地控制各向异性蚀刻,并且可以产生具有精确尺寸的直边。在每种
发表于 03-09 16:48
•1401次阅读
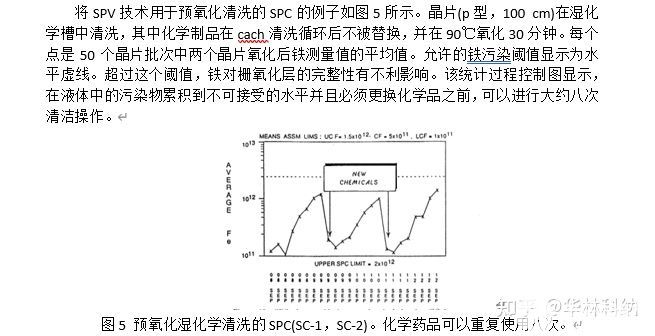
我们开发了一种改进的各向异性湿法蚀刻工艺,通过在晶片上使用单个蚀刻掩模来制造各种硅微结构,这些微结构具有圆形凹角和尖锐凸角、用于芯片隔离的凹槽、蜿蜒的微流体通道、具有弯曲V形凹槽的台面结构以及具有
发表于 03-14 10:51
•394次阅读
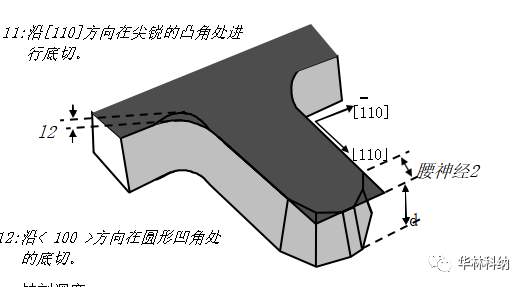
本文研究了用金刚石线锯切和标准浆料锯切制成的180微米厚5英寸半宽直拉单晶硅片与蚀刻时间的关系,目的是确定FAS晶片损伤蚀刻期间蚀刻速率降低的根本原因,无论是与表面结构相关,缺陷相关,由于表面存在的氧化层,还是由于有机残差。
发表于 03-16 13:08
•385次阅读

微加工过程中有很多加工步骤。蚀刻是微制造过程中的一个重要步骤。术语蚀刻指的是在制造时从晶片表面去除层。这是一个非常重要的过程,每个晶片都要经历许多蚀刻过程。用于保护晶片免受蚀刻剂影响的材料被称为掩模
发表于 03-16 16:31
•904次阅读
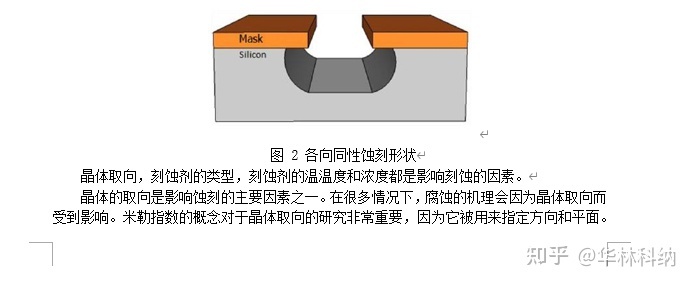
在半导体微器件的制造中,必须通过蚀刻各种材料,从表面移除整个层或将抗蚀剂图案转移到下面的层中。在蚀刻工艺中可以分为两种工艺:湿法和干法蚀刻,同时进一步分为各向同性和各向异性工艺(见下图)。
发表于 03-17 13:36
•278次阅读
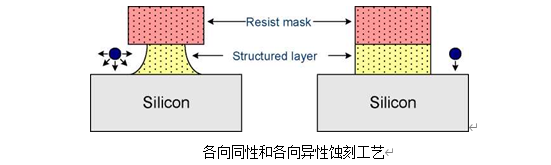
本文章将对表面组织工艺优化进行研究,多晶硅晶片表面组织化工艺主要分为干法和湿法,其中利用酸或碱性溶液的湿法蚀刻工艺在时间和成本上都比较优秀,主要适用于太阳能电池量产工艺。本研究在多晶晶片表面组织化工艺
发表于 03-25 16:33
•296次阅读

摘要 本文提出了一种用于实现贯穿芯片互连的包含沟槽和空腔的微机械晶片的减薄方法。通过研磨和抛光成功地使晶圆变薄,直至达到之前通过深度反应离子蚀刻蚀刻的空腔。研究了腐蚀结构损坏的可能原因。研究了空腔中
![的头像]() 发表于
发表于 03-25 17:03
•2413次阅读

在本研究中,我们设计了一个150mm晶片的湿蚀刻槽来防止硅片的背面蚀刻,并演示了优化的工艺配方,使各向异性湿蚀刻的背面没有任何损伤,我们还提出了300mm晶圆处理用湿浴槽的设计,作为一种很有前途的工艺发展。
发表于 03-28 11:01
•1516次阅读

本文提出了一种用于实现贯穿芯片互连的包含沟槽和空腔的微机械晶片的减薄方法。通过研磨和抛光成功地使晶圆变薄,直至达到之前通过深度反应离子蚀刻蚀刻的空腔。研究了腐蚀结构损坏的可能原因。研究了空腔中颗粒
发表于 03-29 14:56
•417次阅读
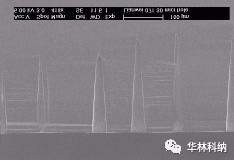
/MIR) 中的傅里叶变换红外光谱 (FTIRS)、高分辨率电子能量损失光谱 (HREELS)、X 射线光电子能谱 (XPS) 和原子用于分析用不同湿蚀刻程序处理的 GaAs (100) 样品的力显微镜
发表于 03-31 14:57
•464次阅读

晶圆薄化是实现集成电路小型化的主要工艺步骤,硅片背面磨至70微米的厚度被认为是非常关键的,因为它很脆弱。本文将讨论关键设备检查项目的定义和设置险。 所涉及的设备是内联晶圆背面研磨和晶圆安装。本研究
发表于 03-31 14:58
•3875次阅读

薄晶片已经成为各种新型微电子产品的基本需求。其中包括用于射频识别系统的功率器件、分立半导体、光电元件和集成电路。除了向堆叠管芯组件的转移之外,垂直系统集成和微机电系统器件中的新概念要求晶片厚度减薄到小于150米。
发表于 04-01 14:23
•167次阅读

的各向同性湿法蚀刻条件相比,由于非常高的各向异性,反应离子蚀刻工艺能够实现更好的蚀刻尺寸控制。尽管如此,当使用敏感材料(即栅极氧化物[1])或当尺寸放宽时,使用光敏抗蚀剂的湿法图案化仍然是参考工艺。本文研究了整个湿法腐蚀过程中抗蚀剂保
发表于 04-06 13:29
•445次阅读
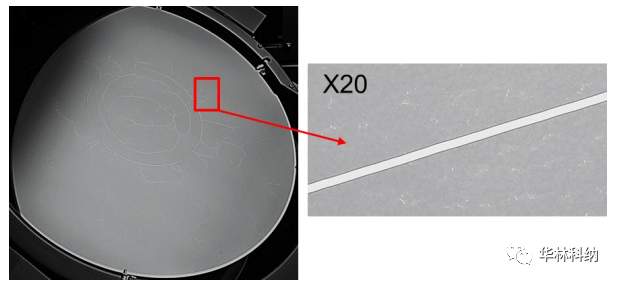
薄晶片已成为各种新型微电子产品的基本需求。 需要更薄的模具来适应更薄的包装。 使用最后的湿蚀刻工艺在背面变薄的晶圆与标准的机械背面磨削相比,应力更小。 硅的各向同性湿蚀刻通常是用硝酸和氢氟酸的混合物
发表于 04-07 14:46
•499次阅读

本文研究了用金刚石线锯切和标准浆料锯切制成的180微米厚5英寸半宽直拉单晶硅片与蚀刻时间的关系,目的是确定FAS晶片损伤蚀刻期间蚀刻速率降低的根本原因,无论是与表面结构相关,缺陷相关,由于表面存在的氧化层,还是由于有机残差。
发表于 04-18 16:36
•234次阅读
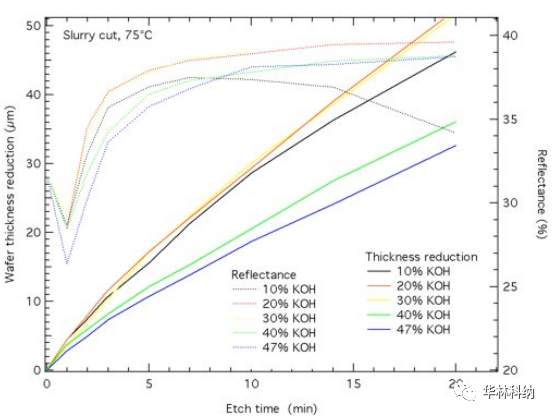
半导体制造工业中的湿法清洗/蚀刻工艺用于通过使用高纯化学品清洗或蚀刻来去除晶片上的颗粒或缺陷。扩散、光和化学气相沉积(CVD)、剥离、蚀刻、聚合物处理、清洁和旋转擦洗之前有预清洁作为湿法清洁/蚀刻工艺
发表于 04-21 12:27
•383次阅读

的各向同性湿法蚀刻条件相比,由于非常高的各向异性,反应离子蚀刻工艺能够实现更好的蚀刻尺寸控制。尽管如此,当使用敏感材料(即栅极氧化物[1])或当尺寸放宽时,使用光敏抗蚀剂的湿法图案化仍然是参考工艺。本文研究了整个湿法腐蚀过程中抗蚀剂保
发表于 04-22 14:04
•354次阅读
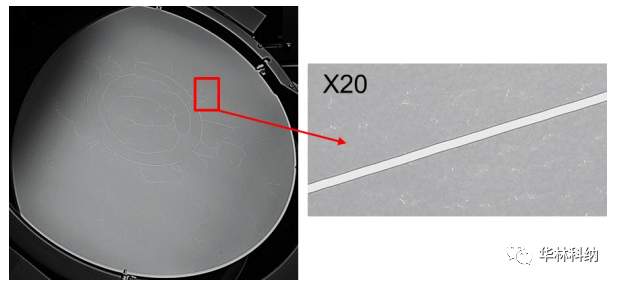
抛光的硅片是通过各种机械和化学工艺制备的。首先,通过切片将单晶硅锭切成圆盘(晶片),然后进行称为研磨的平整过程,该过程包括使用研磨浆擦洗晶片。 在先前的成形过程中引起的机械损伤通过蚀刻是本文的重点。在准备用于器件制造之前,蚀刻之后是各种单元操作,例如抛光和清洁。
发表于 04-28 16:32
•379次阅读
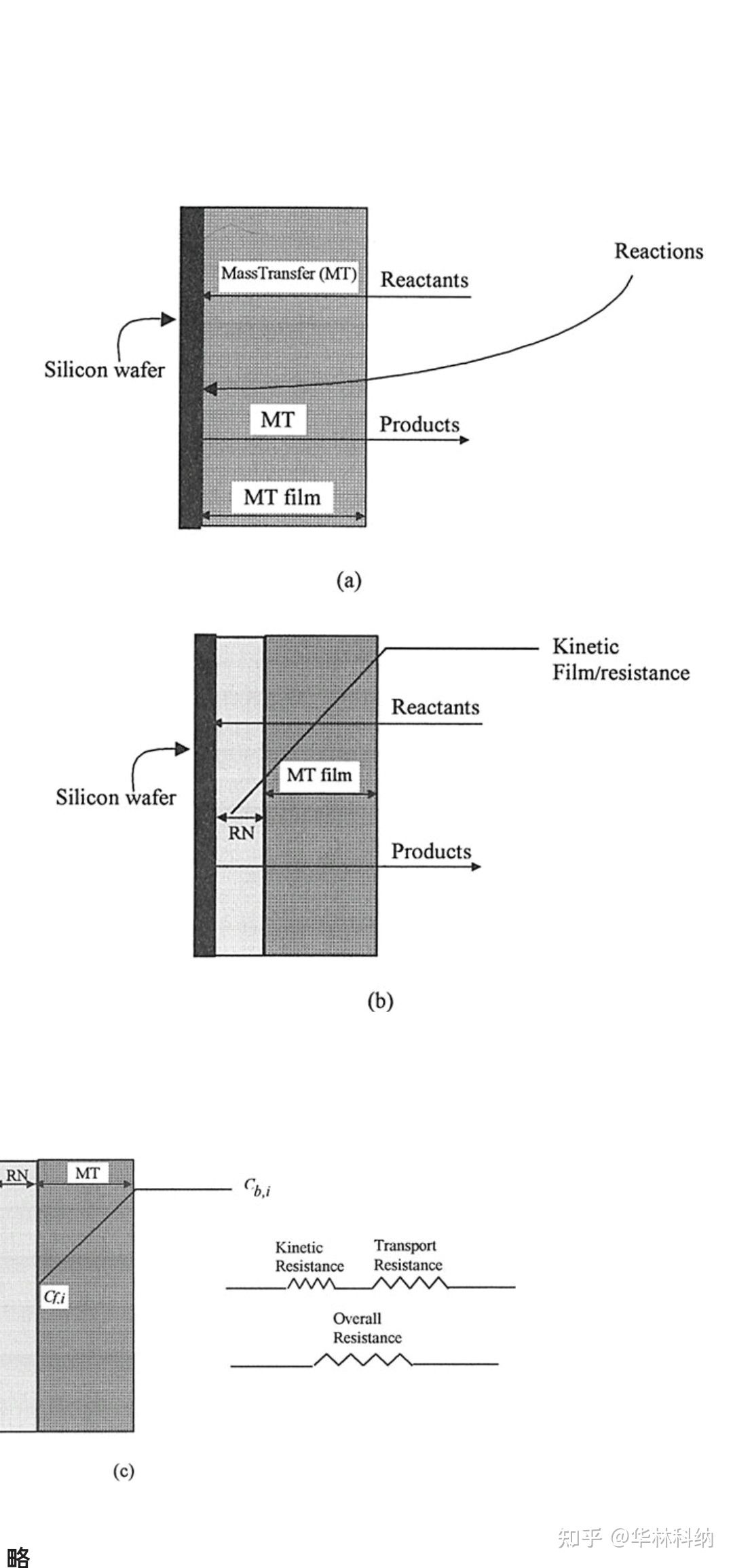
引起的,湿法清洗和干法蚀刻清洗工艺被用于去除多晶硅蚀刻残留物,这可能影响电特性和进一步的器件工艺。XPS结果表明,湿法清洗适用于蚀刻残留物的去除。
发表于 05-06 15:49
•785次阅读
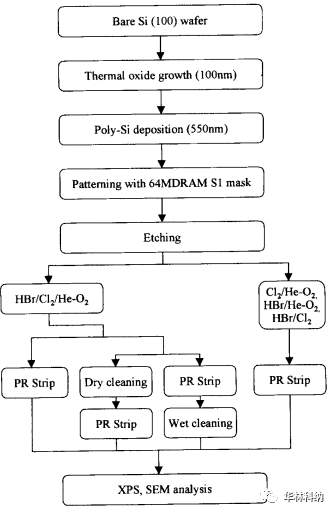
InAsSb材料用于彼此相对的蚀刻停止层,但是不希望其独特的II型破碎带隙对准的器件需要具有良好选择性的GaSb和AlGaAsSb之间的新的选择性湿法蚀刻剂。这里描述的所有湿法化学和干法蚀刻工艺都使用n型GaSb衬底进行了优化。
发表于 05-11 14:00
•668次阅读

,HF通常也用于湿法蚀刻钛粘附层,通过用氩(Ar)等离子体处理代替HF-dip并用基于过氧化氢(H2O2)的蚀刻剂蚀刻Ti层来避免在这两个步骤中使用HF。
![的头像]() 发表于
发表于 05-30 15:29
•1169次阅读
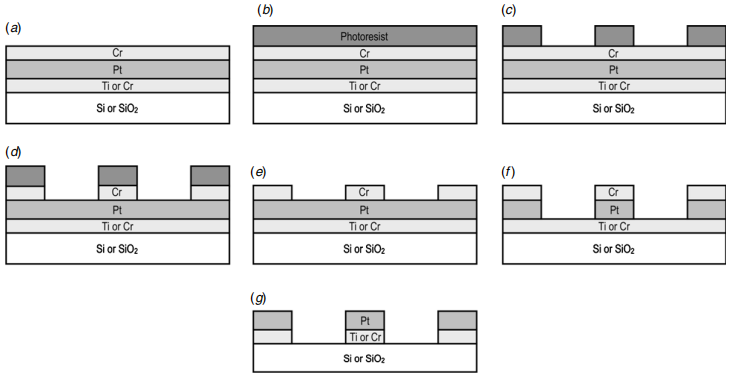
引言 本研究针对12英寸晶圆厂近期技术开发过程中后端一体化(AIO)蚀刻工艺导致的图案失效缺陷。AIO蚀刻直接限定了沟槽和通孔的形状,然而,包括层间介电膜的沉积、金属硬掩模和湿法清洗的那些先前的工艺
![的头像]() 发表于
发表于 06-01 15:55
•7541次阅读

初始屏蔽检查 对蚀刻工艺的良好理解始于理解初始掩模轮廓,无论是光致抗蚀剂还是硬掩模。掩模的重要参数是厚度和侧壁角度。如果可能,对横截面进行SEM检查,以确定适用于您的蚀刻步骤的不同特征尺寸的侧壁角度
![的头像]() 发表于
发表于 06-10 16:09
•4698次阅读

项工作中,使用光刻和蚀刻技术将晶体硅(c- Si)晶片深度蚀刻至厚度小于20 μm。使用SPR 220-7.0和SU-8光刻胶,使用四甲基氢氧化铵(TMAH)湿法各向异性蚀刻和基于等离子体的反应离子蚀刻(RIE)。二氧化硅用作TMAH蚀刻的制造层。4英寸c-Si晶片的TMAH
![的头像]() 发表于
发表于 06-10 17:22
•5613次阅读

蚀刻,加入CHCI以控制各向异性。大量的氦有助于光致抗蚀剂的保存。已经进行了支持添加剂作用的参数研究。 高速率各向异性等离子体蚀刻工艺对于提高加工VLSI晶片器件的机器的效率非常重要。这篇论文描述了这样一种用于以高速率( 5000埃/分
![的头像]() 发表于
发表于 06-13 14:33
•505次阅读

的逐层秘密。随着制造工艺的变化和半导体结构的变化,这些技术需要在时间和程序上不断调整。虽然有许多工具有助于这些分析,如RIE(反应离子蚀刻-一种干法蚀刻技术)、离子铣削和微切割,但钨的湿法化学蚀刻有时比RIE技术更具重现性。
![的头像]() 发表于
发表于 06-20 16:38
•3831次阅读

通过使用多级等离子体蚀刻实验设计、用于蚀刻后光致抗蚀剂去除的替代方法,以及开发自动蚀刻后遮盖物去除顺序;一种可再现的基板通孔处理方法被集成到大批量GaAs制造中。对于等离子体蚀刻部分,使用光学显微镜
发表于 06-23 14:26
•315次阅读

本文描述了我们华林科纳一种新的和简单的方法,通过监测腐蚀过程中薄膜的电阻来研究湿法腐蚀ITO薄膜的动力学,该方法能够研究0.1至150纳米/分钟之间的蚀刻速率。通常可以区分三种不同的状态:(1)缓慢
![的头像]() 发表于
发表于 07-01 14:39
•1257次阅读

薄晶片已经成为各种新型微电子产品的基本需求。这些产品包括用于RFID系统的功率器件、分立半导体、光电元件和集成电路。此外,向堆叠管芯组件的转变、垂直系统集成和MEMS器件中的新概念要求晶片厚度薄至小于150 μm。
![的头像]() 发表于
发表于 07-05 15:53
•2764次阅读

本文介绍了我们华林科纳在半导体制造过程中进行的湿法蚀刻过程和使用的药液,在晶圆表面,为了形成LSI布线,现在几乎所有的半导体器件都使用干蚀刻方式,这是因为干法蚀刻与湿法蚀刻相比,各向异性较好,对于形成细微的布线是有利的。
![的头像]() 发表于
发表于 07-06 16:50
•893次阅读

在半导体器件制造中,蚀刻指的是从衬底上的薄膜选择性去除材料并通过这种去除在衬底上产生该材料的图案的任何技术,该图案由抗蚀刻工艺的掩模限定,其产生在光刻中有详细描述,一旦掩模就位,可以通过湿法化学或“干法”物理方法对不受掩模保护的材料进行蚀刻,图1显示了这一过程的示意图。
发表于 07-06 17:23
•1980次阅读
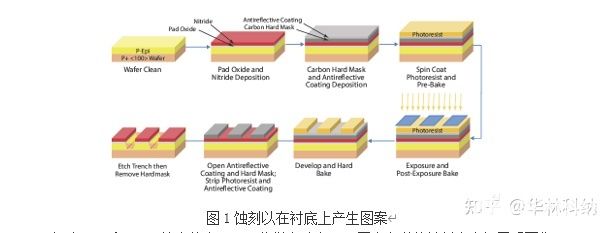
本文描述了我们华林科纳用于III族氮化物半导体的选择性侧壁外延的具有平面侧壁刻面的硅微米和纳米鳍的形成。通过湿法蚀刻取向的硅晶片生产鳍片。使用等离子体增强化学气相沉积来沉积二氧化硅,以产生硬掩模
发表于 07-08 15:46
•629次阅读

本文主要阐述我们华林科纳在补救InGaP/GaAs NPN HBT的喷雾湿法化学腐蚀过程中光刻胶粘附失效的几个实验的结果。确定了可能影响粘附力的几个因素,并使用实验设计(DOE)方法来研究所选因素
发表于 07-12 14:01
•819次阅读

50纳米,4,5,尽管最近有报道称rms粗糙度低至4–6纳米的表面。6光增强电化学(PEC)湿法蚀刻也已被证明适用于氮化镓(GaN)的蚀刻。7–10 PEC蚀刻具有设备成本相对较低和表面损伤较低的优势
![的头像]() 发表于
发表于 07-12 17:19
•2617次阅读

本次在补救InGaP/GaAs NPN HBT的喷雾湿法化学腐蚀过程中光刻胶粘附失效的几个实验的结果。确定了可能影响粘附力的几个因素,并使用实验设计(DOE)方法来研究所选因素的影响和相互作用。确定
发表于 07-13 16:55
•1557次阅读

引言 氢氧化钾(KOH)是一种用于各向异性湿法蚀刻技术的碱金属氢氧化物,是用于硅晶片微加工的最常用的硅蚀刻化学物质之一。各向异性蚀刻优先侵蚀衬底。也就是说,它们在某些方向上的蚀刻速度比在其
发表于 07-14 16:06
•1674次阅读

湿法蚀刻工艺的原理是利用化学溶液将固体材料转化为liquid化合物。由于采用了高选择性化学物质可以非常精确地适用于每一部电影。对于大多数解决方案选择性大于100:1。
发表于 07-27 15:50
•1117次阅读
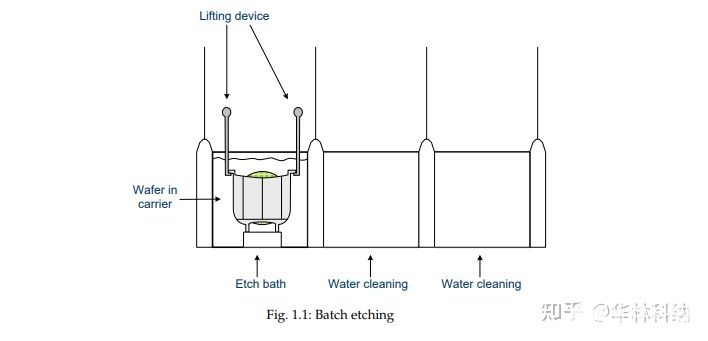
蚀刻工艺 蚀刻过程分类
发表于 08-08 16:35
•415次阅读
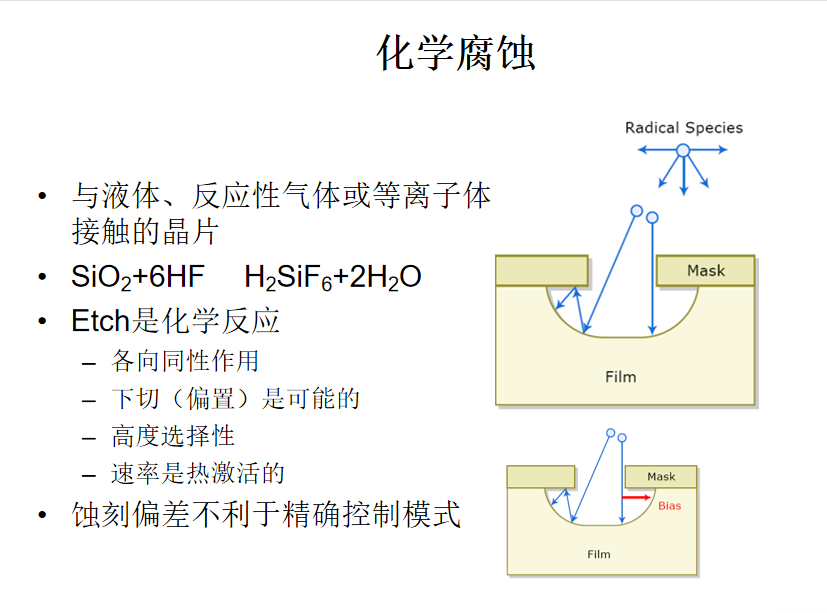
在半导体湿法蚀刻中, 热磷酸广泛地用于对氮化硅的去除工艺, 实践中发现温下磷酸对氮化硅蚀刻率很难控制。 从热磷酸在氮化硅湿法蚀刻中的蚀刻原理出发, 我们华林科纳分析了影响蚀刻率的各个因素, 并通过
![的头像]() 发表于
发表于 08-30 16:41
•1545次阅读

传统的光刻工艺是相对目前已经或尚未应用于集成电路产业的先进光刻工艺而言的,普遍认为 193nm 波长的 ArF 深紫外光刻工艺是分水岭(见下表)。这是因为 193nm 的光刻依靠浸没式和多重曝光技术的支撑,可以满足从 0.13um至7nm 共9个技术节点的光刻需要。
发表于 10-18 11:20
•6292次阅读
蚀刻不是像沉积或键合那样的“加”过程,而是“减”过程。另外,根据刮削方式的不同,分为两大类,分别称为“湿法蚀刻”和“干法蚀刻”。简单来说,前者是熔法,后者是挖法。
![的头像]() 发表于
发表于 01-29 09:39
•993次阅读
金属蚀刻是一种通过化学反应或物理冲击去除金属材料的技术。金属蚀刻技术可分为湿蚀刻和干蚀刻。金属蚀刻由一系列化学过程组成。不同的蚀刻剂对不同的金属材料具有不同的腐蚀特性和强度。
发表于 03-20 12:23
•199次阅读
印刷线路板从光板到显出线路图形的过程是一个比较复杂的物理和化学反应的过程,本文就对其最后的一步--蚀刻进行解析。目前,印刷电路板(PCB)加工的典型工艺采用"图形电镀法"。即先在
![的头像]() 发表于
发表于 03-29 10:04
•46次阅读
关键词:氢能源技术材料,耐高温耐酸碱耐湿胶带,高分子材料,高端胶粘剂引言:蚀刻(etching)是将材料使用化学反应或物理撞击作用而移除的技术。蚀刻技术可以分为湿蚀刻(wetetching)和干蚀刻
![的头像]() 发表于
发表于 03-15 17:57
•0次阅读

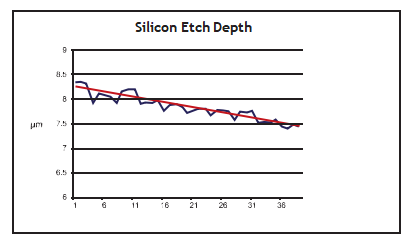

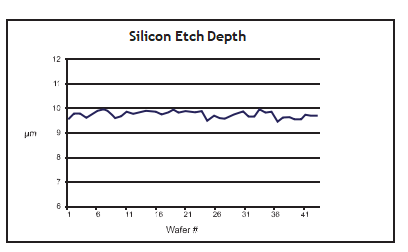
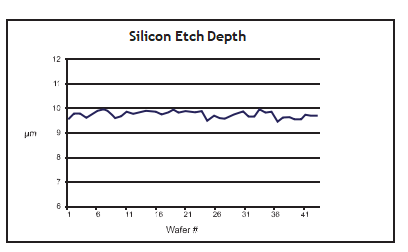


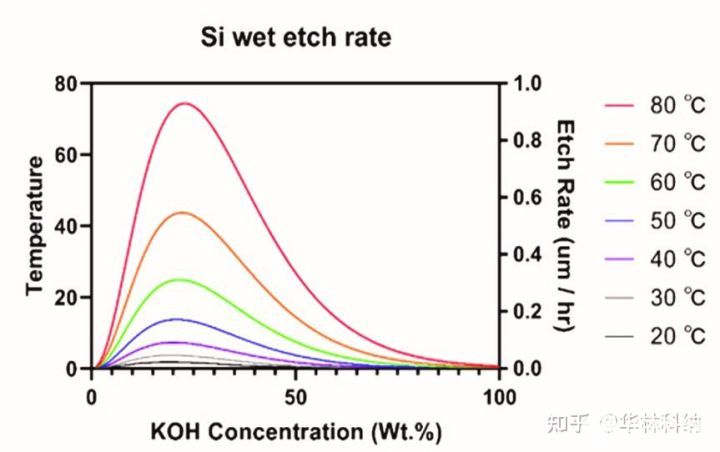
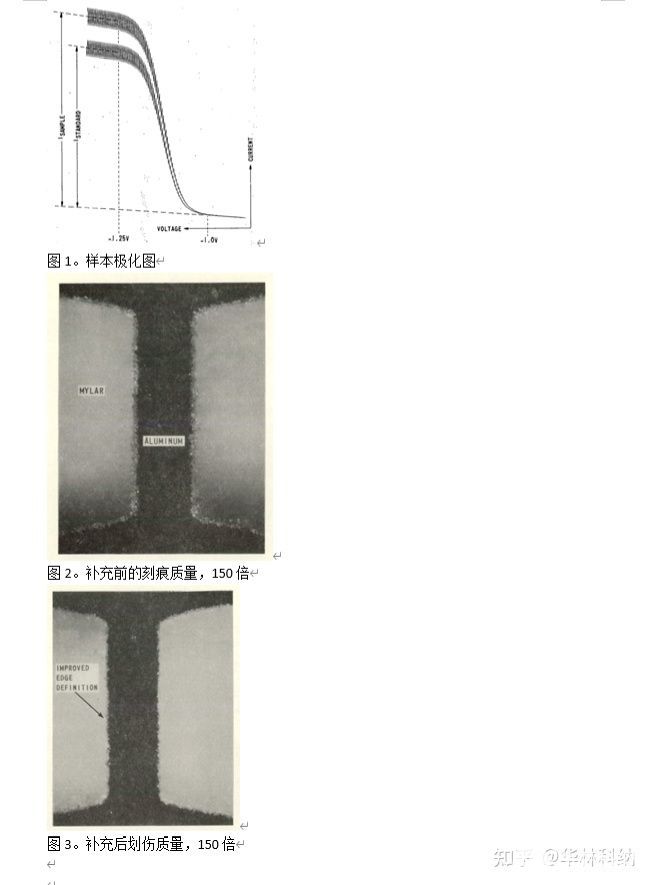


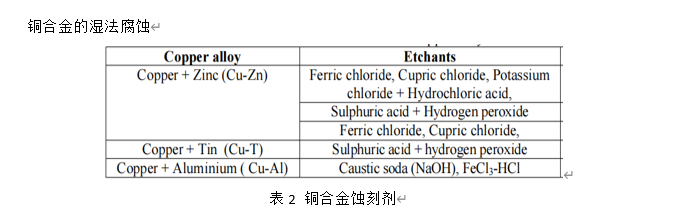
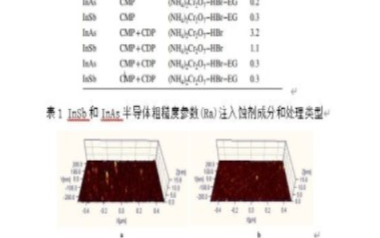
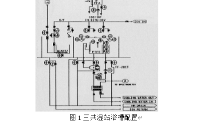

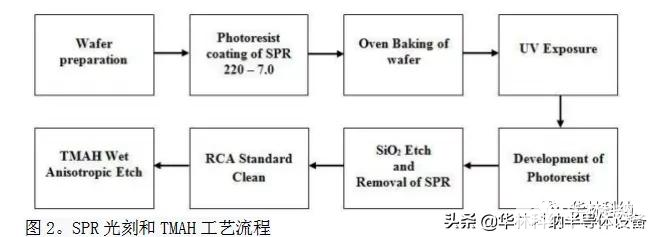



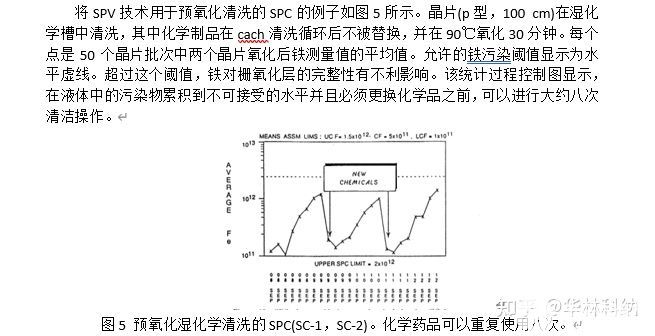
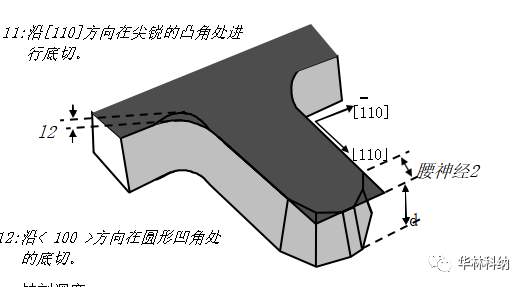

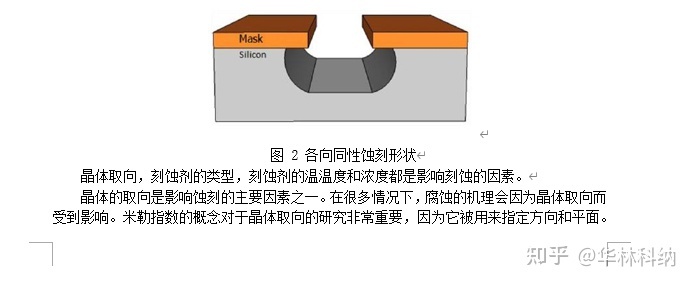
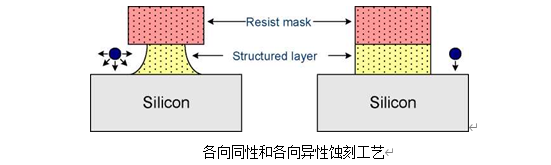



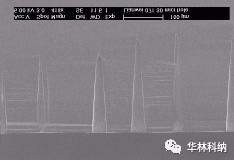



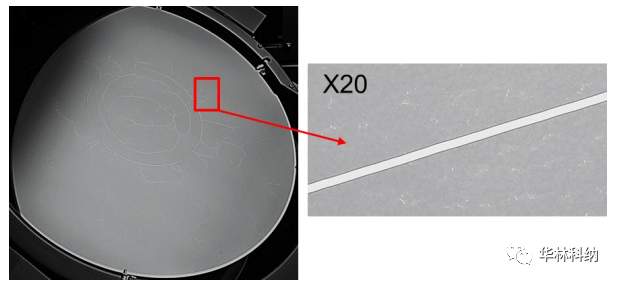

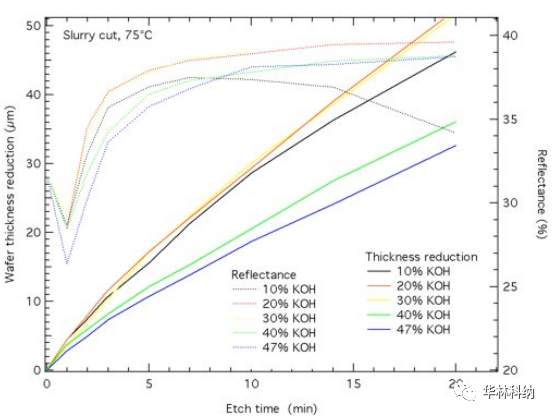

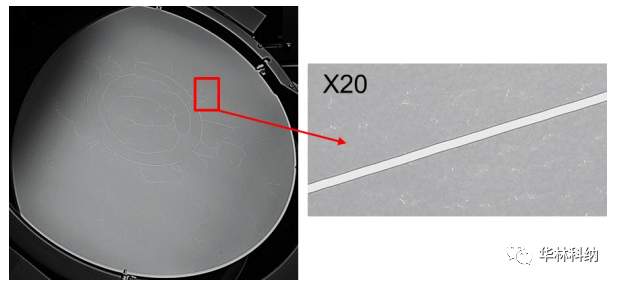
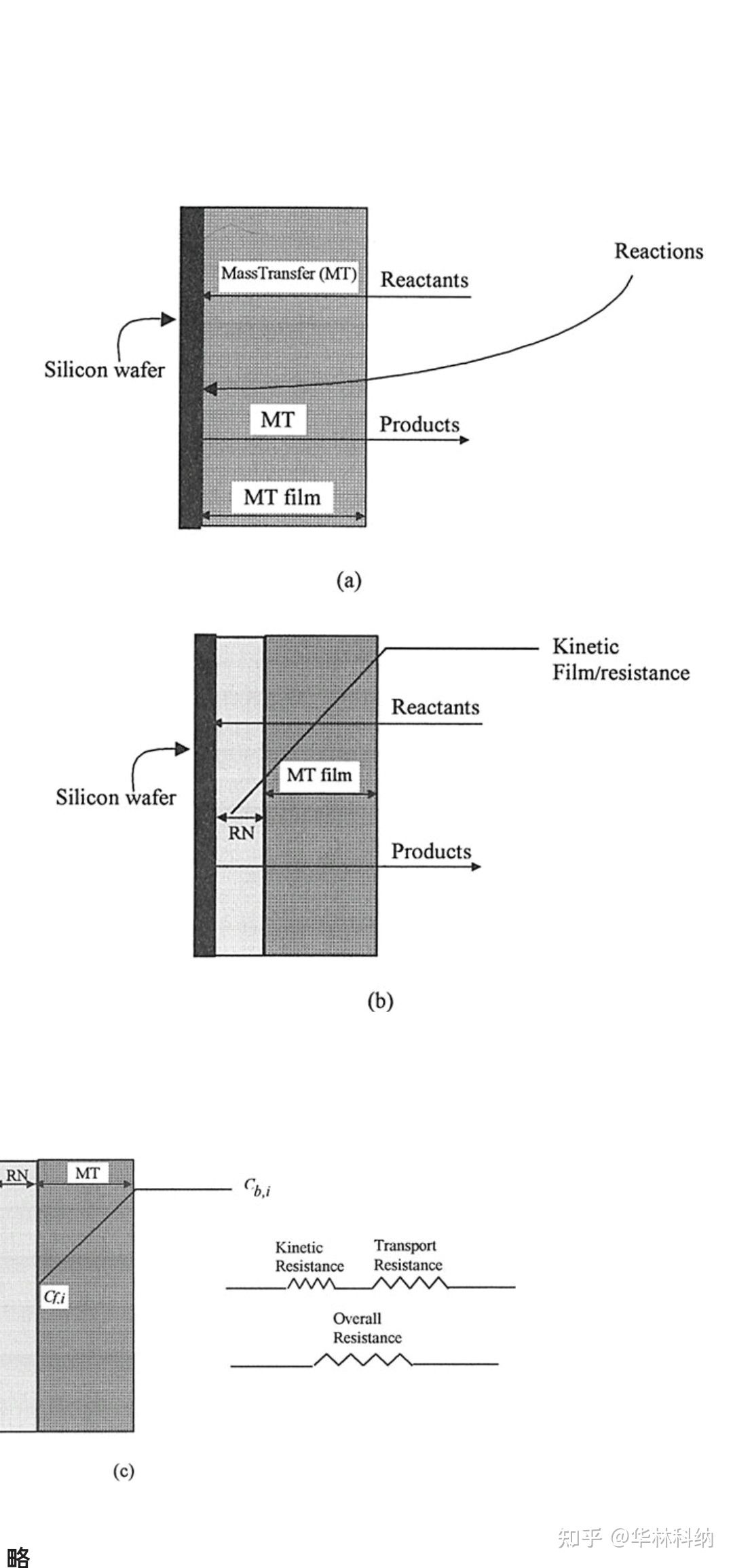
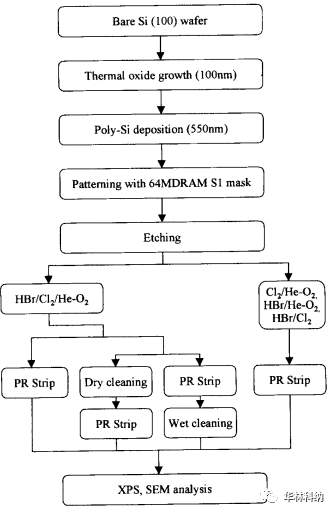










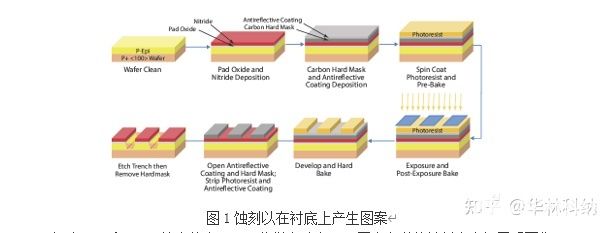





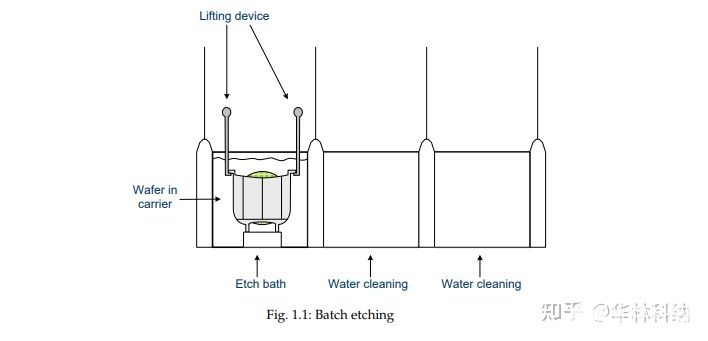






 用于硅片减薄的湿法蚀刻工艺控制的研究
用于硅片减薄的湿法蚀刻工艺控制的研究 0
0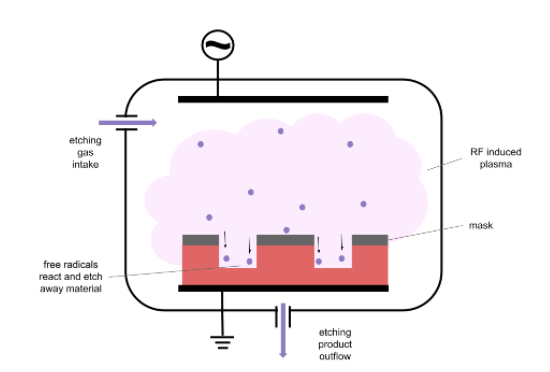
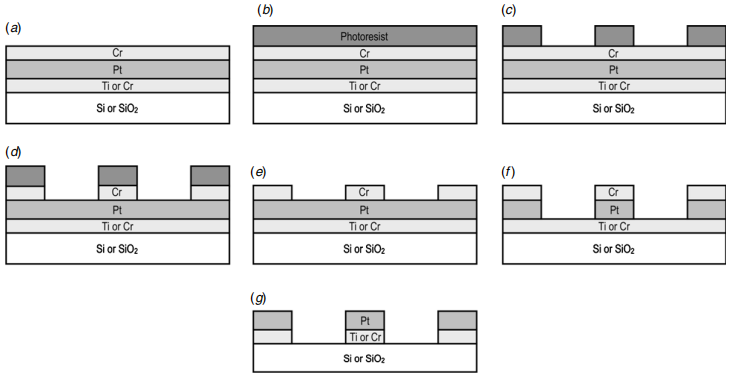
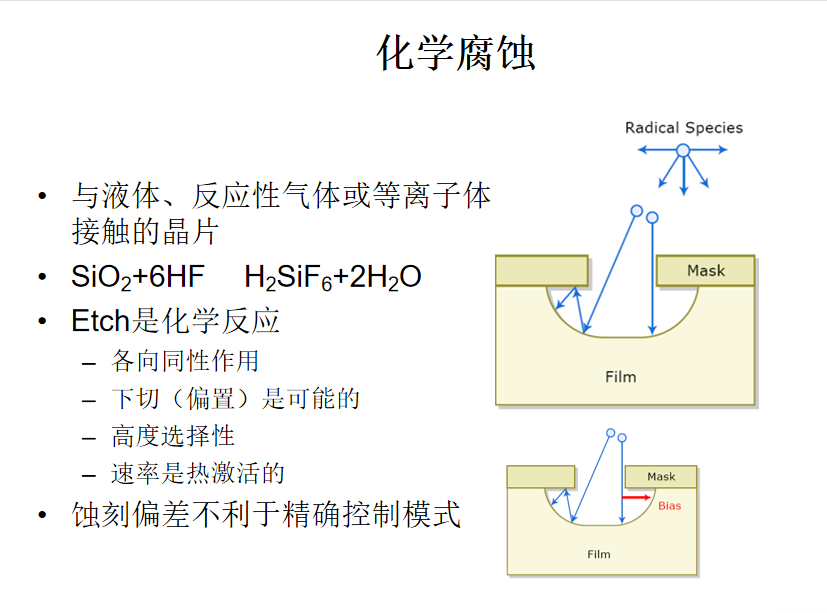

















评论