本文我们华林科纳半导体有限公司研究了类似的现象是否发生在氢氧化钾溶液中添加的其他醇,详细研究了丁基醇浓度对(100)和(110)Si平面表面形貌和蚀刻速率的影响,并给出了异丙醇对氢氧化钾溶液的蚀刻结果,为了研究醇分子在蚀刻溶液中的行为机理,我们还对溶液的表面张力进行了测量。
实验中采用了(100)和(110)取向的硅晶片。晶片的蚀刻过程在氢氧化钾水溶液中进行。酒精浓度增加到饱和水平,这可以在溶液表面观察到一层单独的酒精层。以异丙醇、1-丁醇、异丁醇和叔丁醇作为添加剂(图1),氢氧化钾浓度分别为3或5M(15或23wt%)。蚀刻实验是在一个带有回流冷凝器的搅拌条件下(机械搅拌210rpm)的玻璃容器中进行的。晶片在75±0.5C的温度下蚀刻60min。
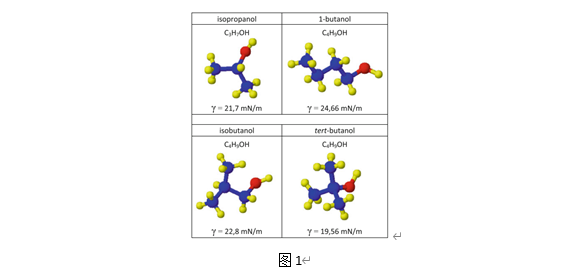
酒精浓度对(100)平面和(110)平面蚀刻速率的影响如图所示2,在所有被研究的酒精中,在氢氧化钾溶液中添加少量的酒精会显著降低两个平面的蚀刻率。用微刻工具进行蚀刻深度测量,估计了晶片的蚀刻速率,测量是在室温(20C)下进行的,因为测量容器必须是开放的,因此酒精可以在高温下蒸发,在一定浓度的醇类条件下,可以观察到(100)平面和(110)平面的蚀刻速率的最小值。
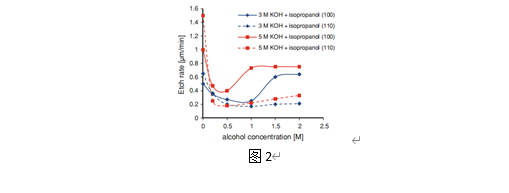
众所周知,氢氧化钾溶液的酒精饱和度显著降低了(110)蚀刻率,而(100)蚀刻率的降低相对较低,这种效应可以通过醇分子在(110)平面上的优先吸附来解释,被吸附的分子被认为抑制了反应物(水和oh基团)进入硅表面的途径,从而导致蚀刻速率的降低。因此,酒精浓度的逐渐增加会导致醇分子的吸附更强,蚀刻速率的降低更大。然而,这一解释并不足以描述(110)和(100)平面的蚀刻速率最小值的发生。
在一定程度上减缓(100)表面的蚀刻过程。然而,这也可以从吸附密度与酒精浓度的变化的角度来解释。如果吸附的醇分子是山丘形成的微掩模(Rola和Zubel2011),酒精分子的密集吸附也会导致山丘分布更密集,因此(100)蚀刻速率降低更大。
通过研究氢氧化钾水溶液中醇浓度对(100)和(110)平面蚀刻速率和表面形貌的影响,实验采用异丙醇和三种丁醇异构体,蚀刻速率与醇浓度的最小值不仅对异丙醇,而且对丁醇也观察到,此外在接近蚀刻率最小值的浓度时,(110)表面的粗糙度降低,虽然在此浓度下,(100)表面覆盖着小山丘,但在低浓度异丁醇和叔丁醇溶液中蚀刻的小山丘相对较小,一般来说,氢氧化钾溶液的饱和导致(100)表面的山丘密度降低,但降低的强度随酒精的不同而不同。
根据蚀刻速率结果、表面张力测量结果和文献报道,提出了各向异性蚀刻过程中醇与硅表面相互作用的机理,假设蚀刻速率与酒精浓度的最小值对应于吸附在硅表面的酒精分子的最大密度,当醇浓度升高时,氢键网络逐渐破裂,导致了蚀刻率的增加,这种现象一直发生到酒精蚀刻溶液饱和,(100)平面的蚀刻速率最小值比(110)平面更明显,这可能是由于后者的疏水性更高,因此醇分子对其的吸附更强,然而,这一假设应该通过对不同晶体取向的硅晶圆的润湿性测量来证明。
审核编辑:汤梓红

 电子发烧友App
电子发烧友App










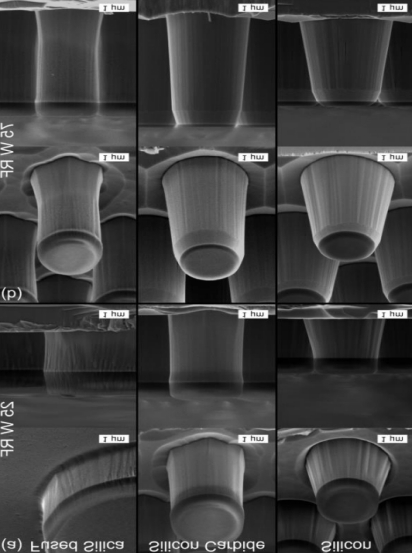
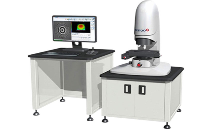

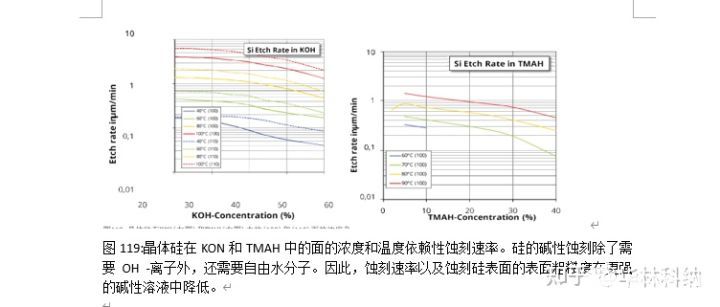



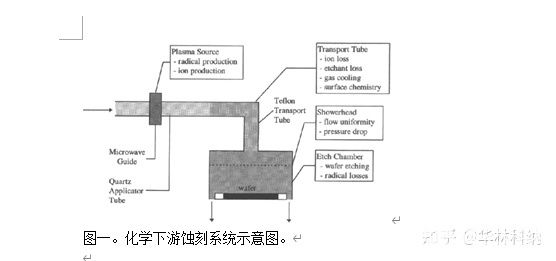




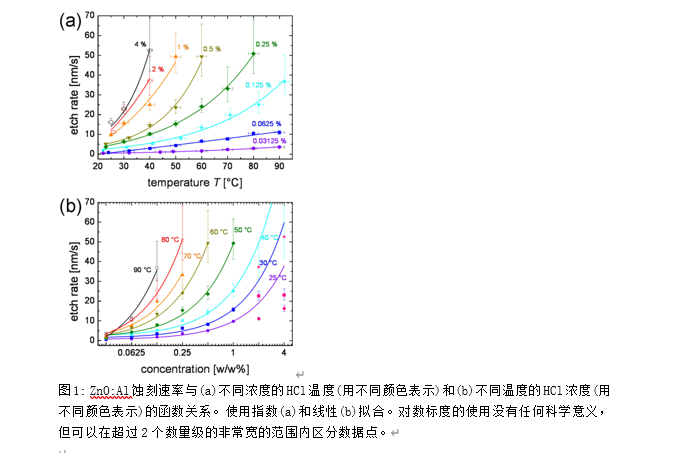

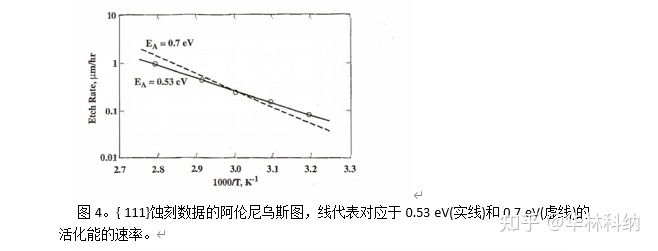

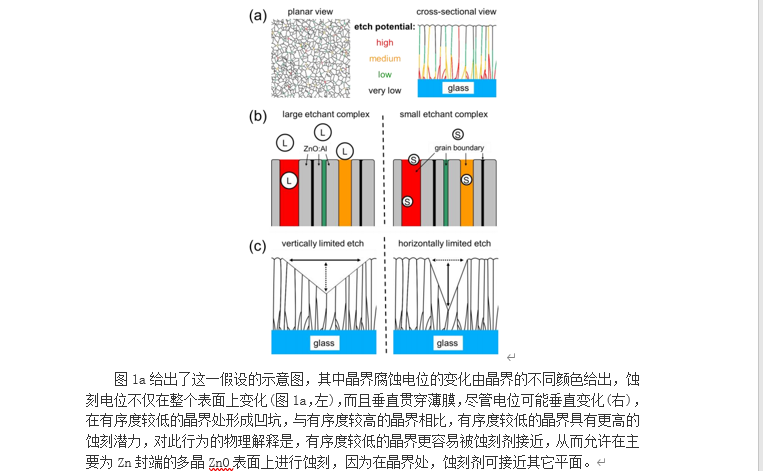
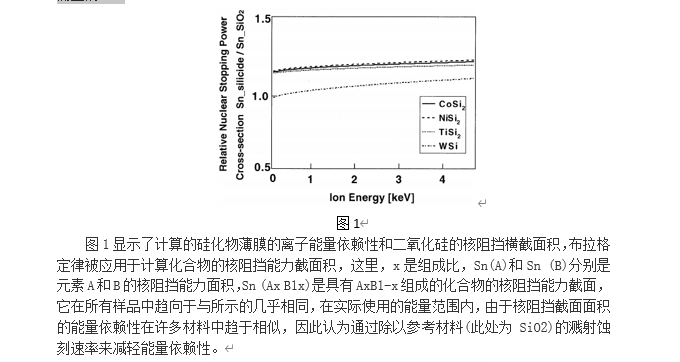

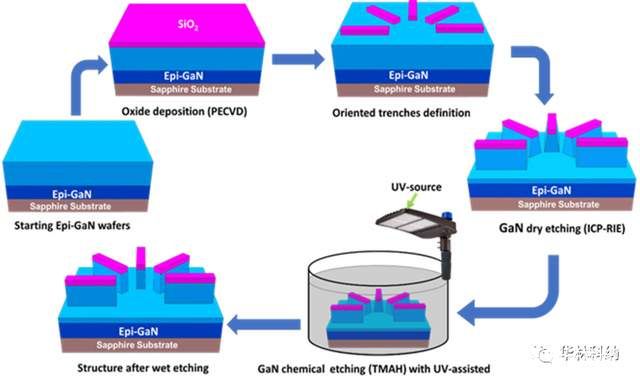
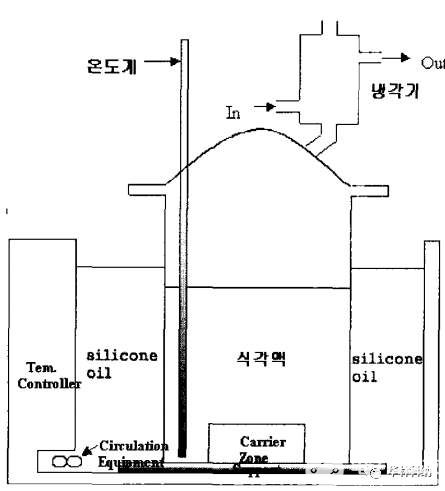
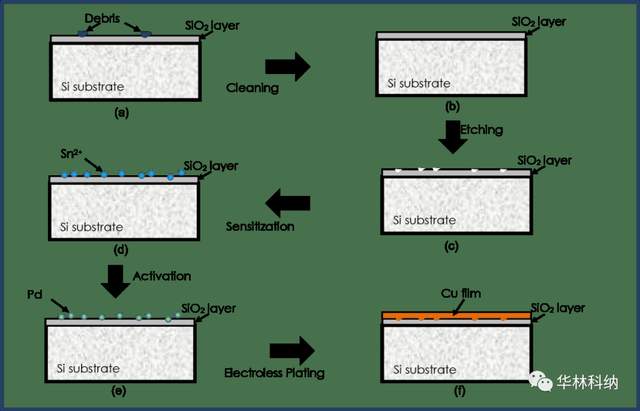
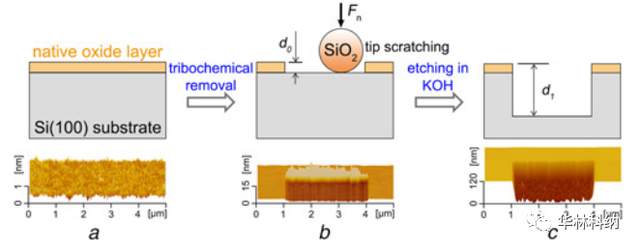
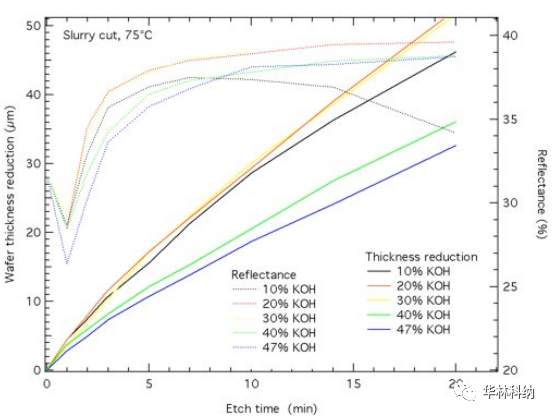


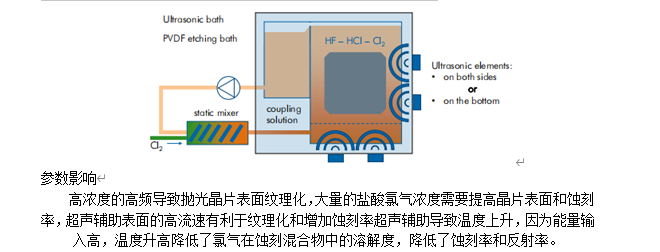
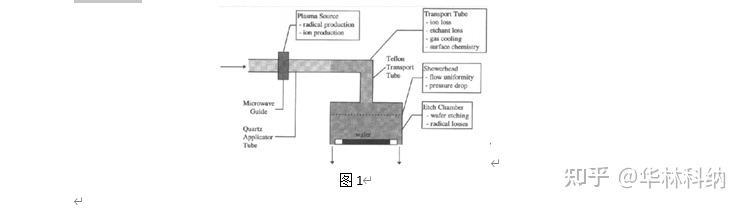
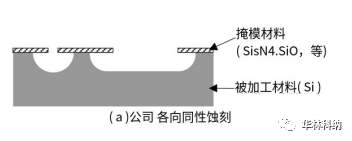


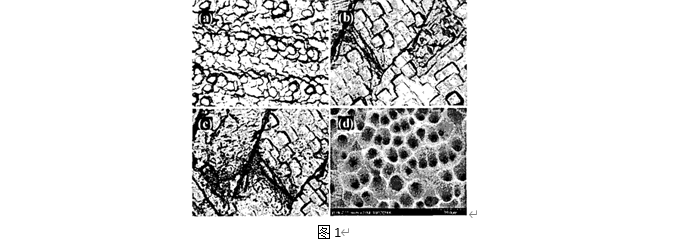
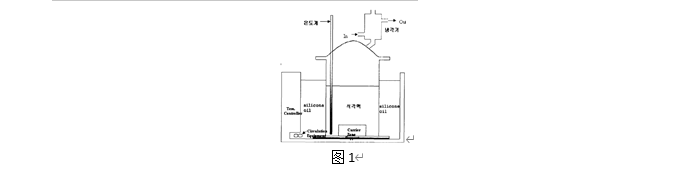
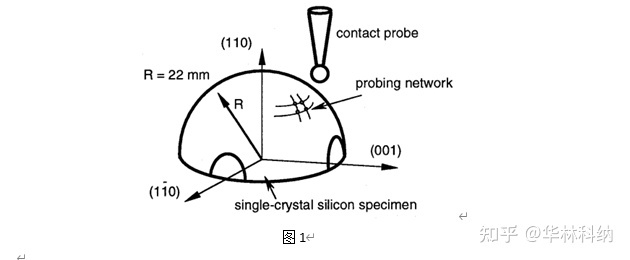

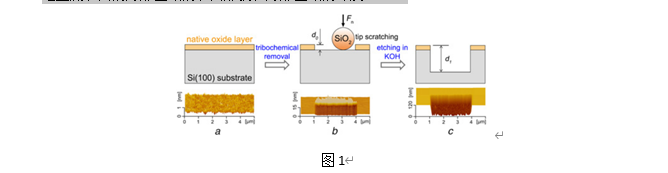
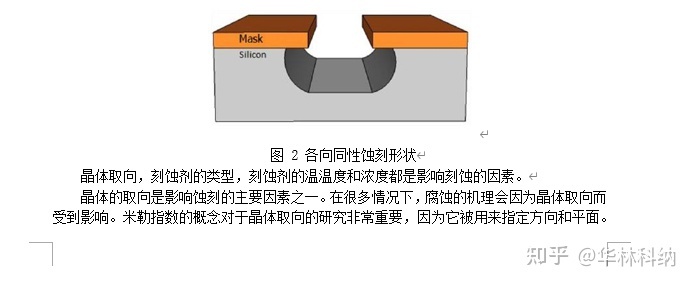

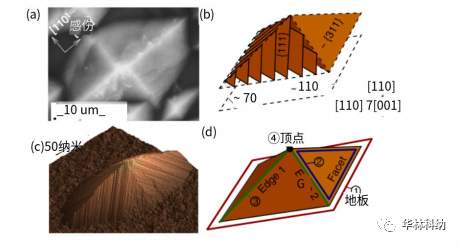
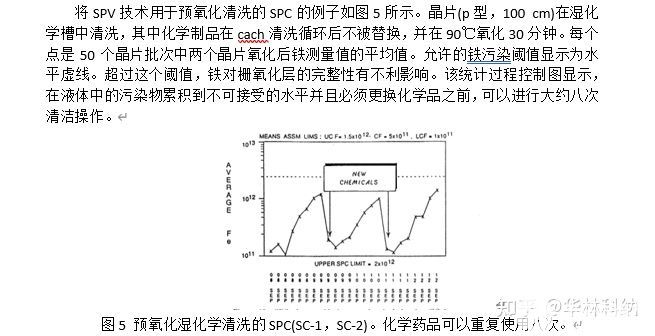
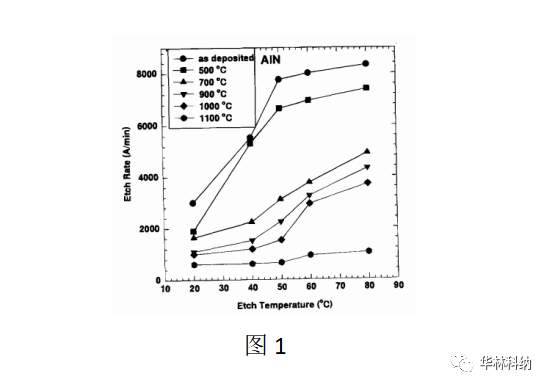

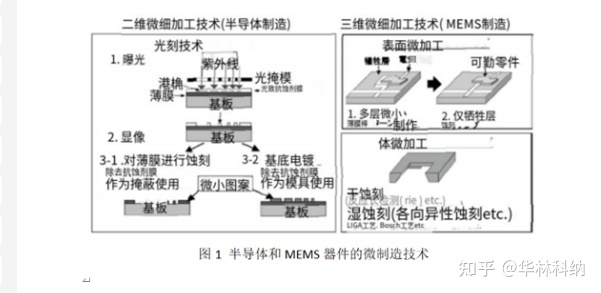




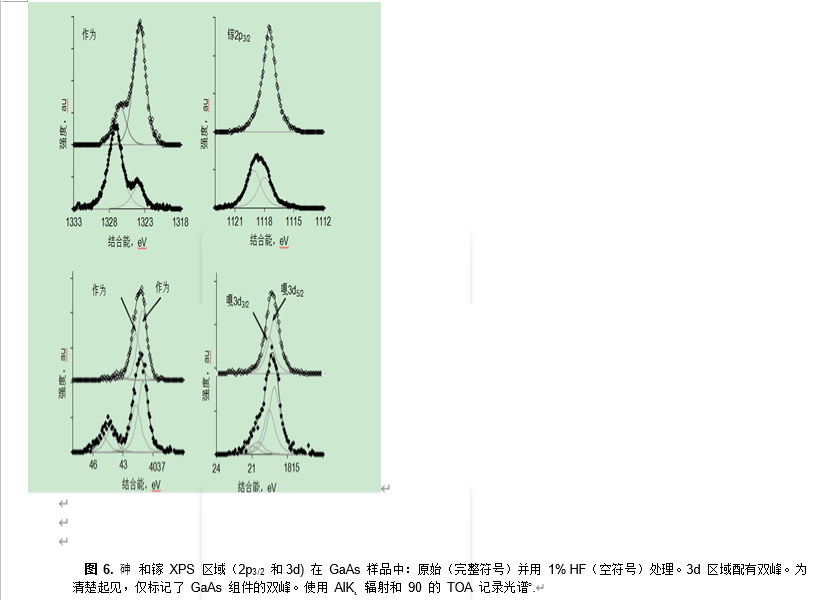



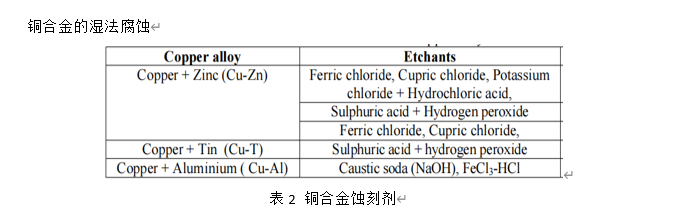

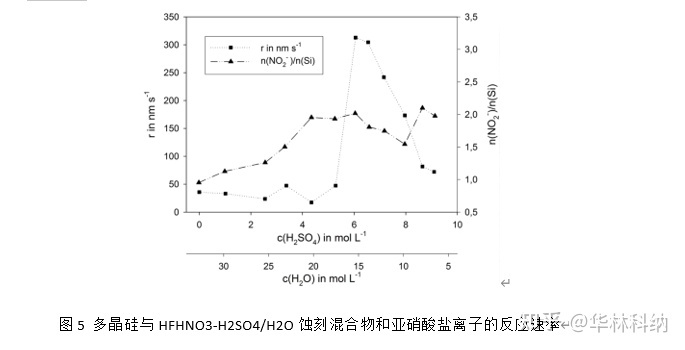



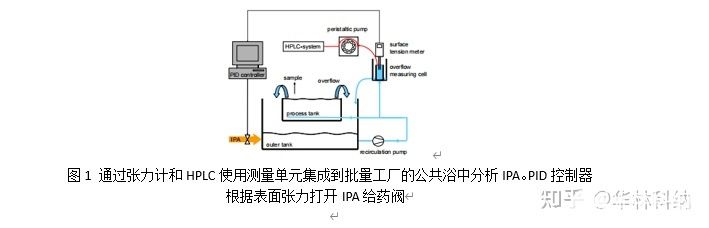
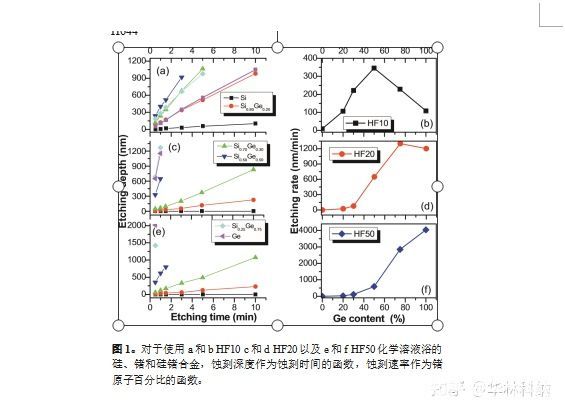

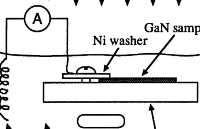
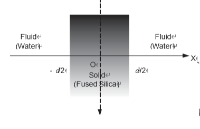
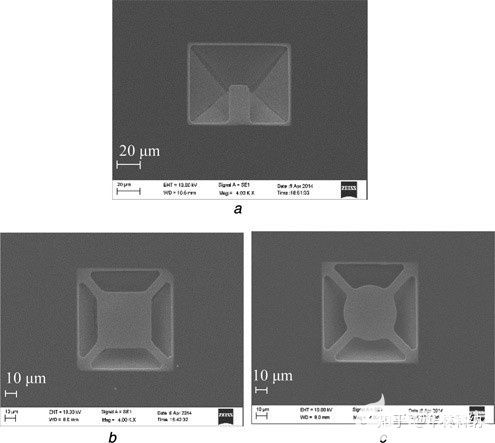

















评论