随着摩尔定律面临诸多瓶颈、先进工艺逼近物理极限,业界普遍认为,先进封装会成为下一阶段半导体技术的重要发展方向。长电科技作为全球领先的封测厂商之一,在先进封装领域也进行了大量的研发与布局。针对先进封装的市场需求、技术发展趋势,记者采访了长电科技技术市场副总裁包旭升。
先进封装市场逐年增长
近年来,封装技术在半导体领域发挥的作用越来越大,越来越多前道工艺需要完成的步骤被引入后道工艺当中,两者的界限变得越来越模糊。随之而来的是,越来越多超越传统封装理念的先进封装技术被提出,系统级封装(SiP)、晶圆级封装(WSP)、2.5D/3D封装等的应用越来越广泛。统计数据显示,从2017年到2023年,整个半导体封装市场的营收将以5.2%的复合年增长率增长,而先进封装市场将以7%的复合年增长率增长,市场规模到2023年将增长至390亿美元。另一方面,传统封装市场的复合年增长率则低于3.3%。
针对市场需求的发展变化趋势,包旭升指出,需求不会无缘无故出现,当前市场最大的驱动因素来自于对数字芯片的 SiP封装需求。因为摩尔定律目前已经走到5nm节点,正在开发 3nm,还有人在讨论1nm。但是,随之而来的是芯片制造成本的大幅增加,并不是每个公司都能承担得起几亿元的芯片流片费用,一个保险的方式就是,把经过验证的芯片做成标准化的小芯片,再用 SiP封装技术整合到一起,这样就产生了对Chiplet SiP的需求。此外,模拟芯片对先进封装的需求也很高。5G 时代,频谱、信号复杂度大为提高,对射频器件、滤波器等的技术要求越来越高。如何才能实现一个手机走遍天下?这就需要不断地集成各种频段资源,集成元件数量翻倍的增加。与此同时,功耗增加但手机的尺寸不能增大。如何在有限的空间内集成更多的元件?SiP就是当前最有效的技术。
SiP与Chiplet成技术发展热点
正是因为市场对SiP封装的广泛需求,SiP成为当前应用最为广泛的先进封装技术之一。据介绍,SiP是先进封装中带有系统功能的多芯片与器件的一种封装形式总称,它可以将一颗或多颗芯片及被动元件整合在一个封装模块当中,从而实现具有完整功能的电路集成。这种封装方式可以降低成本,缩短上市时间,同时克服了芯片系统集成过程中面临的工艺兼容、信号混合、噪声干扰、电磁干扰等难题。
另外,随着先进封装技术的发展,一种小芯片(Chiplet)的发展理念又被提出,成为当前封装领域最热门的话题之一。包旭升认为,Chiplet其实也可以算是一种SiP技术,是系统级芯片(SoC)中 IP模块的芯片化。其主要目的是为了提高良率和降低成本,同时提高设计的灵活度,降低设计周期。一般来说,一颗SoC芯片中会包含许多不同的IP模块,随着芯片制造工艺已经演进到7/5 nm,但并不是所有IP模块都需要做到7/5 nm,把一些IP模块单独拿出来,做成一个标准化功能的小芯片,这个就可以称为Chiplet。它相当于一个标准化的元件,当这个单独的标准化元件制造完成之后,可以再和其他的功能模块,如存储芯片、应用处理器等封装在一起,就可以做成一个SiP模块,执行复杂的功能。 Chiplet SiP多见于 2.5D 高端 FcBGA 封装以做高速运算等应用。这种封装目前发展迅速,主要晶圆厂都在花巨资建设开发这种封装产能。Chiplet SiP的另一个方向是用于模拟类芯片的封装,例如 RF、MEMS 等。在这个领域,OSAT 厂商布局了很多。
SiP和Chiplet也是长电科技重点发展的技术。“目前我们重点发展几种类型的先进封装技术。首先就是系统级封装(SiP),随着5G的部署加快,这类封装技术的应用范围将越来越广泛。其次是应用于Chiplet SiP的 2.5D/3D封装,以及晶圆级封装,并且利用晶圆级技术在射频特性上的优势推进扇出型(Fan-Out)封装。此外,我们也在开发部分应用于汽车电子和大数据存储等发展较快的热门封装类型。”包旭升指出。
不应机械划分“先进”与“低端”
传统上,封装的目的是将切割好的芯片进行固定、引线和塑封保护。但随着半导体技术的发展,越来越多前道工艺需要完成的步骤被引入后道工艺当中,两者的界限变得越来越模糊。随之而来的是,越来越多超越传统封装理念的先进封装技术被提出。
但对长电科技而言,先进封装和传统封装的概念不应被机械地理解。这两者并不是绝对划分的。做一个形象的比喻,不同的封装技术就像是工具箱中不同类型的工具。在不同的应用中使用不同的工具。这样理解其实封装技术并没有什么“先进”或“低端”的区别,只有适用或者不适用之分。比如汽车电子产品用到的封装技术多为已有且量产的封装技术。因为汽车电子对可靠性的要求很高,所以用到的封装技术都必须是量产的且在消费类、计算类等产品中经过充分验证的技术,才会用到汽车电子产品中。
“当然,我们看到一个新的趋势,即原来汽车电子中用到更多的封装技术是比较传统的,现在正在逐步扩展到很多高I/O、高密度的封装技术,例如 WB BGA, FCBGA-SiP等。因此以前汽车电子中使用的多为电控元件,这些产品大多采用的是TO、SOP、SOT、QFN 等相对传统的封装技术。如今,随着5G的普及,汽车电子智能化功能得到扩展,比如驾驶舱内一些车载信息娱乐系统的内容得到大大扩展,大屏的使用率不断提高。这就是意味着控制芯片的 I/O进一步增多,对处理器的响应速度要求进一步提高。在这种需求下,WB BGA 和 fcCSP 等类型的封装就被应用到汽车电子产品中。ADAS 系统普及,基于 FCBGA 技术的SiP需求也在不断增长。也就是说,先进封装和传统封装是相对而言的,并不应当只重视先进封装的开发,而忽略传统封装技术的发展。不论是 2.5D/3D 封装,或者是 FEM SiP,还是用到第三代半导体的 TO、SOT封装技术都在进一步发展当中,都应受到关注。只要市场应用在高速发展,所需的封装技术就会受到关注并快速发展。”包旭升强调。
责任编辑:tzh
-
芯片
+关注
关注
437文章
43846浏览量
403404 -
晶圆
+关注
关注
50文章
3861浏览量
125454 -
封装
+关注
关注
119文章
6454浏览量
139674 -
5G
+关注
关注
1327文章
46918浏览量
523753 -
chiplet
+关注
关注
5文章
256浏览量
12177
发布评论请先 登录
相关推荐
SiP(系统级封装)技术的应用与发展趋势
系统级封装(SiP)集成技术的发展与挑战
先进封装技术及发展趋势

先进封装概念火热,SiP与Chiplet成“左膀右臂”
先进封装呼声渐涨 Chiplet或成延续摩尔定律新法宝
光芯片走向Chiplet,颠覆先进封装
半导体芯片先进封装——CHIPLET
何谓先进封装/Chiplet?先进封装/Chiplet的意义
什么是先进封装/Chiple?先进封装Chiplet优劣分析
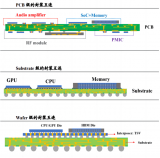
SiP与先进封装有什么区别

先进封装Chiplet的优缺点与应用场景





 SiP与Chiplet成先进封装技术发展热点
SiP与Chiplet成先进封装技术发展热点
















评论