晶圆直接键合技术可以使经过抛光的半导体晶圆,在不使用粘结剂的情况下结合在一起,该技术在微电子制造、微机电系统封装、多功能芯片集成以及其他新兴领域具有广泛的应用。对于一些温度敏感器件或者热膨胀系数差异
2023-06-14 09:46:27 355
355 
`各位大大:手头上有颗晶圆的log如下:能判断它的出处吗?非常感谢!!`
2013-08-26 13:45:30
晶圆键合机主要用于将晶圆通过真空环境, 加热, 加压等指定的工艺过程键合在一起, 满足微电子材料, 光电材料及其纳米等级微机电元件的制作和封装需求. 晶圆键合机需要清洁干燥的高真空工艺环境, 真空度
2023-05-25 15:58:06 202
202 
这是一种晶圆键合方法,其中两个表面之间的粘附是由于两个表面的分子之间建立的化学键而发生的。
2023-04-20 09:43:57 823
823 据悉,英国光电子技术解决方案的领先开发商Plessey Semiconductor日前表示,已从晶圆键合和光刻设备生产商EVG购买了GEMINI晶圆键合系统。
2018-11-16 15:10:08 1803
1803 随着产业和消费升级,电子设备不断向小型化、智能化方向发展,对电子设备提出了更高的要求。可靠的封装技术可以有效提高器件的使用寿命。阳极键合技术是晶圆封装的有效手段,已广泛应用于电子器件行业。其优点是键合时间短、键合成本低。温度更高,键合效率更高,键合连接更可靠。
2023-09-13 10:37:36 66
66 
EV集团将在SEMICON CHINA展出用于3D-IC封装的突破性晶圆键合技术 较之上一代对准系统,GEMINI FB XT 熔融键合机上的全新 SmartView NT3 对准系统可提升2-3
2019-03-05 14:21:36 1731
1731 不同的微电子工艺需要非常干净的表面以防止颗粒污染。其中,晶圆直接键合对颗粒清洁度的要求非常严格。直接晶圆键合包括通过简单地将两种材料的光滑且干净的表面接触来将两种材料连接在一起(图1)。在室温和压力下,两种材料表面的分子/原子之间形成的范德华力会产生粘附力。
2023-09-08 10:30:18 73
73 
随着胶囊化封装的先进微电子机械系统(MEMS)和互补金属氧化物半导体(CMOS)成像器件产量的加速提升,中国市场对 EVG 晶圆键合解决方案的需求也不断提升。微机电系统(MEMS)、纳米技术以及
2017-03-18 01:04:11 3463
3463 晶圆键合是半导体行业的“嫁接”技术,通过化学和物理作用将两块已镜面抛光的晶片紧密地结合起来,进而提升器件性能和功能,降低系统功耗、尺寸与制造成本。
2023-06-02 16:45:04 190
190 
新的BONDSCALE系统大大提升了晶圆键合的生产率;解决了IRDS路线图中描述的晶体管逻辑电路扩展和3D集成的问题 奥地利,圣弗洛里安,2019年3月12日面向MEMS、纳米技术和半导体市场的晶圆
2019-03-12 14:24:45 1490
1490 就微粒污染而言,不同的微电子工艺需要非常干净的表面。其中,直接晶片粘接在颗粒清洁度方面有非常积极的要求。直接晶圆键合是将两种材料结合在一起,只需将它们光滑干净的表面接触即可(图1)。在常温常压下,两种材料表面的分子/原子之间形成的范德华力会产生附着力
2023-05-09 14:52:19 514
514 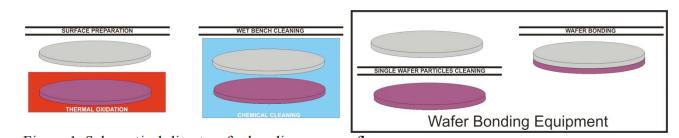
当的方式为激光解键合。鸿浩半导体设备所生产的UV激光解键合设备具备低温、不伤晶圆等技术特点,并且提供合理的制程成本,十分适合应用于扇出晶圆级封装。 01 扇出晶圆级封装简介 扇出晶圆级封装(Fan Out Wafer Level Packaging, FOWLP,简称扇出
2023-04-28 17:44:43 495
495 
根据台积电在第二十四届年度技术研讨会中的说明,SoIC是一种创新的多芯片堆叠技术,是一种晶圆对晶圆(Wafer-on-wafer)的键合(Bonding)技术,这是一种3D IC制程技术,可以让台积电具备直接为客户生产3D IC的能力。
2019-08-14 11:21:06 3758
3758 
InP 材料在力学方面具有软脆的特性,导致100 mm(4 英寸)InP 晶圆在化合物半导体工艺中有显著的形变和碎裂的风险;同时,InP 基化合物半导体光电子器件芯片大部分采用双面工艺,在晶圆的双面进行半导体工艺。
2023-06-27 11:29:32 2116
2116 
到350°C,并允许硅与氮化镓结合。 背景 许多半导体材料系统是彼此不相容的。由于晶格错配,一些不能通过异质外延一起生长,而对于另一些,在一个上产生器件所需的过程条件会破坏另一个。半导体晶片键合是这两个问题的解决方案之一。粘结允许这两种材料系统分别
2022-01-24 16:57:47 737
737 
结束前工序的每一个晶圆上,都连接着500~1200个芯片(也可称作Die)。为了将这些芯片用于所需之处,需要将晶圆切割(Dicing)成单独的芯片后,再与外部进行连接、通电。此时,连接电线(电信号
2023-08-09 09:49:47 311
311 
新型键合材料对于在高级半导体制造工艺中保持超薄晶圆的完整性至关重要。有了新型材料的配合,临时键合在晶圆减薄工艺中愈发成为可能。
2018-06-25 16:48:00 9513
9513 
目前晶圆键合工艺技术可分为两大类:一类是键合双方不需要介质层,直接键合,例如阳极键合;另一类需要介质层,例如金属键合。如下图2的键合工艺分类
2021-03-01 11:57:09 14982
14982 两片晶圆面对面键合时是铜金属对铜金属、介电值对介电质,两边键合介面的形状、位置完全相同,晶粒大小形状也必须一样。所以使用混合键合先进封装技术的次系统产品各成分元件必须从产品设计、线路设计时就开始共同协作。
2023-05-08 09:50:30 470
470 制作一颗硅晶圆需要的半导体设备大致有十个,它们分别是单晶炉、气相外延炉、氧化炉、磁控溅射台、化学机械抛光机、光刻机、离子注入机、引线键合机、晶圆划片机、晶圆减薄机。
2022-04-02 15:47:49 4682
4682 为解决铜丝硬度大带来的键合难度,半导体封装企业通常选择应用超声工艺或键合压力工艺提升键合效果,这也导致焊接期间需要耗费更多的时间完成键合工作。
2022-12-15 15:44:46 1460
1460 技术成为实现系统性能、带宽和功耗等方面指标提升的重要备选方案之一。对目前已有的晶圆级多层堆叠技术及其封装过程进行了详细介绍; 并对封装过程中的两项关键工艺,硅通孔工艺和晶圆键合与解键合工艺进行了分析
2022-09-13 11:13:05 3006
3006 本文主要介绍了晶圆的结构,其次介绍了晶圆切割工艺,最后介绍了晶圆的制造过程。
2019-05-09 11:15:54 10964
10964 
晶圆抛光机作为半导体晶圆抛光配备,主要优点有新型实用、经济成本低、容易实现。
2023-01-06 12:21:31 1458
1458 结束前工序的每一个晶圆上,都连接着500~1200个芯片(也可称作Die)。 为了将这些芯片用于所需之处,需要将晶圆切割(Dicing)成单独的芯片后,再与外部进行连接、通电。 此时,连接
2023-03-13 15:49:58 2376
2376 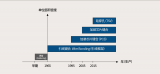
结合离子注入工艺、激光照射和去除牺牲层,晶片键合技术是将高质量薄膜转移到不同衬底上的最有效方法之一。本文系统地总结和介绍了苏州华林科纳的晶片键合技术在电子、光学器件、片上集成中红外传感器和可穿戴传感器等领域的应用。依次介绍了基于智能剥离技术
2021-12-21 16:33:29 2196
2196 
晶圆薄化是实现集成电路小型化的主要工艺步骤,硅片背面磨至70微米的厚度被认为是非常关键的,因为它很脆弱。本文将讨论关键设备检查项目的定义和设置险。 所涉及的设备是内联晶圆背面研磨和晶圆安装。本研究
2022-03-31 14:58:24 4435
4435 
金丝键合质量的好坏受劈刀、键合参数、键合层镀金质量和金丝质量等因素的制约。传统热压键合、超声键合、热超声键合或楔形键合和球形键合分别在不同情况下可以得到最佳键合效果。工艺人员针对不同焊盘尺寸所制定
2023-02-07 15:00:25 2402
2402 晶圆测温系统,晶圆测温热电偶,晶圆测温装置一、引言随着半导体技术的不断发展,晶圆制造工艺对温度控制的要求越来越高。热电偶作为一种常用的温度测量设备,在晶圆制造中具有重要的应用价值。本文
2023-06-30 14:57:40
作为有效的补充越来越被重视。传统封装工艺不断迭代出的先进封装技术崭露头角,它继续着集成电路性能与空间在后摩尔时代的博弈。同时,晶圆键合(Wafer Bonding)、倒装芯片键合(Flip Chip Bonding)、混合键合等也是一项技术壁垒较高的新型
2023-02-17 18:16:19 1180
1180 
在回顾现行的引线键合技术之后,本文主要探讨了集成电路封装中引线键合技术的发展趋势。球形焊接工艺比楔形焊接工艺具有更多的优势,因而获得了广泛使用。传统的前向拱丝越来越
2011-10-26 17:13:56 85
85 晶圆是指制作硅半导体电路所用的硅晶片,其原始材料是硅。高纯度的多晶硅溶解后掺入硅晶体晶种,然后慢慢拉出,形成圆柱形的单晶硅。硅晶棒在经过研磨,抛光,切片后,形成硅晶圆片,也就是晶圆。晶圆的主要加工
2023-02-22 14:46:16 2
2 芯片制造主要分为5个阶段:材料制备;晶体生长或晶圆制备;晶圆制造和分拣;封装;终测。
2022-12-12 09:24:03 3113
3113 晶圆是指硅半导体集成电路制作所用的硅晶片,由于其形状为圆形,故称为晶圆;在硅晶片上可加工制作成各种电路元件结构,而成为有特定电性功能之IC产品。晶圆的原始材料是硅,而
2011-11-24 09:21:42 6575
6575 引线键合是LED封装制造工艺中的主要工序,其作用是实现LED芯片电极与外部引脚的电路连接。引线键合工艺的方法和质量直接影响着LED灯珠的可靠性和成本。 服务客户: LED封装厂 检测手段: 扫描电镜
2021-11-21 11:15:26 1321
1321 受疫情影响,环球晶马来西亚工厂负责生产 6 吋硅晶圆,受马来西亚全国封城政策影响,6吋硅晶圆供应将更吃紧。法人解读,此举将有助 6 吋硅晶圆报价上涨,包含环球晶、合晶都已针对 6 吋硅晶圆调涨价格。
2020-03-19 10:01:43 2411
2411 晶圆的最终良率主要由各工序良率的乘积构成。从晶圆制造、中期测试、封装到最终测试,每一步都会对良率产生影响。工艺复杂,工艺步骤(约300步)成为影响良率的主要因素。可以看出,晶圆良率越高,在同一晶圆上可以生产出越多好的芯片。
2022-12-15 10:37:27 623
623 本文开始介绍了晶圆的概念和晶圆的制造过程,其次详细的阐述了晶圆的基本原料,最后介绍了晶圆尺寸的概念及分析了晶圆的尺寸是否越大越好。
2018-03-16 14:50:23 142166
142166 
在传统晶圆封装中,是将成品晶圆切割成单个芯片,然后再进行黏合封装。不同于传统封装工艺,晶圆级封装是在芯片还在晶圆上的时候就对芯片进行封装,保护层可以黏接在晶圆的顶部或底部,然后连接电路,再将晶圆切成单个芯片。
2022-04-06 15:24:19 8930
8930 今年半导体市况相对低缓,上游硅晶圆端业者包括环球晶、台胜科、合晶等同步面临压力与挑战。
2023-06-26 17:40:48 277
277 进行注塑,将玻璃晶圆与异构芯片重构成玻璃与树脂永久键合的晶圆. 减薄树脂晶圆面漏出TSV转接芯片的铜柱,在 树脂表面上完成再布线. 把控制、电源管理等芯片倒装焊在再布线形成的焊盘处,植上BGA焊球形
2023-05-15 10:39:22 354
354 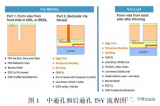
晶圆的制造在半导体领域,科技含量相当的高,技术工艺要求非常高。而我们国半导体事业起步较晚,在晶圆的制造上还处于建设发展阶段。现在我国主要做的是晶圆的封测。我国的晶圆封测规模和市场都是全球首屈一指的,约占全球约1/4。
2019-08-12 14:13:00 42685
42685 EV集团与中芯宁波携手,实现砷化镓射频前端模组晶圆级微系统异质集成 中芯宁波特有的晶圆级微系统集成技术(uWLSI)与EV集团的晶圆键合和光刻系统相结合,为4G/5G手机提供最紧凑的射频前端芯片组
2019-03-20 14:00:41 1926
1926 晶圆是微电子产业的行业术语之一。
2017-12-07 15:41:11 34641
34641 市场研究机构虽然近期普遍对明年硅晶圆的市况供需及报价暂持保守看法,不过,硅晶圆厂之一的合晶在看好未来产业发展趋势下,宣布加码投资上海合晶持股,将持股比重增加五成。
2018-12-28 17:01:41 2939
2939 铜线以其良好的电器机械性能和低成本特点已在半导体分立器件的内引线键合工艺中得到广泛应用,但铜线的金属活性和延展性也在键合过程中容易带来新的失效问题,文中对这种
2009-03-07 10:30:57 14
14 作为有效的补充越来越被重视。传统封装工艺不断迭代出的先进封装技术崭露头角,它继续着集成电路性能与空间在后摩尔时代的博弈。同时,晶圆键合(Wafer Bonding)、倒装芯片键合(Flip Chip Bonding)、混合键合等也是一项技术壁垒较高的新型
2023-01-16 16:43:30 285
285 晶圆探针测试也被称为中间测试(中测),是集成电路生产中的重要一环。晶圆探针测试的目的就是确保在芯片封装前,尽可能地把坏的芯片筛选出来以节约封装费用。
2022-08-09 09:21:10 3273
3273 作为有效的补充越来越被重视。传统封装工艺不断迭代出的先进封装技术崭露头角,它继续着集成电路性能与空间在后摩尔时代的博弈。同时,晶圆键合(Wafer Bonding)、倒装芯片键合(Flip Chip Bonding)、混合键合等也是一项技术壁垒较高的新型
2023-02-01 16:12:14 661
661 晶圆是非常重要的物件之一,缺少晶圆,目前的大多电子设备都无法使用。在往期文章中,小编对晶圆的结构、单晶晶圆等均有所介绍。本文中,为增进大家对晶圆的了解,小编将阐述晶圆是如何变成CPU的。如果你对晶圆相关内容具有兴趣,不妨继续往下阅读哦。
2020-12-26 11:25:15 7419
7419 多年来,半导体晶片键合一直是人们感兴趣的课题。使用中间有机或无机粘合材料的晶片键合与传统的晶片键合技术相比具有许多优点,例如相对较低的键合温度、没有电压或电流、与标准互补金属氧化物半导体晶片的兼容性
2022-04-26 14:07:04 2381
2381 
芯片是晶圆切割完成的半成品,晶圆是芯片的载体,将晶圆充分利用刻出一定数量的芯片后,进行切割就就成了一块块的芯片了。
2022-01-29 16:16:00 56291
56291 芯片的制造分为原料制作、单晶生长和晶圆的制造、集成电路晶圆的生产和集成电路的封装阶段。本节主要讲解集成电路封装阶段的部分。
集成电路晶圆生产是在晶圆表面上和表面内制造出半导体器件的一系列生产过程。整个制造过程从硅单晶抛光片开始,到晶圆上包含了数以百计的集成电路戏芯片。
2023-05-06 10:59:06 638
638 引线键合技术是封装技术的主力,有着兼容性强、成本低、可靠性高、技术成熟等优点。据不完全统计,目前超过90%的芯片互连封装依靠引线键合技术完成,未来引线键合将在多数芯片封装中作为主要的互联技术长期存在
2023-04-11 10:35:16 286
286

 电子发烧友App
电子发烧友App













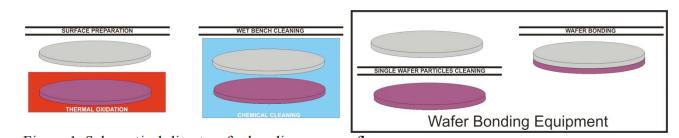







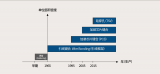





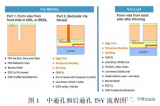

















评论