引言
晶圆-机械聚晶(CMP)过程中产生的浆体颗粒对硅晶片表面的污染对设备工艺中收率(Yield)的下降有着极大的影响。
为了去除氧化后CMP晶片表面的颗粒,通过与DHF(稀释高频)、非离子表面活性剂PAAE(聚氧乙烯烷氧芳基醚)、DMSO(二甲基亚砜)和D.I.W.混合制备了新的清洗溶液。硅酮晶片故意被硅、氧化铝和PSL(聚苯乙烯乳胶)污染。与传统的AMP(氢氧化铵、过氧化氢和D.LW的混合物)相比,这种大气辐照下的清洗溶液可以在室温下同时去除颗粒和金属,而不会增加微粗糙度、金属线腐蚀和有机污染物沉积等副作用。这表明这种清洗溶液在铜刷清洗工艺和传统的铜刷后清洗工艺中具有广阔的应用价值。
实验
本方法采用直径在0.1 nm~0.5 im之间的二氧化硅颗粒、铝矾土颗粒和polystylene latex(PSL)颗粒。在人为污染的清洁槽中加入晶片,吸附量调整到表面约30000个左右,该数值在本实验期间保持恒定使用。所用超声波采用的是间接方式的1000 KHz/600 W,本方法研究的清洁液A-HF(DHF,Polyoxyethylene Alkyl Aryl Ether和Dimethylsulfoxide的混合物)的组合物采用了如下提纯: 表面活性剂(Polyoxyethylene Alkyl Aryl Ether:非离子表面活性剂)和DMSO(KANTO Chemical)通过微粒颗粒过滤后使用,颗粒尺寸为0.05。另外,用于配合它们的超纯水是电阻为18.3 MQ的超纯水,经过0.02 er。表1是表面活性剂PAAE的数据。
表1 PAAE表面活性剂的HLB数和云点
其他用于本实验的分析设备包括:Dynamic contact angle analyzer(Cahn DCA-312)用于测量添加了MAE的A-HF的接触角和表面张力;ElHpsometer用于测量氧化膜的厚度;用Wafer-T进行最小载波生命周期分析,用Perkin-Elmer Autosystem XL-Turbomass(GC-MS)进行晶片表面吸附的PAAE分析。
结果和讨论
颗粒去除效率:
A-HF如图1所示,它有效地消除了晶片表面存在的二氧化硅、铝矾土和PSL颗粒。此时,颗粒去除效率受HF浓度影响不大,取而代之的是表面活性剂和溶剂的浓度。此时使用的非离子表面活性剂(RXAE)与非质子性溶剂(DMSO)一起提高了清洁剂对晶片表面的润湿能力,从而提高了已吸附颗粒的脱附能力,使脱附颗粒不再被吸附。把它看成是一种避免的方式。

图1 A-HF溶液的颗粒去除效率
其作用也可以看做是降低A-HF清洁剂的表面张力,使晶片从清洁剂中取出时可能产生的颗粒吸附降到最低,这是最容易吸附颗粒的过程。表3是对添加AE后硅烷晶片的湿滑能力和清洁液表面张力的调查结果。人们普遍认为阴离子表面活性剂比非离子表面活性剂更能防止颗粒的再吸附。但在表面活性剂的选择过程中,我们已经证实了这一点。在对吸附粒子进行脱附反应的情况下,反而发现阴离子表面活性剂的应用比非离子表面活性剂差很多。
这可能是因为阴离子表面活性剂将阴离子涂在晶片表面,从而阻碍SiO2表面受到蚀刻用最重要的化学种类离子的攻击,增加边界层的厚度,从而导致超声波对粒子的脱附。可以认为是因为降低了能力。另外,对于晶片中以氧化膜存在的SiO2表面相同的SiO和A12O3>以及PSL粒子,在pH小于5的情况下,其绝对值虽然差异较大,但具有相同符号的Zeta势垒,因此仅非离子表面活性剂的使用就可以。
金属离子的去除效果:
在传统的RCA洗脱工艺中,对金属离子的去除机理是HPM(HC1, HQ和D.I.W.的混合物)内由金属离子和过氧化氢起因的活性氧Grego HC1间的氧化还原电位差所描述的复杂化学反应或最基本反应是由金属离子和HC1。这是金属氯化物形成的反应。另一方面,A-HF清洁剂通过F蚀刻去除含有金属离子的氧化膜,从而去除存在于晶片表面的金属离子。使用这种清洁剂的优势在于排除了过氧化氢的使用,使用了实际浓度0.1%以下的极低浓度HF,并在常温下使用。
总结
为了提高CMP洗脱过程中浆体颗粒的去除效率,本方法在DHF上制备了非离子性表面活性剂PAAE、非质子性溶剂DMSO和超纯水的混合物新型洗脱液A-HJ。超声下A-HF的性能评价结果表明:本洗脱技术可以显著降低含有超纯水的化学药品的用量,并能有效应用于Post Oxide CMP洗脱的颗粒的洗脱能力和对金属离子的洗脱。显示了清洁能力,即与传统的APM不同,在常温下可以清洁,清洁过程缩短,通过使用低浓度的HI,可以通过最小的蚀刻来防止表面粗糙。同时,对主流CMP金属布线材料的低腐蚀力,不仅适用于传统的CMP后清洁工艺,更成为新一代CMP工艺备受瞩目的Brush清洁工艺的E调清洁工艺。确认本洗涤剂有适用的可能性。
审核编辑:汤梓红

 电子发烧友App
电子发烧友App









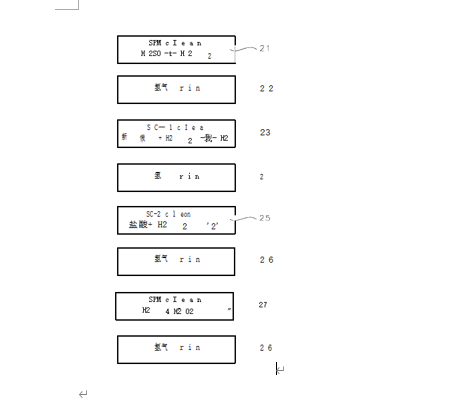



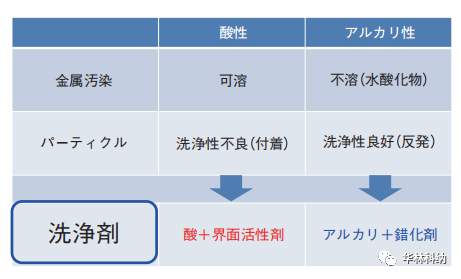


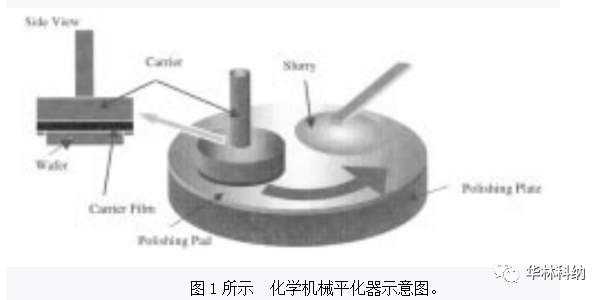
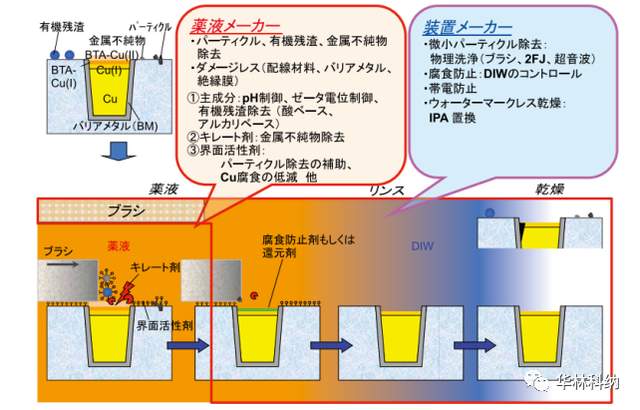
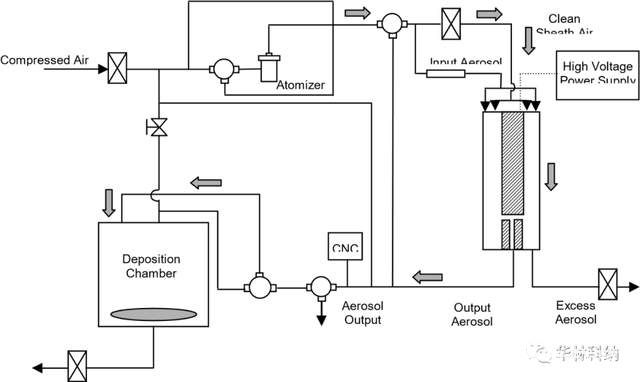

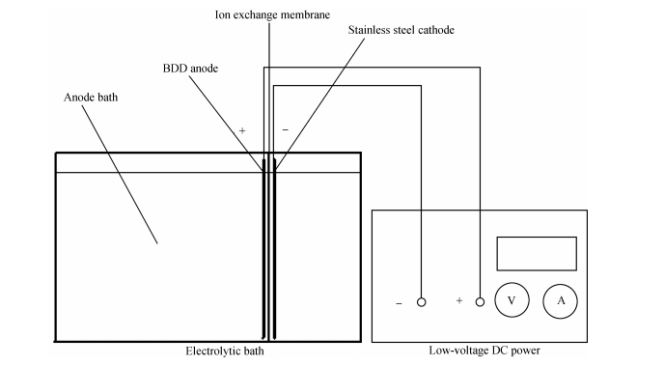
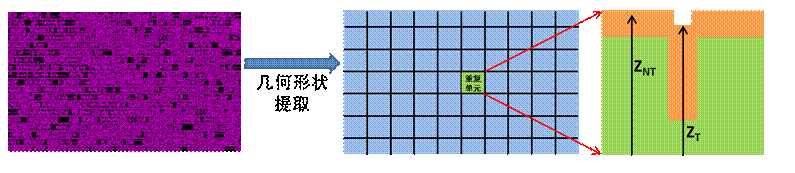
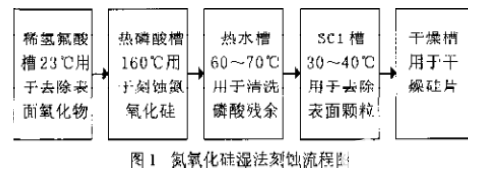
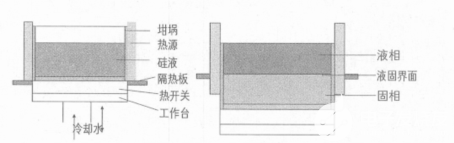

















评论