日本东京工业大学(Tokyo Tech)的研究人员开发了一种用于处理单元(processing units)和内存堆叠的创新三维集成技术,可以实现目前“世界上最高的性能”,为更快、更高效的计算铺平了道路。
这种创新的堆叠架构被命名为“Bumpless Build Cube 3D”(简称BBCube 3D),它实现了比最先进的内存技术更高的数据带宽,同时还最大限度地降低了比特访问所需的能量。
BBCube 3D技术采用了一种堆叠设计,其中处理单元(xPU)位于多个互连内存层(DRAM)之上。通过用硅通孔(TSV)代替电线,可以缩短连接长度,从而获得更好的整体电气性能。
在当今的数字时代,工程师和研究人员不断提出新的计算机辅助技术,这些技术需要处理单元(即PU,例如GPU和CPU)与存储芯片之间有更高的数据带宽。现代带宽密集型应用的一些例子包括人工智能、分子模拟、气候预测和遗传分析等。
然而,为了增加数据带宽,必须在PU和存储器之间添加更多线路,或者提高数据速率。第一种方法在实践中很难实现,因为上述组件之间的传输通常发生在二维中,使得添加更多线路变得困难棘手。另一方面,提高数据速率则需要增加每次访问一个比特数据所需的能量,称为“比特访问能量”(bit access energy),这也是具有挑战性的。
幸运的是,日本东京工业大学的一组研究人员现在可能已经找到了解决这个问题的可行方案。在最近举行的IEEE 2023 VLSI技术和电路研究研讨会上,Takayuki Ohba教授及其同事报告了他们的关于BBCube3D技术的研究成果(论文题目:Bumpless Build Cube 3D:Heterogeneous 3D Integration Using WoW and CoW to Provide TB/s Bandwidth with Lowest Bit Access Energy)。该技术有望解决上述问题,从而实现更好的PU和动态随机存取存储器(DRAM)集成。
BBCube 3D最引人注目的方面是实现了PU和DRAM之间的三维连接,而不是二维连接。该团队通过使用创新的堆叠结构实现了这一壮举,其中PU芯片位于多层DRAM之上,所有层均通过硅通孔(TSV)互连。
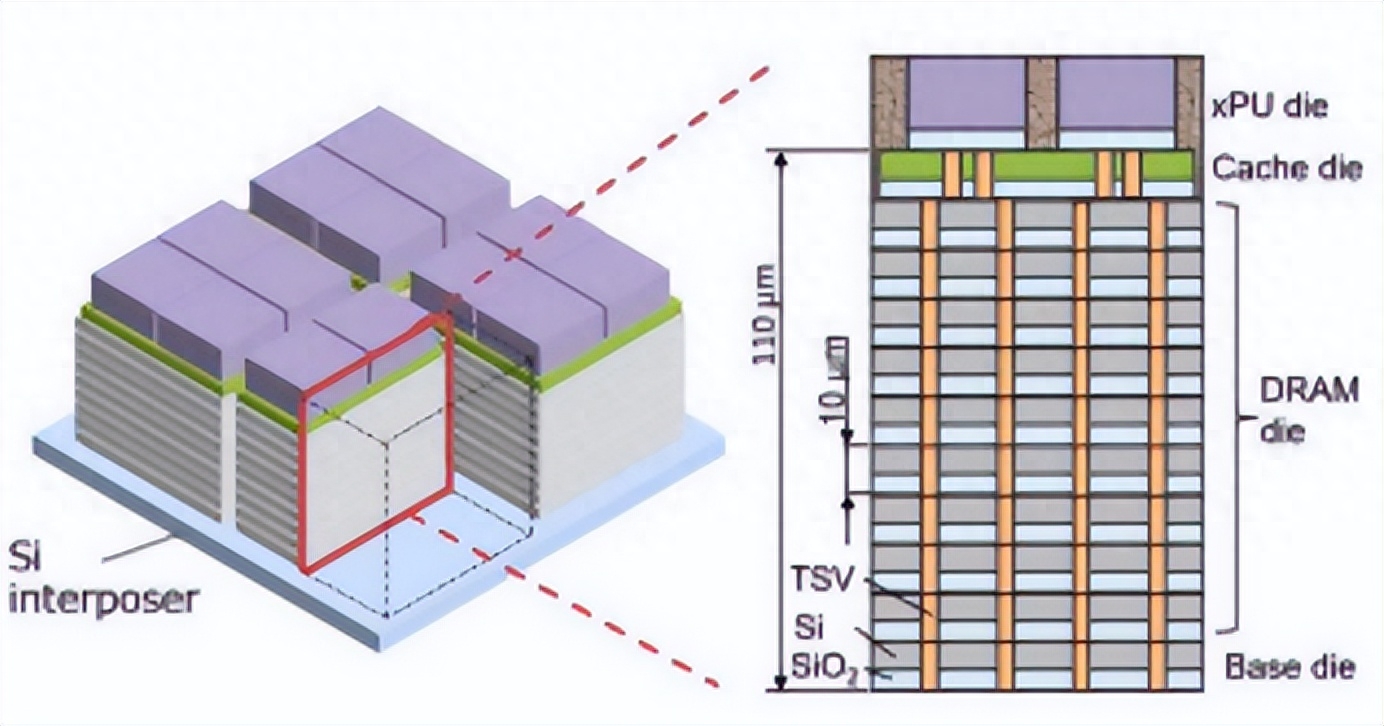
BBCube3D的整体架构紧凑,没有采用典型的焊料微凸块,并且使用TSV代替较长的电线,这些都有助于实现低寄生电容和低电阻,也提高了整体设计在各个方面的电气性能。
此外,研究人员实施了一项涉及四相屏蔽输入/输出(IO)的创新策略,以使BBCube 3D具有更强的抗噪声能力。他们调整了相邻的IO线的时序,使它们始终彼此不同步,这意味着它们永远不会同时改变其值。这减少了线路之间的串扰噪声,并使整体设计运行更加稳健。
该研究团队评估了他们的BBCube 3D架构的速度,并将其与现有两种最先进的内存技术:DDR5和HBM2E进行了比较。Ohba教授在解释实验结果时表示:“由于BBCube 3D 的低热阻和低阻抗,可以缓解3D集成中典型的热管理和电源问题。BBCube 3D有望实现每秒1.6TB的带宽,比DDR5高30倍,比HBM2E高4倍。在比特访问能量方面,BBCube 3D的比特访问能量分别是HBM2E的1/20和DDR5的1/5。”
审核编辑:汤梓红
-
半导体
+关注
关注
321文章
21423浏览量
199249 -
DRAM
+关注
关注
36文章
1881浏览量
180708 -
异构集成
+关注
关注
0文章
18浏览量
1678
发布评论请先 登录
相关推荐

3D混合制造技术介绍
3D制图软件如何进行多CAD混合设计?
浩辰3D的「3D打印」你会用吗?3D打印教程
基于3D打印的原理及应用
3D集成系统的测试挑战
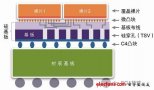
TSMC 和 Cadence 合作开发3D-IC参考流程以实现真正的3D堆叠
3D打印技术:微软推3D Builder、实现打印心脏
2.5D异构和3D晶圆级堆叠正在重塑封装产业

英特尔异构3D系统级封装集成
3D IC制造技术已成主流,异构3D IC还有待进步
为什么选择3D,3D芯片设计要点分析
行业资讯 I 当芯片变身 3D 系统,3D 异构集成面临哪些挑战





 BBCube3D以混合3D方法实现异构集成
BBCube3D以混合3D方法实现异构集成















评论